

【会员论文】中国科大&杭州镓仁半导体&中电科四十六研究所:在2英寸(010)衬底上实现β氧化镓的均匀晶圆级MOCVD同质外延
日期:2025-10-31阅读:380
由中国科学技术大学、杭州镓仁半导体和中国电子科技集团有限公司第四十六研究所的联合研究团队在学术期刊 Chinese Physics B 布了一篇名为Uniform Wafer-scale MOCVD homoepitaxy of β-Ga2O3 on 2-inch (010) substrates(在2英寸(010)衬底上实现 β-Ga2O3 的均匀晶圆级 MOCVD 同质外延)的文章。
项目支持
本研究得到了以下项目的资助:国家自然科学基金(项目编号 U23A20358、62474170、61925110、62404214、62234007),中国科学技术大学“双一流”建设专项科研基金(项目编号 WK2100000055),中国电子科技集团有限公司第四十六研究所项目(项目编号 WDZC202446007),湖南省长沙市揭榜挂帅科技项目(项目编号 kq2301006),以及中国科学院苏州纳米技术与纳米仿生研究所纳米器件与应用重点实验室开放课题的支持。部分研究工作在中国科学技术大学微纳尺度研究中心完成。作者特别感谢杭州镓仁半导体有限公司提供铸造型 β-Ga2O3 本征晶体,以及微著半导体科技(苏州)有限公司协助完成 C–V 测试。
背 景
随着电子系统对更高效率与功率密度的持续追求,超宽禁带(UWBG)半导体受到广泛关注。其中,β-Ga2O3 因其高达 8 MV/cm 的理论击穿电场和优异的功率品质因数,被视为超越 Si、SiC 与 GaN 的下一代功率电子材料。然而,其单斜晶系结构具有显著的各向异性,使晶向选择成为决定器件性能的关键因素。其中 (010) 取向具有最高的电子迁移率,最适合用于高性能横向器件,但长期受制于缺乏大面积 (010) 取向衬底,限制了可扩展器件制备与晶圆级均匀性研究。近年来,随着熔体生长技术的突破,2 英寸 (010) β-Ga2O3 衬底已实现商品化,这为其产业化奠定了基础。当前亟需建立并验证可扩展的高质量外延生长工艺,以推动其在功率电子器件中的应用。
主要内容
β-Ga2O3 的 (010) 晶向因其优异的理论输运特性,被认为是下一代横向功率电子器件的极具潜力的平台。然而,由于大面积衬底的缺乏,相关研究长期受限于小尺寸样品。借助近年来 2 英寸衬底的问世,本研究首次报道了在 2 英寸 Fe 掺杂半绝缘型 (010) β-Ga2O3 衬底上采用金属有机化学气相沉积(MOCVD)实现的同质外延生长。通过系统的晶圆级表征,验证了高质量外延薄膜的成功制备。高分辨 X 射线衍射(HRXRD)结果显示外延层晶体结构优异,摇摆曲线的半高宽(FWHM)范围为 21.0–103.0 arcsec。原子力显微镜(AFM)测试表明外延层表面原子级平滑,均方根粗糙度(RMS)低于 1.53 nm,晶圆表面呈现出典型的阶梯流生长模式。此外,汞探针电容-电压(C–V)映射表明载流子浓度约为 ~2×1018 cm-3,且相对标准偏差(RSD)仅为 5.12%,表明载流子浓度控制良好。该研究首次对 2 英寸 (010) β-Ga2O3 外延晶圆进行了系统性评估,为高性能功率器件的开发与未来制造提供了关键材料平台验证。
结 论
本研究成功实现了首例在 2 英寸 (010) 取向 β-Ga2O3 衬底上的 MOCVD 同质外延生长,并对所得外延薄膜进行了首个全面的全片尺度表征。详细研究显示,薄膜在整个晶圆上均表现出优异的材料质量,包括原子级平滑的表面和均匀的阶梯流生长形貌(RMS 粗糙度介于 0.89 nm 至 1.53 nm 之间)、出色的晶体结构(XRD 摇摆曲线全宽半高 FWHM 为 21.0 至 103 arcsec)。此外,展示了对 n 型掺杂的精确且均匀控制,实现了载流子浓度约为 2×1018 cm-3,同时具有优异的空间均匀性(RSD≈5.12%)和深度均匀性。这一开创性工作不仅为此前不可获得的平台建立了器件级材料的可靠基线,也验证了 (010) β-Ga2O3 材料体系的可制造性。本研究标志着将 Ga2O3 横向功率器件从实验室概念推进到晶圆级可应用技术的重要一步,为其商业化奠定了基础。
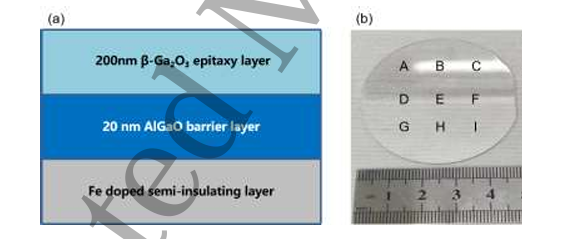
图1. (a) MOCVD生长的外延结构示意图,由200 nm Si掺杂Ga2O3通道层和20 nm AlGaO背势垒组成,衬底为Fe掺杂半绝缘(010) β-Ga2O3 衬底。(b) 2英寸晶圆的光学图像,显示用于系统表征的9个特征点位置(A至I)。
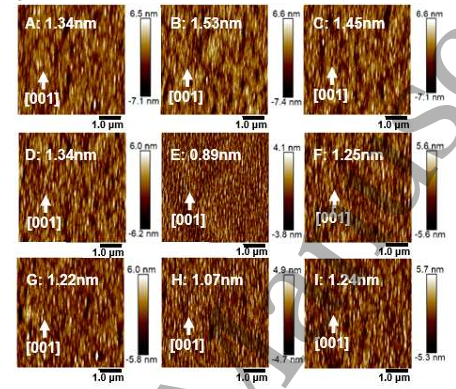
图2. 表面形貌及结构性质概览。对2英寸晶圆上九个特征点(A-I)进行的5 µm×5 µm AFM表面形貌扫描均显示明显的阶梯流(step-flow)生长模式,表明表面呈原子级平滑。
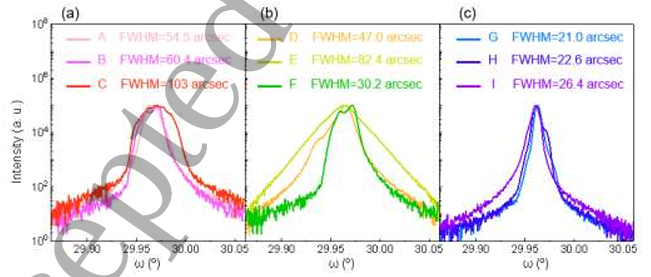
图3. 对称 (020) 衍射的高分辨率X射线衍射(XRD)摇摆曲线。

图4. 晶圆尺度载流子浓度分布图。基于汞探针电容-电压(Hg-CV)测试获得的2英寸晶圆平均载流子浓度空间分布图。颜色标度表示浓度(单位:cm-3)。图中显示掺杂均匀性良好,中心到边缘仅有轻微变化。
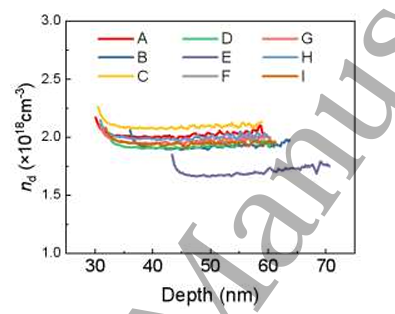
图5. 载流子浓度深度分布。通过Hg-CV在晶圆九个位置测得的载流子浓度(nd)随表面深度的变化曲线。曲线在200 nm Ga2O3通道层主体部分保持平稳,表明MOCVD生长过程中硅掺杂均匀。

图6. 室温霍尔迁移率对比。MOCVD生长的(010) β-Ga2O3薄膜的电子迁移率随载流子浓度变化曲线(红色星标),与文献中不同取向β-Ga2O3薄膜的汇总数据对比。本工作结果处于报告值的上限范围,验证了材料的高电子质量。
DOI:
doi.org/10.1088/1674-1056/ae12e0