

【会员论文】北邮李培刚教授&南邮唐为华教授团队:低漏电流与高击穿电压p-NiO/n-Ga₂O₃ JBS二极管电输运机制研究
日期:2025-11-12阅读:362
由北京邮电大学李培刚教授、南京邮电大学唐为华教授、李山副教授、季学强副教授、内蒙古大学刘增研究员等人联合中国科学院微电子研究所的研究团队在学术期刊 Physica Scripta 发布了一篇名为Investigation of electrical transport mechanisms in p-NiO/n-Ga2O3 junction barrier Schottky diodes with low leakage and high breakdown voltage(低漏电流与高击穿电压 p-NiO/n-Ga2O3 结势垒肖特基二极管电输运机制研究)的文章。
项目支持
本研究得到中国国家重点研发计划(2022YFB3605404)、 中国国家自然科学基金联合基金(U23A20349),江苏省自然科学基金(BK20250657),以及南京邮电大学人才引进自然科学研究启动基金(XK1180924052)。
背 景
β-氧化镓(β-Ga2O3)因其超宽禁带和高击穿场强,在下一代功率电子器件领域展现出巨大潜力。然而,β-Ga2O3 缺乏有效的 p 型掺杂,这阻碍了双极型器件的发展。为了克服这一难题,研究人员转向使用 p 型氧化物与 n 型 Ga2O3 构建异质结。结势垒肖特基(JBS)二极管是一种先进的器件结构,巧妙的将 p-n 异质结(p-NiO/n-Ga2O3)的低漏电流特性与肖特基接触的低开启电压、快恢复特性相结合,被认为是实现高性能 Ga2O3 功率二极管的理想途径。尽管 p-NiO/n-Ga2O3 JBS 二极管已展现出优异性能,但其内部复杂的载流子输运机理,特别是决定器件可靠性的反向漏电机理(尤其是在高温下),尚未被系统地阐明。
主要内容
采用平面和沟槽结势垒结构设计,制备了高性能氧化镓(Ga2O3)结势垒肖特基(JBS)二极管,并系统研究了其电输运机制。JBS 结构通过 pn 结诱导的 Ga2O3 导带抬升强化了界面耗尽区,而沟槽设计则形成了更高的界面势垒并扩展了横向耗尽区,有效调控了载流子传输。此外,JBS 结构降低了肖特基界面电场,不仅抑制了肖特基势垒降低以减少反向漏电流,还缓解了表面电场拥挤现象,防止器件过早击穿。采用 JBS 结构的肖特基势垒二极管正向电流开关比高达 8.0 × 1010,展现卓越开关特性。沟槽 JBS 结构使 SBD 反向击穿电压从 310 V 跃升至 1150 V,增幅约 3.7 倍。同时,漏电流降低两个数量级至 1.1 × 10−9 A cm−2 的超低值。本文通过平面型与沟槽型 JBS 结构的器件性能对比分析,为 Ga2O3 基 SBD 的未来创新提供了理论基础与参考依据。
创新点
● 成功制备了具有高击穿电压和低漏电的 p-NiO/n-Ga2O3 JBS 二极管,其综合性能处于先进水平。
● 系统地揭示了 p-NiO/n-Ga2O3 JBS 二极管中复杂且随温度、偏压变化的混合漏电模式。
● 揭示了平面型与沟槽型 JBS 结构的载流子电导调控机制,为器件性能优化提供了重要物理依据。
结 论
通过模拟与实验相结合的方法,对平面型和沟槽型 JBS 结构的导电调制机制进行了全面分析。将 JBS 结构集成到器件中,可通过 p-n 结诱导的 Ga2O3 导带抬升效应增强界面耗尽区。沟槽设计凭借更高的界面势垒和增大的侧壁接触面积,进一步扩展并强化了耗尽区。沟槽 JBS 结构显著降低电场强度,使漏电流水平降低两个数量级,反向漏电流仅为 1.1×10−9 A cm−2。此外,通过有效抑制肖特基界面峰值电场,击穿电压获得显著提升——TJBS 器件达到 1150 V,远超传统肖特基二极管的 310 V。本研究为推动 Ga2O3 基肖特基二极管向大功率应用发展提供了切实有效的指导。
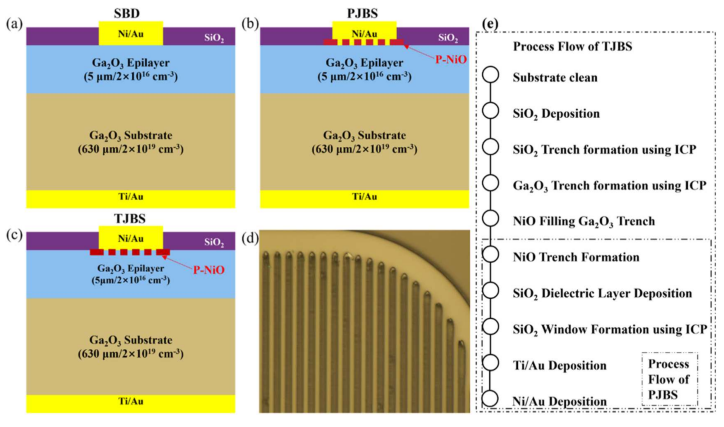
图1. 垂直结构示意图:(a) SBDs, (b) PJBS, (c) TJBS。(d) JBS 结构的光刻图案。(e) 制造 TJBS 和 PJBS 的关键工艺流程。
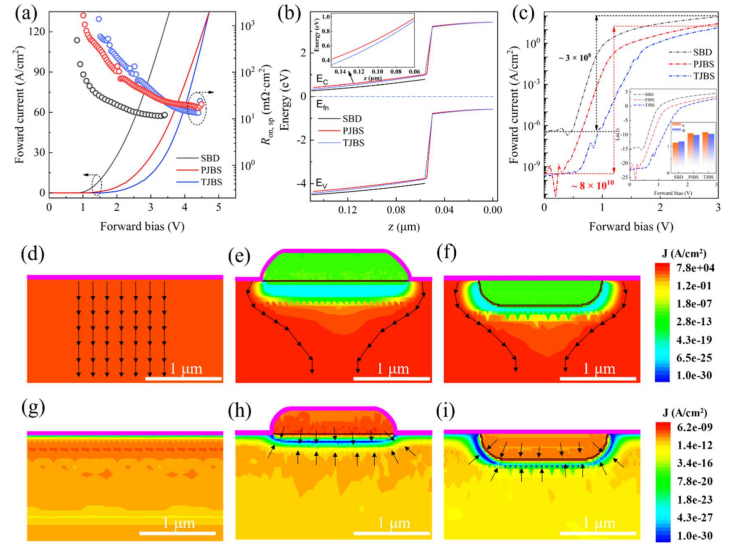
图2. (a) 线性坐标系下的 J-V-Ron,sp 曲线,(b) 0 V 时的能带图,以及 (c) SBD、PJB和 TJBS 二极管的对数坐标系 J-V 曲线(插图显示从 ln(J)-V 曲线提取的 n 和 Φ 参数)。在 5 V 偏压下 TCAD 模拟的电流密度分布:(d) SBD,(e) PJBS,(f) TJBS;在 0 V 偏压下:(g) SBD,(h) PJBS,(i) TJBS。

图3. (a) SBD,(b) PJBS,(c) TJBS 的温度依赖性 J-V 特性曲线。
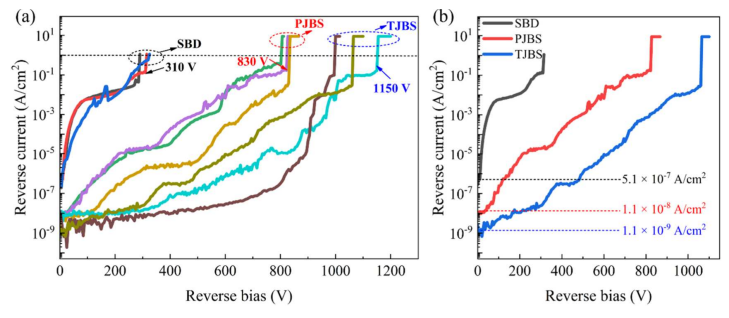
图4. 三种器件结构的击穿特性:(a)反向 J-V 曲线;(b)典型坐标-反向 J-V 曲线。

图5. 在反向击穿电压下 (a) SBD、(b) PJBS、(c) TJBS 的电场分布模拟图,以及对应提取的 Ga2O3 表面横向电场分布。
DOI:
doi.org/10.1088/1402-4896/ae098a