

【外延论文】使用 N₂O 等离子体的低温等离子体增强原子层沉积(PEALD)制备 Ga₂O₃ 薄膜用于硅表面钝化
日期:2025-11-17阅读:318
由俄罗斯圣彼得堡国立电子科技大学的研究团队在学术期刊 Applied Surface Science 发布了一篇名为Low-temperature plasma-enhanced atomic layer deposition of Ga2O3 films using N2O plasma for silicon surface passivation(使用 N2O 等离子体的低温等离子体增强原子层沉积(PEALD)制备 Ga2O3 薄膜用于硅表面钝化)的文章。
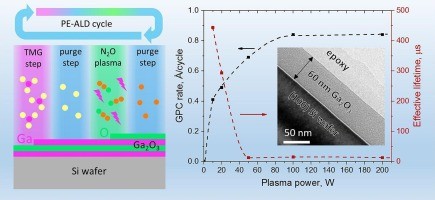
摘要
本研究利用等离子增强原子层沉积(PE-ALD)在晶体硅表面沉积氧化镓(Ga2O3)薄膜,并采用一氧化二氮(N2O)作为氧化剂实现表面钝化。沉积在低温 75°C 的直接等离子体配置下进行,实现了衬底的均匀覆膜。透射电子显微镜(TEM)横截面分析确认了 Ga2O3 薄膜的非晶结构,并在衬底界面形成了薄的 SiOx 层。扫描透射电子显微镜能谱(STEM-EDX)元素分布显示镓和氧均匀分布,同时存在少量氮和碳,归因于前驱体与等离子体的相互作用。光学测量表明 Ga2O3 薄膜光学带隙为 4.52 eV,与文献中非晶 Ga2O3 的数值一致。研究发现,随着等离子体功率增加,单循环生长速率由 0.41 Å/cycle 提高至 0.84 Å/cycle,但较高功率及延长的等离子体照射会因 Ga2O3/Si 界面损伤而降低钝化质量。在等离子体功率 10 W(22 mW/cm2)条件下,载流子有效寿命最高达到 443 μs,显示低损伤沉积条件下具有高效钝化效果。这些结果表明,基于 N2O 的 PE-ALD Ga2O3 薄膜具有作为宽禁带、低温硅太阳能电池钝化层的潜力。
原文链接:
https://doi.org/10.1016/j.apsusc.2025.165092


