

【国际论文】突破 3 kV 耐压与极低漏电的垂直 (011) β-Ga₂O₃ 二极管:采用工程化肖特基和高介电常数场
日期:2025-11-18阅读:472
由爱荷华州立大学的研究团队最新发布了一项研究成果,研究名为:Over 3 kV and Ultra-Low leakage Vertical (011) β-Ga2O3 Power Diodes with Engineered Schottky Contact and High-permittivity Dielectric Field Plate(突破 3 kV 耐压与极低漏电的垂直 (011) β-Ga2O3 二极管:采用工程化肖特基和高介电常数场)。
背 景
β-Ga2O3 因其约 4.8 eV 的超宽带隙、可控浅掺杂以及高临界击穿场强(约8 MV/cm),在紧凑型高功率半导体器件中引起广泛关注。尤其是熔体生长的 β-Ga2O3 本征衬底的可获得性,为超宽带隙功率器件的大规模低成本制备提供了独特机会。尽管已有多种场管理技术(如场板、沟槽结构、保护环、深刻蚀和离子注入)在垂直 β-Ga2O3 功率二极管中展示出优异性能,但多数器件仍采用 HVPE 生长的厚度约 10 μm、(001) 取向的 β-Ga2O3 外延层,其背景掺杂较高,且易形成线状位错,这些“致命缺陷”会导致漏电和击穿电压下降,限制器件高压扩展。为克服这一问题,(011) 取向的 β-Ga2O3 同质外延生长被提出,可减少位错对垂直电流方向漏电的影响。然而,目前 (011) β-Ga2O3 肖特基二极管的基本电子特性及高压性能尚缺系统研究。为实现千伏级高压器件,边缘场管理和肖特基接触工程至关重要,可有效抑制金属/β-Ga2O3 结的隧穿漏电并提升击穿电压。本研究通过在(011) β-Ga2O3 垂直肖特基二极管中集成高介电常数(ZrO2)场板并优化复合 Pt cap/PtOx/Pt (1.5 nm) 阳极接触,成功实现了超低漏电、多千伏击穿电压以及低导通电压,展示了 (011) β-Ga2O3 在高压功率器件中的应用潜力及设计策略。
主要内容
本文报道了一种耐压超过 3 kV、超低漏电的 (011) β-Ga2O3 功率器件,该器件结合了肖特基势垒工程与高介电常数 (κ) 介质 (ZrO2) 场板技术。(011) 取向的 β-Ga2O3 实现了低本征掺杂和厚漂移层,这对支持 kV 级垂直 β-Ga2O3 功率开关非常有利。肖特基势垒工程采用复合 Pt cap/PtOx/Pt(1.5 nm)阳极接触设计,利用 PtOx 提升反向阻断能力,同时通过薄 Pt 接触层保持低导通电压。研究团队在同一晶片上系统研究了协同制备的 Pt/(011) β-Ga2O3 肖特基二极管 (SBDs)。裸 SBD 的击穿电压约为 1.5 kV,而场板 Pt/(011) β-Ga2O3 SBD 通过边缘电场管理将击穿电压提高至 2.75 kV。进一步通过复合 Pt cap/PtOx/Pt(1.5 nm)肖特基接触的隧穿漏电管理,将场板二极管的击穿电压最终提升至 3.7 kV。值得注意的是,复合 Pt cap/PtOx/Pt(1.5 nm)接触的导通电压与 Pt/(011) β-Ga2O3 SBDs 相似。通过复合 Pt cap/PtOx/Pt 接触有效控制隧穿漏电,同时保持类似导通电压,结合高 κ 介电 ZrO2 场板的边缘电场降低以及 (011) β-Ga2O3 材料自身的优势特性,这一策略展示了在开发超低漏电、多 kV 级垂直 (011) β-Ga2O3 功率器件方面的巨大潜力。
结 论
本文报道了一种基于 (011) 取向 β-Ga2O3 的高功率垂直型肖特基二极管,其采用高介电常数(κ)氧化锆(ZrO2)场板结构,并通过复合 Pt cap/PtOx/Pt(1.5 nm)接触实现了工程化的肖特基势垒设计。该器件在反向偏压下表现出优异的电学性能,实现了超过 3 kV 的击穿电压以及极低的漏电流。与传统的 Pt 肖特基接触相比,复合 Pt cap/PtOx/Pt(1.5 nm)结构在保持相似导通电压的同时,显著提升了反向阻断能力并降低了漏电,为低损耗、高电压功率器件的发展提供了新的可能。因此,本研究充分展示了 (011) β-Ga2O3 的潜力,其厚漂移区具备低背景掺杂特性,再结合精心设计的器件制造策略,为高效千伏级垂直功率开关器件的发展提供了有前景的路径。
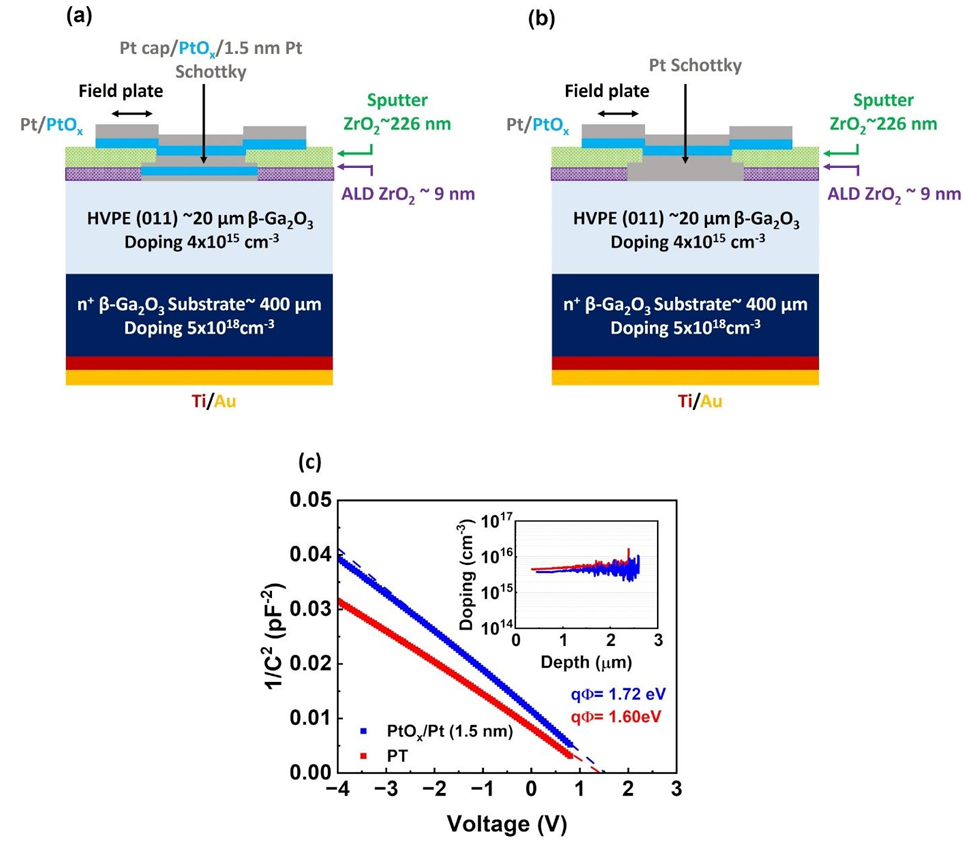
图1:(a) 和 (b) 分别为带高介电常数 ZrO2 场板的垂直型 (011) β-Ga2O3 肖特基二极管的结构示意图,器件直径为 100 μm。(a) 为复合 Pt cap/PtOx/Pt(总厚 1.5 nm)肖特基接触结构;(b) 为单层 Pt 肖特基接触结构。(c) 为两种二极管通过 1/C2–V 分析提取的肖特基势垒高度(SBH),插图显示对应的掺杂浓度。
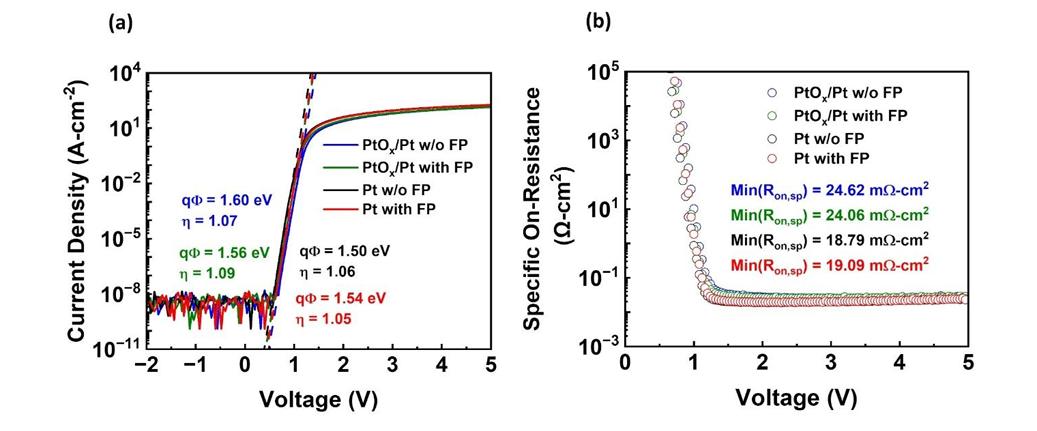
图2:(a) 展示了直径为 100 μm 的肖特基二极管的正向传输特性,器件分别采用复合 Pt cap/PtOx/Pt(1.5 nm)接触和单层 Pt 接触结构,并对比了有无 20 μm 场板结构的情况。所有样品的理想因子均接近 1,表现出优异的整流特性。(b) 展示了各类二极管的微分比导通电阻(Ron,sp)以及提取的最小比导通电阻。
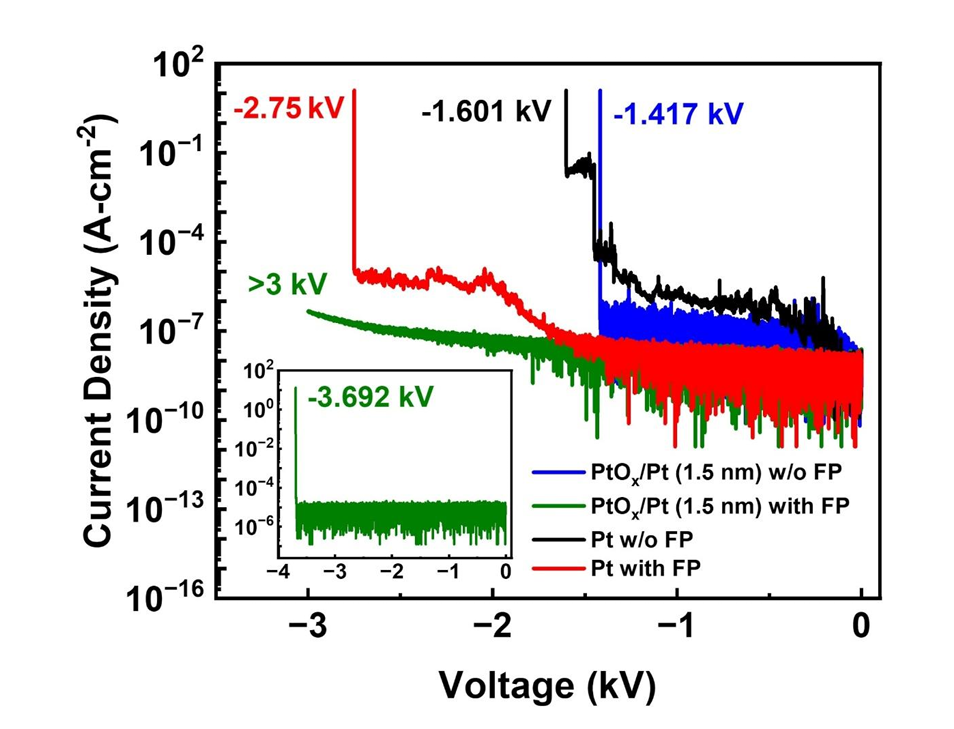
图3:直径为 100 μm 的肖特基二极管(SBD)的反向 J–V 特性,比较了复合 Pt cap/PtOx/Pt(1.5 nm)接触和单层 Pt 接触器件在有无 20 μm 场板的情况下的表现。未加场板时,两类器件的击穿电压相近,约在 1.4–1.6 kV 范围。加上场板后,复合 Pt cap/PtOx/Pt(1.5 nm)器件的反向漏电流显著降低,击穿电压稳定提高至超过 3 kV。插图展示了带场板的复合接触器件的击穿特性,该测试使用 UCSB 的独立参数分析仪完成,可测量超过 3 kV,但噪声底较高。
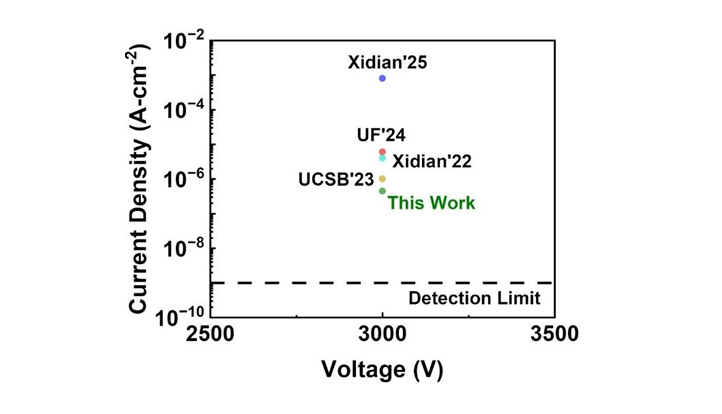
图4:3 kV 条件下反向漏电流密度的基准对比图,展示了制备的垂直 (011) β-Ga2O3 肖特基二极管(SBD)与文献中报道的基于 (001) 外延片的垂直 β-Ga2O3 SBD 的性能对比。
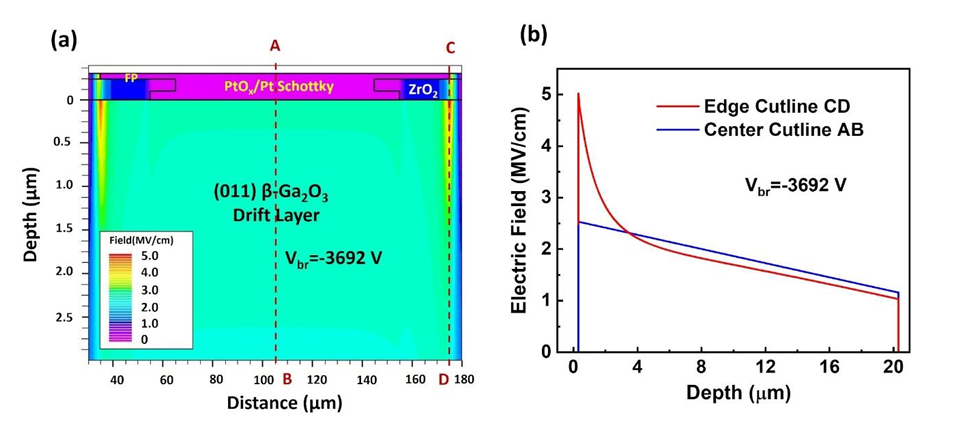
图5:(a) 模拟的电场等高线分布图,显示直径 100 μm 的复合 Pt cap/PtOx/Pt (1.5 nm) 肖特基二极管在 20 μm ZrO2 场板下的电场分布,击穿电压为 Vbr = -3692 V。(b) 沿切线 C-D(场板边缘)的电场显示,峰值电场出现在 ZrO2/β-Ga2O3 界面,为 5 MV/cm;沿平行平面切线 A-B 提取的电场为 2.53 MV/cm。
DOI:
doi.org/10.48550/arXiv.2510.25695