

【国内论文】南京大学叶建东教授团队:MOCVD生长β氧化镓 (001) 同质外延层中非故意Si掺杂的主导机制:竞争性表面吸附
日期:2025-11-26阅读:333
由南京大学叶建东教授领导的研究团队在学术期刊 Journal of Physics D: Applied Physics 发布了一篇名为 Competitive surface adsorption governs unintentional Si incorporation in MOCVD-grown β-Ga2O3 (001) homoepilayers(MOCVD 生长 β-Ga2O3 (001) 同质外延层中非故意 Si 掺杂的主导机制:竞争性表面吸附)的文章。
项目支持
本研究部分受国家重点研发计划(2022YFB3605403)、江苏省科技重大项目(BG2024030)以及国家自然科学基金(62425403、62234007、62293522、U21A2071、U21A20503)的资助。
背 景
β-Ga2O3 作为超宽禁带半导体材料,在高压功率电子器件领域具有极高潜力。然而在 MOCVD 外延中普遍出现的非故意硅掺杂问题,成为限制器件性能和材料纯度的关键瓶颈。硅原子常来源于反应腔体壁、石英部件或前道工艺残留,其在外延过程中的行为受到表面吸附、反应动力学和生长环境的共同影响。目前对于 Si 是如何进入 β-Ga2O3 外延层、其掺杂量与哪些外延参数相关、表面吸附竞争如何影响 UID Si 水平等关键科学问题仍缺乏明确理解。为了优化材料本征纯度、提高器件击穿电压与可靠性,迫切需要从原子尺度解析 Si 在 β-Ga2O3 MOCVD 生长中的来源、迁移与表面吸附机制。本研究围绕这些核心问题展开,通过实验测量与第一性原理计算相结合,揭示了外延表面的竞争吸附过程如何主导非故意 Si 掺杂行为,并给出抑制 UID Si 的有效策略。
主要内容
在高功率器件中,对非故意掺杂(UID)β-Ga2O3 外延层中残余硅(Si)杂质的精确控制至关重要,但由于 Si 掺杂的复杂机制,这仍然具有挑战性。本研究考察了 VI/III 摩尔比和生长速率对 (001) 取向 β-Ga2O3 UID 同质外延层中残余 Si 杂质和净施主浓度的影响,这些外延层由金属有机化学气相沉积(MOCVD)制备。研究发现,通过将生长速率提高至 1.08 μm/h,可将非故意掺入的 Si 浓度抑制至低于 1016 cm-3(接近二次离子质谱 SIMS 仪器的检测下限),从而实现净施主浓度 4.73×1015 cm-3。尽管碳(C)和氢(H)杂质对 VI/III 摩尔比敏感,但它们对 Si 掺杂效率的影响可忽略不计。在 Langmuir 吸附框架下,Si 掺杂由生长表面 Ga 和 Si 物种的竞争吸附过程控制,并且 Si 掺杂与生长速率之间的普适定量关系在不同晶向和不同 MOCVD 系统中广泛适用。
结 论
本研究表明,在 MOCVD 生长的 UID (001) β-Ga2O3 外延层中,残余 Si 掺杂主要由生长表面 Ga 和 Si 物种的竞争吸附过程控制。基于 Langmuir 吸附模型建立了 Si 掺杂与生长速率之间的普适定量关系,该关系适用于各种 MOCVD 生长的 β-Ga2O3 UID 外延层,无论衬底晶向或反应器系统如何。尽管碳(C)和氢(H)杂质水平受 VI/III 摩尔比显著影响,但它们对 Si 掺杂的作用仍可忽略不计。通过提高生长速率,残余 Si 掺杂得以抑制,实现净施主浓度降低至 4.73×1015 cm-3。这些结果为理解 Si 掺杂机制提供了基础框架,并为制备高纯度 β-Ga2O3 以应用于高性能功率电子器件奠定了基础。
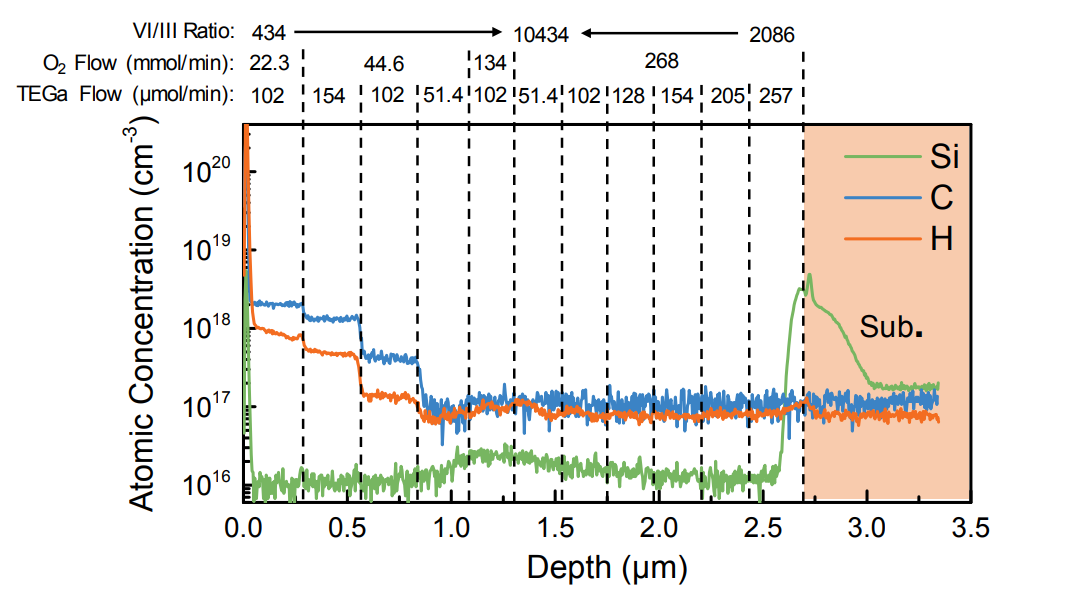
图 1. 在不同 TEGa 和 O₂ 摩尔流量下,MOCVD 生长的 (001) β-Ga₂O₃ 同质外延层中残余杂质(Si、C 和 H)的 SIMS 深度分布曲线。
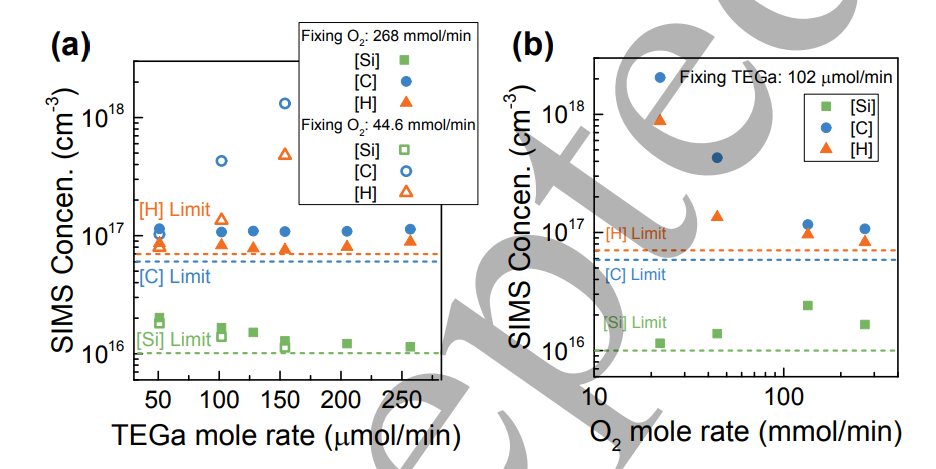
图 2. SIMS 测得的 Si、C 和 H 浓度随 (a) TEGa 摩尔流量和 (b) O₂ 摩尔流量的变化关系。

图 3. (a) CV 测得的净施主浓度 Nd−Na(实心点)和 SIMS 测得的 [Si](空心点)随 VI/III 比的变化关系。(b) SIMS 测得的 [C](实心点)和 [H](空心点)随 VI/III 摩尔比的变化关系。数据点按 O₂ 摩尔流量颜色编码,其中黄色和蓝色分别对应 22.3 和 134 mmol/min。(c) Nd−Na 与 [Si] 的关系。(d) [Si] 和 Nd−Na(左轴)及对应生长速率(右轴)随 TEGa 摩尔流量的变化关系。

图 4. (a) (001)-β-Ga₂O₃ 生长表面 Si 与 Ga 物种竞争吸附示意图。(b) 不同 MOCVD 系统生长的 (001)、(100) 和 (010) 取向先进 UID β-Ga₂O₃ 外延层中残余 [Si] 与背景载流子浓度随 1/生长速率 (1/GR) 的变化关系。
DOI:
doi.org/10.1088/1361-6463/ae1e08