

【会员论文】西电郝跃院士联合西交大微电子学院团队: 通过协同保护环与斜面场板实现2.3kV低漏电流垂直(001)β氧化镓二极管
日期:2025-12-02阅读:363
由西安电子科技大学郝跃院士团队联合西安交通大学杨明超工程师、周磊簜副教授团队在学术期刊 Journal of Vacuum Science & Technology A 发布了一篇名为 2.3 kV low leakage vertical (001) β-Ga2O3 diodes enabled by a synergistic guard ring and beveled field plate(通过协同保护环与斜面场板实现 2.3kV 低漏电流垂直 (001) β氧化镓二极管)的文章。
项目支持
本工作得到中国国家自然科学基金联合基金资助(项目号 U23A20367)。
背 景
β-Ga2O3 是一种超宽禁带(4.5–4.9 eV)半导体,具有高理论击穿电场(约 8 MV/cm)以及通过熔融生长单晶衬底实现低成本、高质量同质外延的潜力,使其成为下一代高压、高温功率器件的有力候选材料。然而,β-Ga2O3 垂直器件性能难以达到材料极限(Baliga 指标)的主要瓶颈在于器件边缘的电场控制能力不足,同时受限于难以实现 P 型掺杂,传统的边缘终端结构如场限环(FLR)和结延伸(JTE)难以实现。为缓解电场集中问题,研究者探索了多种替代策略,包括场板(FP)、斜角场板(BFP)、台阶终端、电离注入形成高阻护环(GR)、氧化终端及 β-(AlxGa1-x)2O3 封顶层等,这些方法能够有效降低边缘电场集中,提高击穿电压及降低泄漏电流。其中,斜角场板与氮离子注入护环的组合在边缘电场管理上表现出显著优势,为 β-Ga2O3 功率器件的高性能设计提供了有效途径,并可推广至其他宽禁带半导体功率器件。
主要内容
本研究展示了一种垂直(001)取向的 β-Ga2O3 肖特基势垒二极管(SBD),其采用复合边缘终端结构,将氮离子注入护环(GR)与小角度斜面场板(BFP)相结合。基于半导体物理的技术计算机辅助设计(TCAD)仿真,开发并优化了器件几何结构。GR 与 BFP 的集成能够在不损害正向导通特性的情况下抑制阳极边缘的电场峰值。得益于这一优化的终端设计,制备的二极管实现了 2.3 kV 的击穿电压(Vbr),约为无终端器件的 6.5 倍,同时具有 3.19 mΩ·cm2 的特定导通电阻(Ron,sp),从而获得高达 1.71 GW/cm2 的 Baliga 指标。此外,在 −1500 V 反向偏压下,器件表现出低于 1 μA/cm² 的泄漏电流密度。本研究提供了一种可行途径,以提升 β-Ga2O3 SBD 的性能,为其在功率电子器件中的应用奠定基础。
结 论
本工作将氮离子注入护环(GR)与浅斜面场板(BFP)相结合,有效缓解了 β-Ga2O3 肖特基势垒二极管阳极边缘的电场聚集。β-Ga2O3 GR/BFP-SBD 展现出 3.19 mΩ·cm2 的低特定导通电阻(Ron,sp)和 2338 V 的高击穿电压(Vbr),实现了 1.71 GW/cm2 的高 Baliga 指标,并在 −1500 V 反向偏压下保持 1 μA/cm2 的低泄漏电流密度。这种复合终端结构使击穿电压提升了 6.5 倍,同时几乎不影响正向特性。本研究为垂直 β-Ga2O3 SBD 的电场调控提供了一种有效的复合终端技术,并展示了高性能多千伏 β-Ga2O3 器件的广阔应用前景。
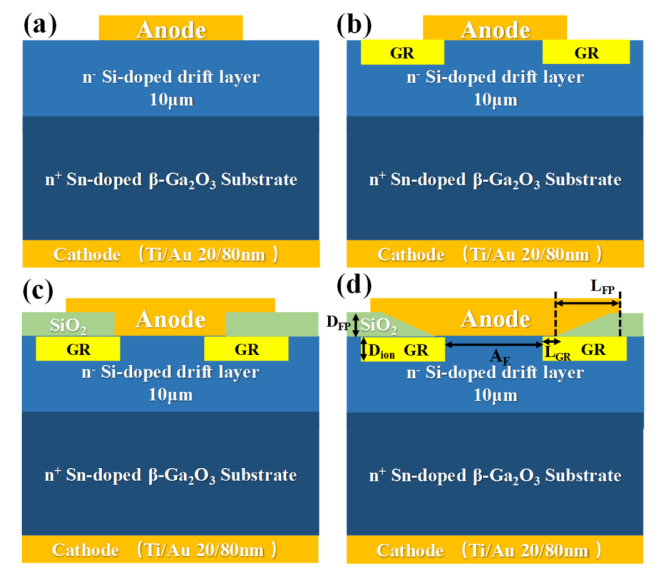
图 1. β-Ga₂O₃ 的示意横截面。(a) 参考 SBD,(b) 带护环 (GR) 的 SBD,(c) 带护环/场板 (GR/FP) 的 SBD,(d) 带护环/浅斜场板 (GR/BFP) 的 SBD。
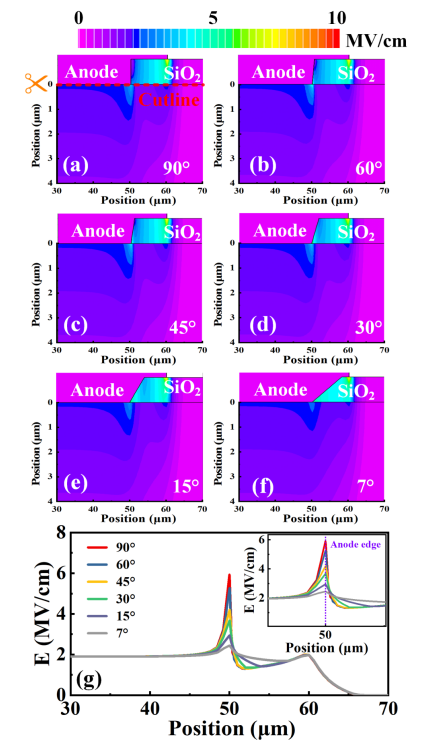
图 2. (a)–(f) 在反向偏压 1000 V 下,不同斜角场板 (FP) 对模拟二维电场分布的影响。(g) 不同斜角 FP 在 β-Ga₂O₃ 表面提取的水平电场分布曲线。
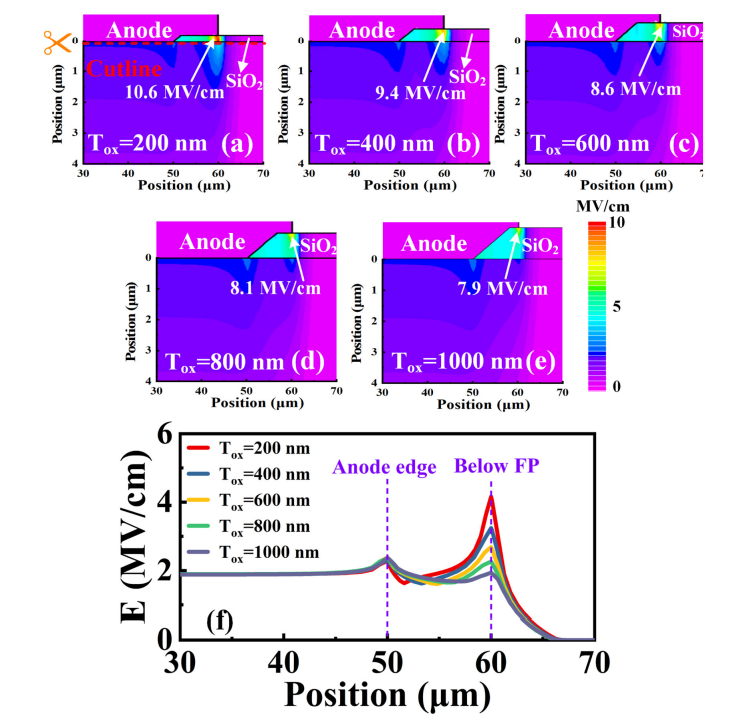
图 3. (a)–(e) 在反向偏压 1000 V 下,不同厚度的小角斜面场板 (BFP) 对模拟二维电场分布的影响。(f) 不同厚度 BFP 在 β-Ga₂O₃ 表面提取的水平电场分布曲线。
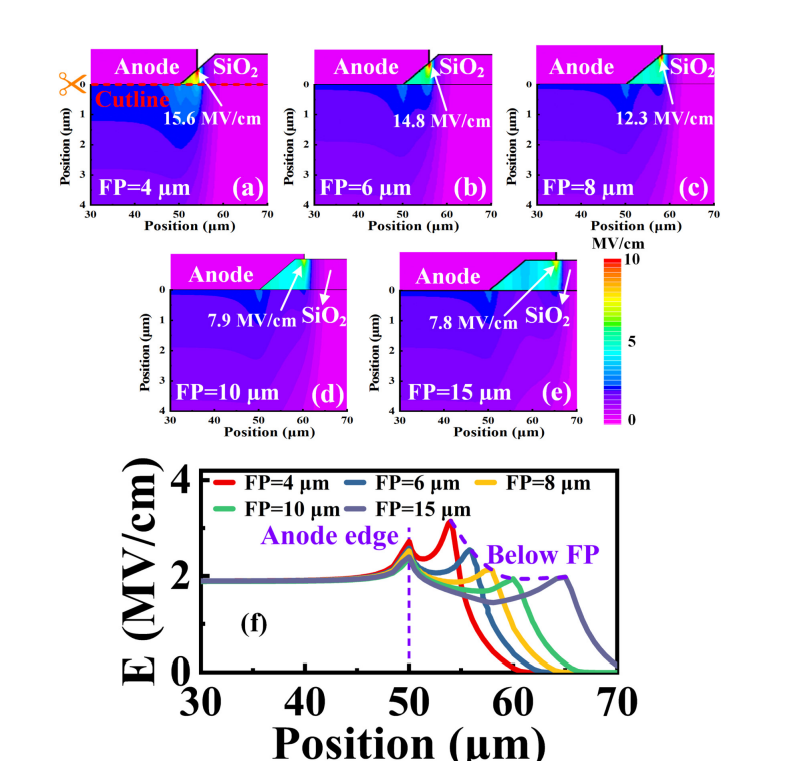
图 4. (a)–(e) 在反向偏压 1000 V 下,不同长度的小角斜面场板 (BFP) 对模拟二维电场分布的影响。(f) 不同长度 BFP 在 β-Ga₂O₃ 表面提取的水平电场分布曲线。

图 5. (a)–(c) 在反向偏压 1000 V 下,不同厚度护环 (GR) 对模拟二维电场分布的影响。(d) β-Ga₂O₃ 表面阳极下方和 (e) 阳极角下方提取的不同厚度 GR 的电场分布曲线。(f) 多能氮离子注入在 β-Ga₂O₃ 中的 SRIM 离子分布模拟。
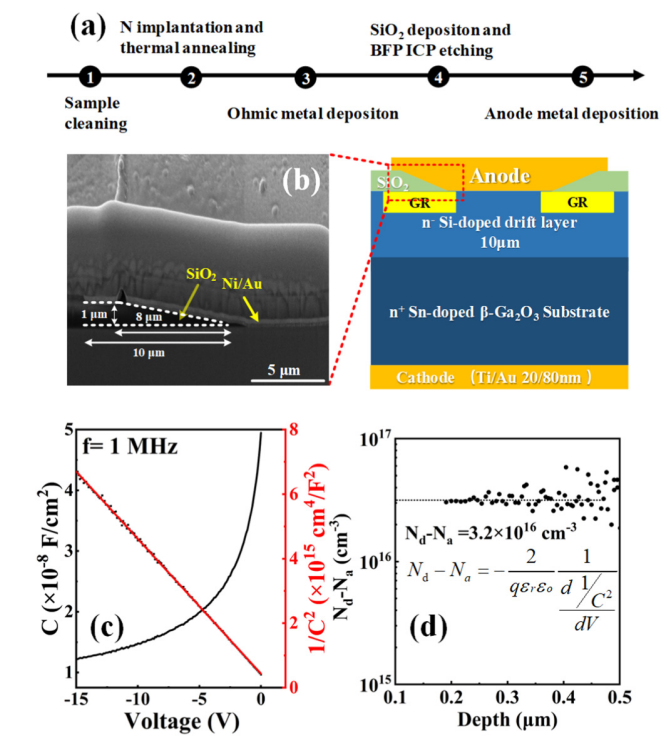
图 6. (a) β-Ga₂O₃ GR/BFP-SBD 的主要制备步骤。(b) GR/BFP-SBD 的截面 SEM 图。(c) GR/BFP-SBD 的 C–V 特性。(d) GR/BFP-SBD 提取的载流子浓度。
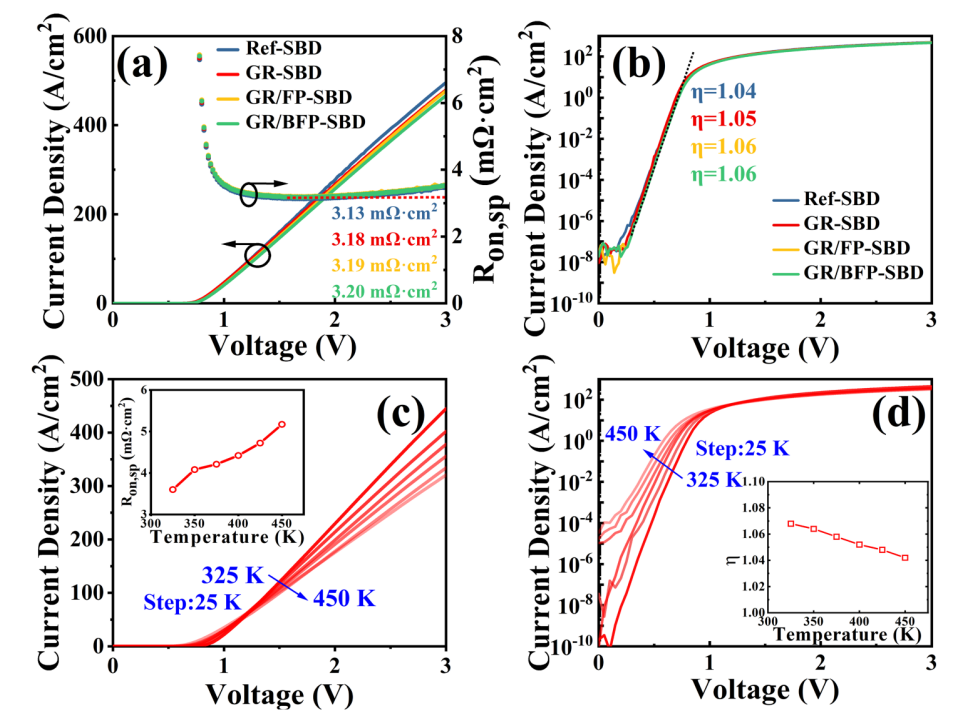
图 7. 四种器件的正向 I–V 曲线:(a) 线性坐标,(b) 半对数坐标。(c) GR/BFP-SBD 的温度依赖正向 I–V 特性(线性坐标),插图显示 Ron,sp 随温度变化。(d) GR/BFP-SBD 的温度依赖正向 I–V 特性(半对数坐标),插图显示理想因子随温度变化。
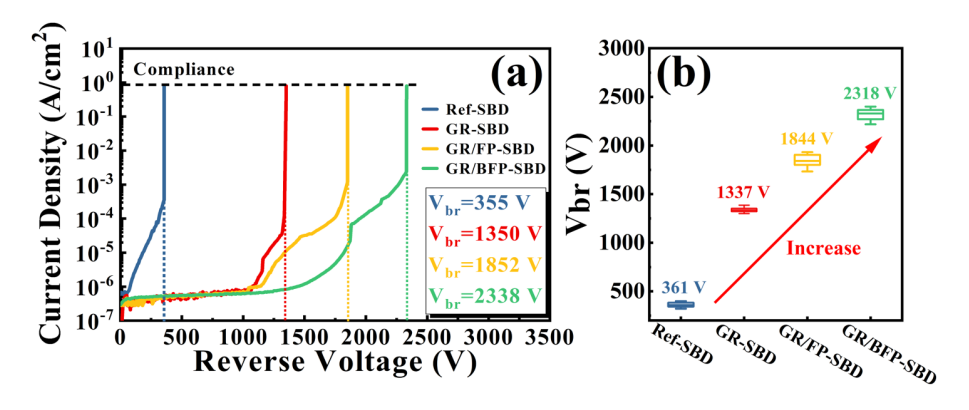
图 8. 四种器件的反向击穿特性:(a) 各器件的反向击穿曲线。(b) 每种结构测试的八个器件击穿电压的箱线图,箱线图显示不同器件的平均击穿电压值。
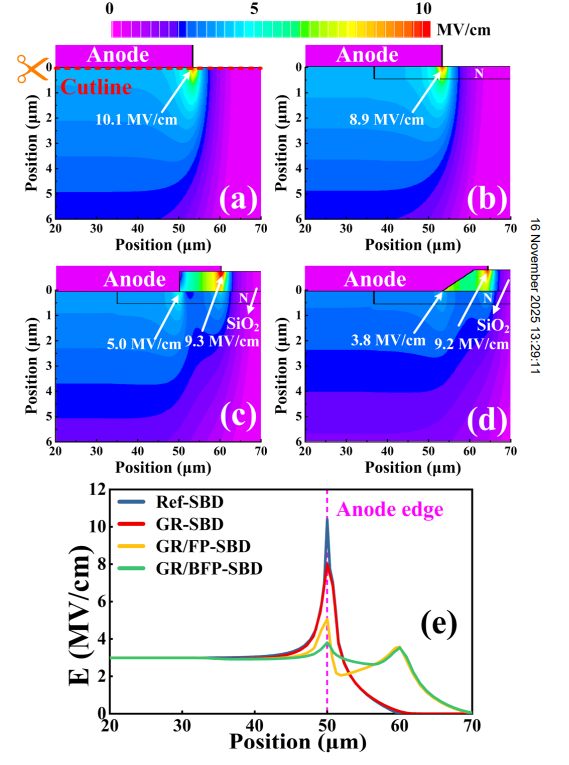
图 9. 在反向偏压 2338 V 下的二维电场分布模拟:(a) Ref-SBDs,(b) GR-SBDs,(c) GR/FP-SBDs,(d) GR/BFP-SBDs。(e) 四种器件在 β-Ga₂O₃ 表面的水平电场剖面。
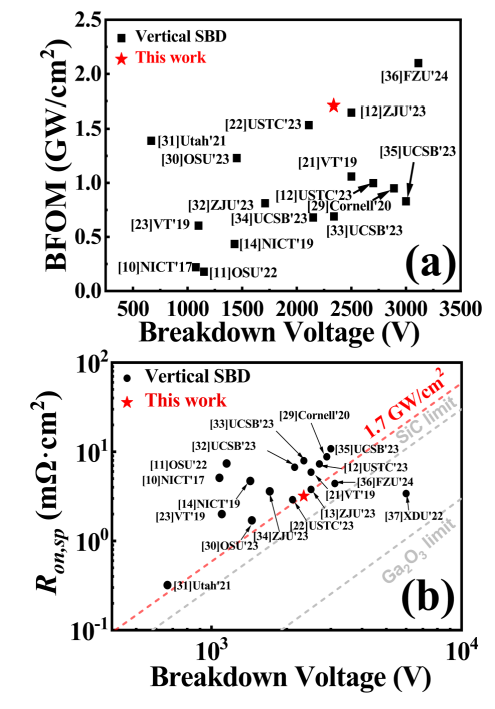
图 10. 报道的垂直 β-Ga₂O₃ SBD 的性能对比:(a) BFOM 与 Vbr 的关系,(b) Ron,sp 与 Vbr 的关系。
DOI:
doi.org/10.1116/6.0004965