

【会员论文】APL丨西电郝跃院士、张进成教授、周弘教授团队:采用金属-介质层-半导体结构与台面终端技术的高性能β-Ga₂O₃垂直二极管
日期:2025-12-14阅读:325
由西安电子科技大学郝跃院士、张进成教授、周弘教授的研究团队在学术期刊 Applied Physics Letters 发布了一篇名为 High-performance β-Ga2O3 vertical diodes integrating metal-interlayer-semiconductor architecture and mesa termination (采用金属-介质层-半导体结构与台面终止技术的高性能 β-Ga2O3 垂直二极管)的文章。
背景
β-Ga2O3 具有 4.8–4.9 eV 的超宽禁带、极高的临界电场以及大的 Baliga 品质因数,是下一代高压功率器件的核心候选材料。得益于低缺陷、可熔融生长的本征衬底的可获得性,器件在规模化及性能方面均取得了显著进展。然而,由于缺乏稳定的 p 型掺杂,实现传统的 p–n 结仍面临限制,使金属–半导体结构和异质结结构成为主流方案,但它们通常存在反向漏电高或开启电压偏大的固有瓶颈。为突破这些限制,在金属与半导体之间引入超薄界面层形成金属–介质层–半导体(MIS)结构,已成为抑制漏电、电势垒升高和优化界面质量的有效策略。同时,器件终端工程——包括场板、保护环以及台面终端——在调控电场分布方面至关重要,其中台面终端通过优化边缘电场分布,被证明能够显著提升器件的击穿性能。尽管已有 Al2O3、TiOx、BN 等多种界面层材料被研究,但采用本征 p 型 NiO 作为超薄插入层的垂直 Ga2O3 MIS 二极管仍鲜有系统性探索。尤其是超薄 NiO 与台面终端协同,在提高势垒高度、降低界面陷阱密度和改善整体电场管理方面的潜力尚未充分挖掘。因此,开发一种结合高质量超薄 NiO 介质层与自对准台面终端结构的 MIS 器件体系,对于实现高击穿电压、低漏电流和稳定导通特性具有重要意义。本研究正是为满足这一需求,通过引入热氧化形成的超薄 NiO 介质层并结合台面终端结构,构建了一种高性能的垂直 Ga2O3 MIS 二极管架构,实现了整流特性与击穿能力的显著提升,为先进功率电子器件的发展提供了有力支撑。
主要内容
本研究报道了基于 β-Ga2O3 的高性能金属-介质层-半导体(MIS)二极管,其特点是采用阳极自对准台面终端结构,并引入超薄 NiO 作为介质层。该多晶 NiO 介质层通过对电子束蒸发沉积的 5 nm Ni 薄膜进行热氧化获得,而台面终端结构则通过感应耦合等离子体刻蚀制备。高分辨透射电子显微镜观察表明,NiO 介质层呈多晶结构,且台面区域的侧壁角约为 84.6°。制备的 40 μm 半径台面 MIS 肖特基二极管表现出仅 1 V 的低开启电压与高达 2.45 kV 的击穿电压,同时保持 4.2 mΩ·cm2 的较低比导通电阻,对应的功率品质因数(PFOM)达到 1.43 GW/cm2,位列当前已报道 Ga2O3 MIS 及带台面终端二极管的最高水平之一。此外,器件还展示出 1011 的高开关比、可忽略的 C–V 与 I–V 滞后、1.2 的理想因子以及 74 mV/dec 的亚阈值摆幅,这些性能均得益于高品质的 NiO/Ga2O3 界面与出色的晶体质量。所制备的带台面终端结构的 β-Ga2O3 MIS 二极管展现了优异的开关特性,进一步推动 Ga2O3 技术在下一代功率电子器件中的应用。
总结
本研究通过在器件中引入超薄热氧化 NiO 介质层,并实现阳极自对准台面终端结构,成功制备了高性能的垂直 β-Ga2O3 金属-介质层-半导体(MMIS)肖特基二极管。器件展现出 2.45 kV 的高耐压、4.2 mΩ·cm2 的低比导通电阻,其功率品质因子(P-FOM)优于已有的 MIS 与 MMS 二极管。得益于介质层带来的 1.15 eV 势垒高度及优异的界面质量,器件表现出 1011 的超高整流比、74 mV/dec 的低亚阈值摆幅,并在双向 I–V 与 C–V 测量中呈现几乎无迟滞的特性。相比 MMS 结构,器件不仅具有更低的反向漏电流,还展现出优异的高温稳定性。这些结果凸显了 MIS 结构的优势,并表明 MMIS 器件在下一代功率整流器中具有强大潜力。
项目支持
本研究由国家自然科学基金(NSFC)资助,项目编号 62222407 和 62421005;由广东省基础与应用基础研究基金资助,项目编号 2023B1515040024。此外,本项目还得到了沙特阿拉伯吉达阿卜杜勒阿齐兹国王大学科研事务署(DSR)的部分资助,项目编号 IPP: 1424-135-2025,并提供了技术支持。
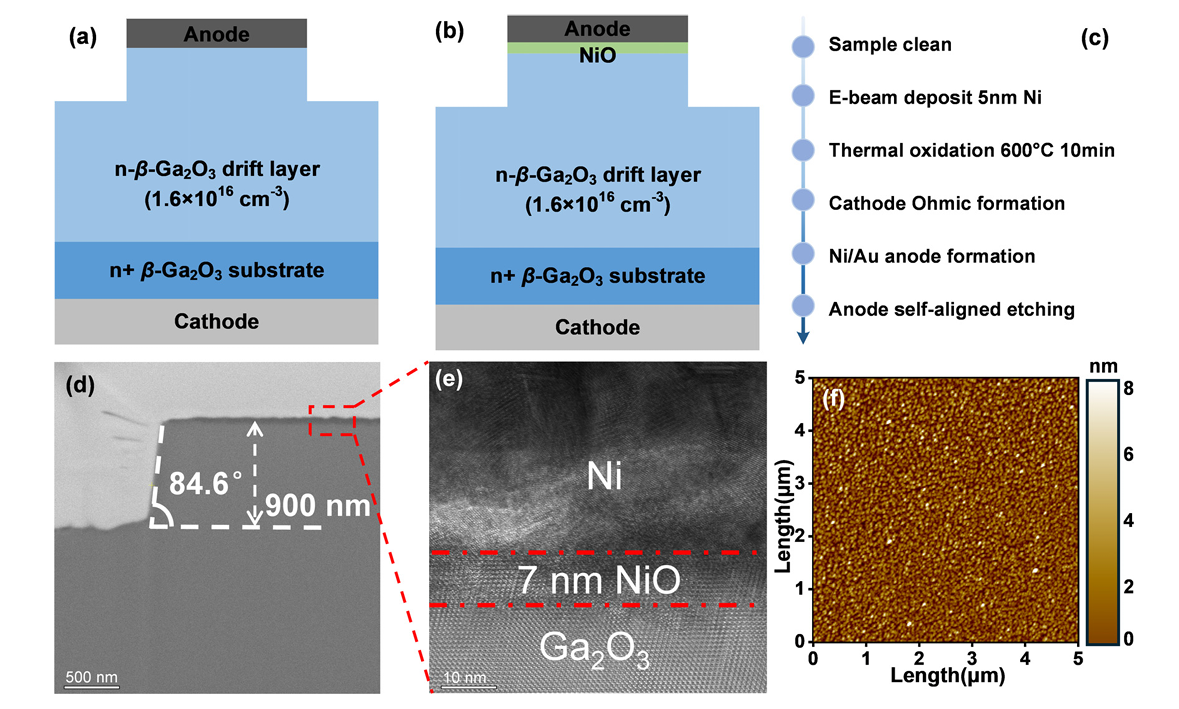
图 1. (a)MMS 二极管与(b)MMIS 二极管的截面示意图。(c)MMIS 二极管的制备流程。(d)MMIS 肖特基二极管的横截面 HR-TEM 图像与(e)放大界面图像表明器件具有垂直的台面终端结构以及多晶 NiO 介质层。(f)通过热氧化制备的 NiO 表面形貌的 AFM 图像。

图 2.(a)MMIS 二极管在 100 kHz 下的 C–V 与 1/C²–V 曲线,提取的内建电势 Vbi 为 1.7 V,净掺杂浓度为 1.6×10¹⁶ cm⁻³。(b)双向 C–V 扫描显示出可忽略的迟滞。

图 3.(a)正向 I–V 特性及微分 Rₒₙ,ₛₚ;(b)对数 I–V 曲线与理想因子,包含提取的势垒高度 φB与开/关比;(c)MS、MMS 和 MMIS 肖特基二极管的对数 I–V 曲线与 SS;(d)MMIS 二极管的双向 I–V 扫描,迟滞仅为 0.02 V;(e)MMIS 二极管在 25–225 ℃(步进 25 ℃)下的温度相关正向 I–V 特性;(f)Vₒₙ 与 Rₒₙ,ₛₚ 随温度变化的汇总。
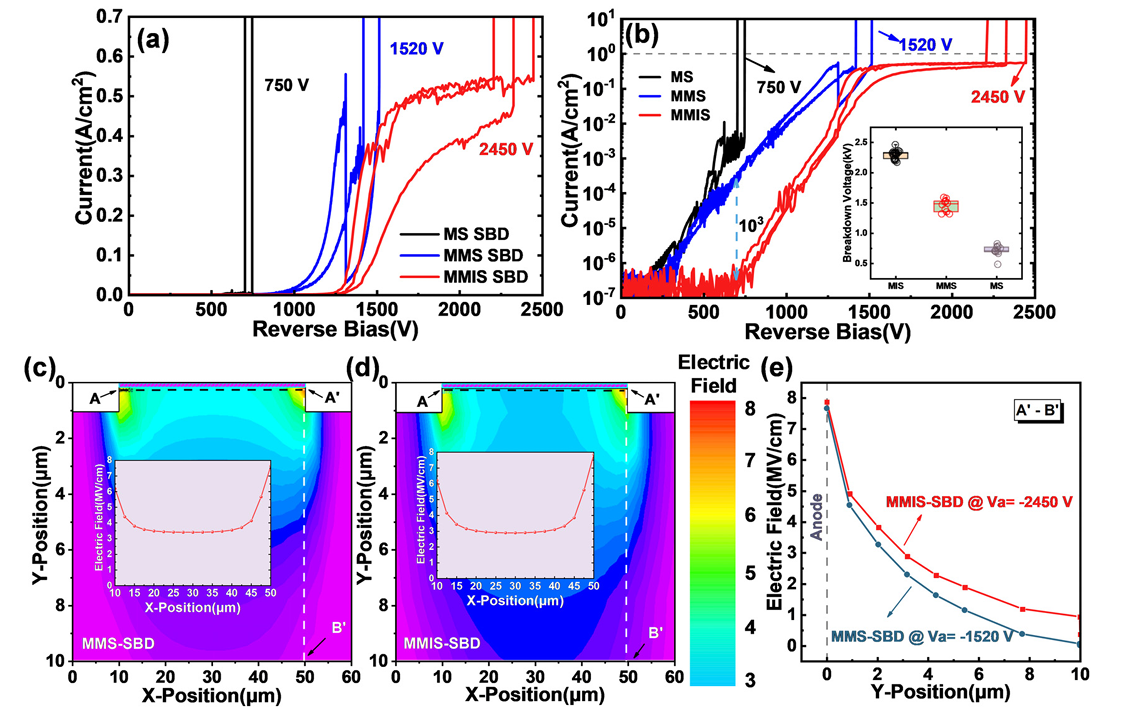
图 4.(a)线性坐标与(b)对数坐标的 Ir–Vr 特性,对应 40 μm 半径的 MS、MMS 和 MMIS 器件,插图为各类型器件耐压的统计分布。(c)MMS 与(d)MMIS 器件在偏置 1520 V 与 2450 V 时的电场分布模拟结果,插图为沿 A–A’ 的截线。(e)沿 A’–B’ 提取的电场强度验证了 MMIS 结构的有效性。
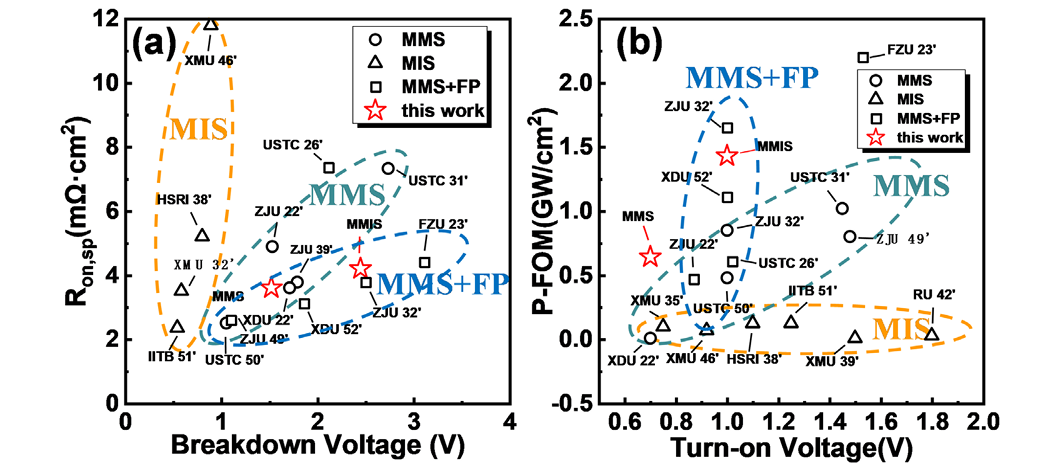
图 5.(a)代表性先进 MMS、MIS 以及 MMS+FP 二极管的比导通电阻与耐压基准对比;(b)功率品质因数(P-FOM)与开启电压的基准对比。
DOI:
doi.org/10.1063/5.0293221