

【国内论文】MTP丨甬江实验室-中国科学院宁波材料所:基于应变弛豫驱动的相变设计α/β-Ga₂O₃混合相异质结构以实现高压功率二极管
日期:2026-01-12阅读:167
甬江实验室-中国科学院宁波材料所超宽禁带半导体联合研究中心在学术期刊 Materials Today Physics 发布了一篇名为 Designing a Hybrid α/β-Ga2O3 Polymorph Heterostructure from Strain-Relaxed Phase Transition for High-Voltage Power Diodes(基于应变弛豫驱动的相变设计 α/β-Ga2O3 混合相异质结构以实现高压功率二极管)的文章。
背 景
氧化镓(Ga2O3)作为新兴的超宽禁带半导体,在高功率电子应用中展现出巨大潜力。其不同晶相特性各异:刚玉结构的 α-Ga2O3 拥有最宽的带隙(~5.3 eV)和高理论击穿场强,巴利加优值较高;而单斜结构的 β-Ga2O3 则具有更浅的施主能级与良好的载流子输运能力。近年来,将不同 Ga2O3 晶相集成为异质结构,以协同利用各自优势,成为一种富有吸引力的器件设计策略。然而,这需要对异质外延过程中的相形成、分布及掺杂激活进行精确控制。以往研究中,由应变驱动的 α 至 β 相变通常被视为损害薄膜质量和劣化器件性能的不利因素。本研究团队提出一种新的策略,利用这一相变行为构建一种 α/β-Ga2O3 混合相结构,基于该结构的薄膜具有独特的缺陷和传输特性,能显著提升横向肖特基二极管的击穿性能。
主要内容
超宽禁带(UWBG)氧化镓(Ga2O3)具有多种晶相,在高功率电子学和日盲光电子学领域展现出巨大潜力。基于混合 Ga2O3 多晶相结构设计电子器件极具吸引力,但始终面临外延挑战和有效掺杂激活问题的困扰。本研究报道了一种基于异质外延 α/β-Ga2O3 混合相结构的 3 kV 级别横向肖特基势垒二极管(SBD),该混合相结构由导电的 β-Ga2O3 相畴嵌入绝缘的 α-Ga2O3 相基体组成。α/β-Ga2O3 混合相结构通过由应变弛豫驱动的 α 向 β 相变构建而成,该相变强烈依赖于衬底取向和薄膜厚度。β-Ga2O3 相的形成对 α-Ga2O3 基体的晶体质量影响较小,并且对于溅射生长的薄膜表现出更易于实现掺杂元素的有效激活。基于此混合 α/β-Ga2O3 异质结构的横向 SBD,结合了 β-Ga2O3 的良好载流子传输优势和 α-Ga2O3 的优异击穿场强优势,从而实现了良好的整流特性和 3 kV 的击穿电压,该击穿电压值是单相 β-Ga2O3 的对照器件的二倍。本研究为开发先进 UWBG 电子器件,在相设计策略上提供了关键见解。
创新点
● 通过磁控溅射技术生长出低位错密度的 α-Ga2O3 薄膜。
● 设计了一种具有独特缺陷特性的 α/β-Ga2O3 混合相结构。
● 基于该混合相结构实现了击穿电压 3 kV 级的横向肖特基二极管。
结 论
本研究展示了一种利用应变弛豫驱动相变形成的 α/β-Ga2O3 混合相异质结构,用于调控载流子输运特性并构建高压横向肖特基势垒二极管(SBD)。该 α/β-Ga2O3 异质结构由导电的 β-Ga2O3 相畴嵌入绝缘的异质外延 α-Ga2O3 相基体组成。这种独特的结构是通过磁控溅射生长过程中应变弛豫驱动的 α 向 β 相变实现的,其相演化与分布关键取决于蓝宝石衬底的取向和薄膜厚度。综合缺陷与输运表征进一步表明,Sn 掺杂元素在 β-Ga2O3 相中更容易被激活。嵌入在 α/β-Ga2O3 异质结构中的 β-Ga2O3 相畴对 α-Ga2O3 基体的晶体质量影响甚微,但显著提高了薄膜的整体导电性。基于该独特 α/β-Ga2O3 异质结构的横向 SBD,与单相 β-Ga2O3 二极管相比,表现出更优异的击穿性能:在 25 °C 时击穿电压超过 3 kV,在 150 °C 时仍超过2 kV。
项目支持
本研究得到国家自然科学基金(62304227)、中国博士后科学基金(2025M773410)、 浙江省自然科学基金(LQ23F040005、LQN25F040011)以及宁波甬江引才工程(2021A-046-C、2024A-441-G)。

图1. (a) 通过磁控溅射法在 m、a、r 和 c 面蓝宝石衬底上生长厚度为 150 nm 的 Ga2O3 薄膜的高分辨率 XRD 的θ-2θ 扫描图谱。(b) Ga2O3 薄膜的光学透射率图谱。插图为用于估算薄膜直接光学带隙的 Tauc 图。(c) Ga2O3 薄膜的原子力显微镜图像。(d) 生长在 m、a、r 面蓝宝石衬底上 Ga2O3 薄膜的不同晶面 XRD摇摆曲线(XRC)图。(e) XRC 半高峰宽值 (W) 随倾斜角变化曲线。虚线为采用 Srikant 等提出的模型进行的最小二乘拟合。插图为进行测试的几何构型示意图。(f) 比较生长于 m、a、r 及c面蓝宝石衬底上 Ga2O3 薄膜的 XRC 半高峰宽值、表面粗糙度及光学带隙的对比图。
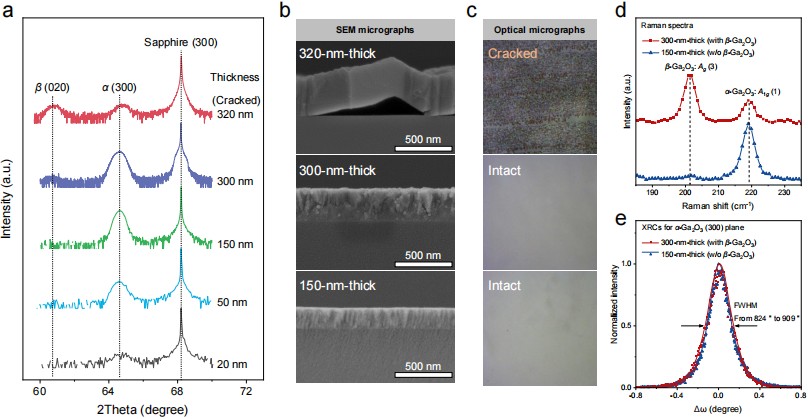
图2. (a)生长于 m-蓝宝石衬底上的不同厚度 Ga2O3 薄膜的高分辨率 XRD 的θ-2θ 扫描图谱。(b) 不同厚度 Ga2O3 薄膜的 SEM 微观图像及 (c) 光学图像。(d) 厚度为300 nm 的薄膜与厚度为150 nm 的薄膜的拉曼光谱图。(e) 厚度为300 nm的薄膜与厚度为150 nm的薄膜的 α-Ga2O3 (300) 晶向 XRD 摇摆曲线图。
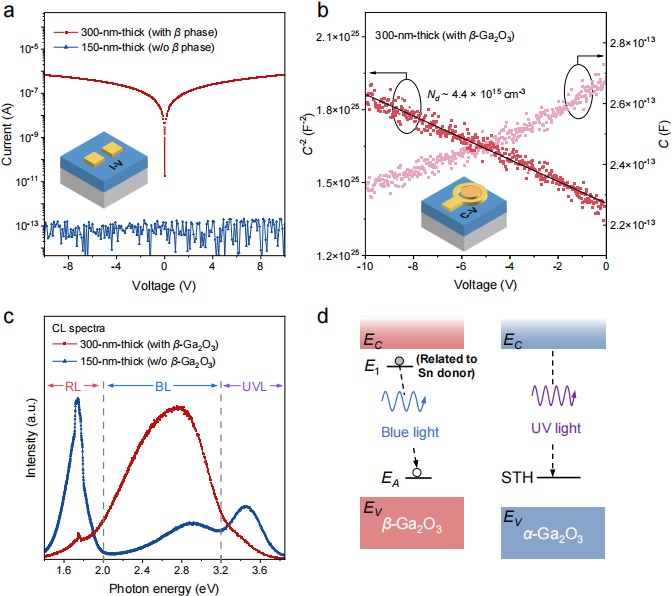
图3. (a) 300 nm 厚的相混合 α/β-Ga2O3 薄膜与 150 nm 厚的单相 α-Ga2O3 薄膜在平面双电极结构中的 I-V 特性曲线。Ti/Al/Ni/Au 金属堆叠层作为欧姆接触层,间距统一为 35 μm。(b) 300 nm 厚的相混合 α/β-Ga2O3 薄膜在横向 SBD 结构中的 C-V 特性曲线。Ti/Al/Ni/Au 与 Pt/Au 金属堆叠层分别作为阴极和阳极,间距为 15 μm。(c) 300 nm 厚的相混合 α/β-Ga2O3 薄膜与 150 nm 厚的单相 α-Ga2O3 薄膜的阴极荧光光谱。光谱在 5 kV 加速电压下测得。(d) 分别解释 β-Ga2O3 的蓝光发射机制与 α-Ga2O3 的紫外光发射机制的示意图。
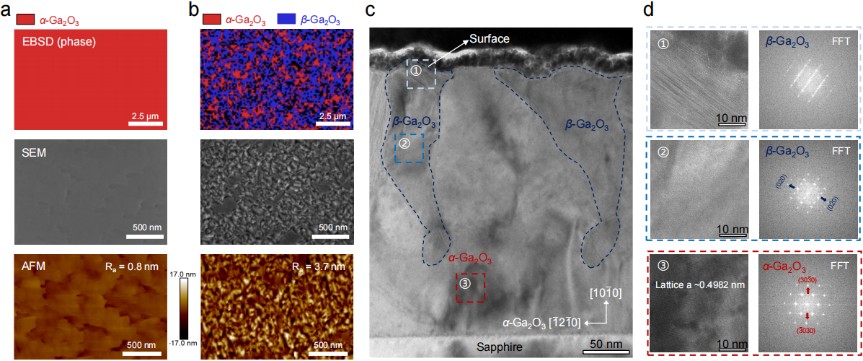
图4. 分别展示了 (a) 150 nm 厚的单相 α-Ga2O3 薄膜与 (b) 300 nm 厚的相混合 α/β-Ga2O3 薄膜的 EBSD 相图、SEM 图像及 AFM 图像。(c) 沿 α-Ga2O3 [0001] 晶轴投影的 300 nm 厚的相混合 α/β-Ga2O3 薄膜截面透射电子显微镜图像。(d) 图 4c 中彩色矩形框选区域的放大视图,附对应的 FFT 图谱。
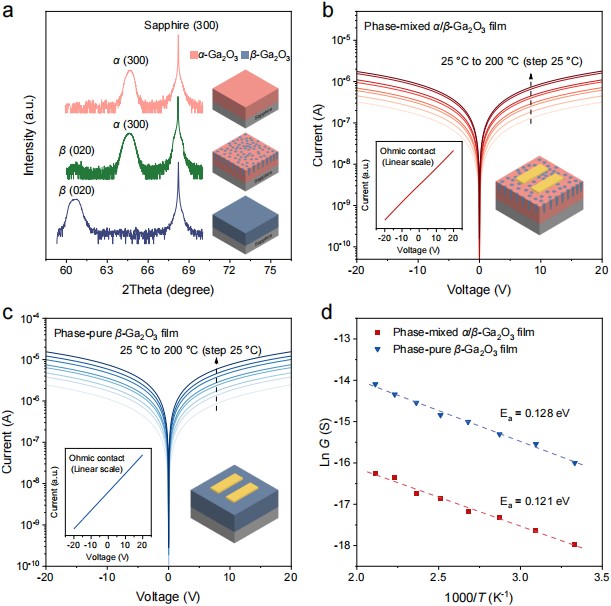
图5. (a) 厚度为 150 nm 的单相 α-Ga2O3 薄膜、厚度为 300 nm 的相混 α/β-Ga2O3 薄膜以及厚度为 300 nm 的单相 β-Ga2O3 薄膜的高分辨率 XRD 的θ-2θ 扫描图谱。(b) 混合相 α/β-Ga2O3 薄膜与 (c) 单相 β-Ga2O3 薄膜在平面双电极结构中测得的 25 ℃ 至 200 ℃ 温度依赖性 I-V 特性曲线。Ti/Al/Ni/Au 金属堆叠层作为欧姆接触电极。(d) 基于温度依赖性电导 (G) 数据提取的 Arrhenius 图,用于估算相混合 α/β-Ga2O3 薄膜与单相 β-Ga2O3 薄膜的传输激活能,虚线表示数据的线性拟合。
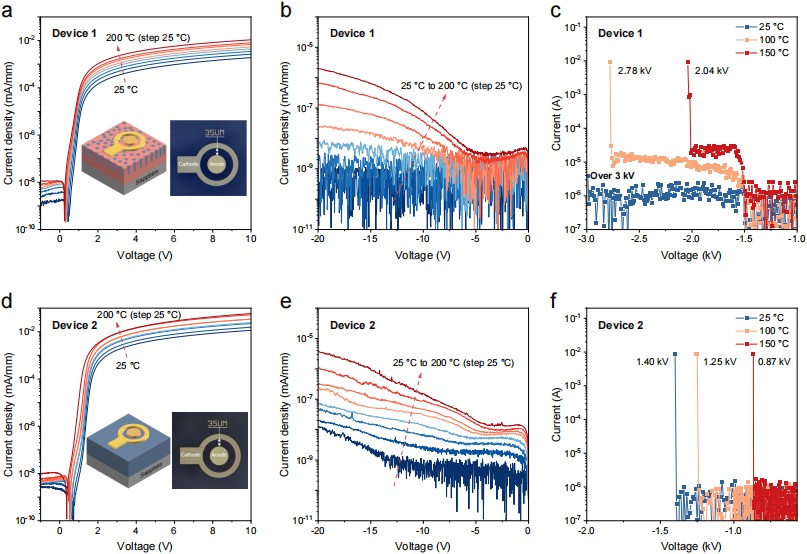
图6. 分别以对数刻度显示的 (a) 器件 1 和 (d) 器件 2 的正向 I-V 特性曲线。插图为横向 SBD 的示意图及俯视光学图像。分别以对数刻度显示的 (b) 器件 1 和 (e) 器件 2 的反向 I-V 特性曲线。测量在 25 ℃ 至 200 ℃ 范围内进行,温度步进为 25 ℃。图 (c) 和 (f) 分别展示器件 1 和器件 2 的反向击穿特性曲线。测量在 25 ℃、100 ℃ 和 150 ℃ 三种温度下完成。
DOI:
doi.org/10.1016/j.mtphys.2026.102010