

【会员论文】APL丨复旦大学:用于铁电Hf₀.₅Zr₀.₅O₂电容器中薄Ga₂O₃插入层对相结构和电学性能演变的影响
日期:2026-01-15阅读:225
由复旦大学的研究团队在学术期刊 Applied Physics Letters 发布了一篇名为Thin Ga2O3 insertion layer for phase structure and electrical property evolutions in ferroelectric Hf0.5Zr0.5O2 capacitors (用于铁电 Hf0.5Zr0.5O2 电容器中薄 Ga2O3 插入层对相结构和电学性能演变的影响)的文章。
背景
2011 年,研究人员首次发现掺杂氧化铪具有铁电性,这一发现彻底改变了铁电领域。与传统的钙钛矿结构铁电材料不同, HfO2 基材料与现有的标准 CMOS 工艺完全兼容。该材料在厚度小于 10 nm 时仍能保持优异的铁电性,满足了先进半导体制程对器件极度小型化的需求。基于 HfO2 铁电体,可以开发新型非易失性存储器(NVM),如铁电随机存储器(FeRAM)、铁电隧道结(FTJs)和铁电场效应晶体管(FeFETs)。在氧化铪基体系中,Hf0.5Zr0.5O2 (HZO) 是研究最广泛的,因其具有稳定的铁电相,且相比于其他掺杂方式,其制造工艺窗口更宽。HZO 的典型矫顽场(Ec)约为 1.0 MV/cm,这非常接近其临界击穿电场(EBD,约 4.0 MV/cm)。较窄的电场窗口限制了器件的耐受力和长期工作稳定性,易导致电介质击穿或极化退化。为了优化性能,研究者开始尝试在 HZO 中嵌入薄层。氧化镓(Ga2O3)因其具有很高的理论击穿电场以及降低矫顽场的潜力,成为本研究重点关注的对象。通过原子层沉积(ALD)在 HZO 膜中嵌入不同厚度的 Ga2O3 插入层,探究其对器件相结构、极化特性及漏电流的影响。
主要内容
在本研究中,采用原子层沉积(ALD)技术在Hf0.5Zr0.5O2(HZO)薄膜中嵌入了不同厚度的氧化镓(Ga2O3)插入层(ILs)。当 Ga2O3 插入层的 ALD 沉积周期少于 4 次时,器件的残余极化(Pr)和矫顽场(Ec)均呈现降低趋势。值得注意的是,采用 2 个 ALD Ga2O3 周期的器件表现出优异性能,实现 2Pr 值达 47.0μC/cm2,Ec 值达 0.92MV/cm。相反,当介质层经历超过 8 个 ALD Ga2O3 沉积周期时,2Pr 值维持在 18μC/cm2 左右,而 Ec 显著增大。这种差异可归因于插层介质的不同扩散状态:在 ALD Ga2O3 沉积周期较少时,Ga3+ 离子向介质层邻近的 HZO 区域扩散导致 Ec 降低; 反之,当 ALD Ga2O3 沉积周期增加时,离子液体形成连续层物理分割 10nm HZO 薄膜,导致 Pr 值进一步降低而 Ec 值上升。此外,生长中的插层离子液体层持续破坏垂直晶界,使漏电流呈持续下降趋势。本研究通过 Ga2O3 插入层有效调控 HZO 器件性能,为提升器件可靠性提供了方法论与数据参考。
创新点
•揭示了 Ga2O3 插入层从离子掺杂扩散向连续应力层转变的物理过程。
•证明了通过引入超薄 Ga2O3,可以在不牺牲核心铁电性能的前提下,显著增强 HZO 器件的击穿强度和长期稳定性。
•为制造高可靠性、长寿命的氧化铪基铁电存储器提供了具体的技术路线,尤其是在低功耗电子设备领域具有广泛前景。
总结
本研究系统探讨了 Ga2O3 离子液体对 HZO 薄膜铁电特性的影响,揭示了两种取决于离子液体厚度(IL)的截然不同机制。在低 ALD Ga2O3 沉积周期下,扩散至 HZO 薄膜中的 Ga3+ 促进 t 相形成,同时降低 2Pr 和 Ec 参数。然而当厚度超过临界值时,离子液体形成连续层破坏了 HZO 晶体结构。这导致 2Pr 值因 Ga3+ 置换受抑制而趋于稳定,同时 Ec 值显著增大——其成因包括但不限于:介质层的电压分压效应及横向晶界密度增加。随着 IL 厚度增加,漏电流呈持续下降趋势(源于晶界破坏),从而提升器件耐用性。通过 2 个 ALD Ga2O3 沉积周期实现了最佳平衡:2Pr 值高达 47.0 μC/cm2,Ec 值降至 0.92 MV/cm,耐用性提升约两个数量级。本研究最终证实 Ga2O3 离子液能有效调控 HZO 的铁电行为,为定制化应用这类薄膜提供了明确指导。
项目支持
本工作部分由国家自然科学基金(62027818、11974320)资助, 中国国家重点研发计划项目(2021YFB3202500),第三代半导体功率器件制造原子层沉积设备专项(2024GXGG004),以及MIND项目(MINDXZ202402)。
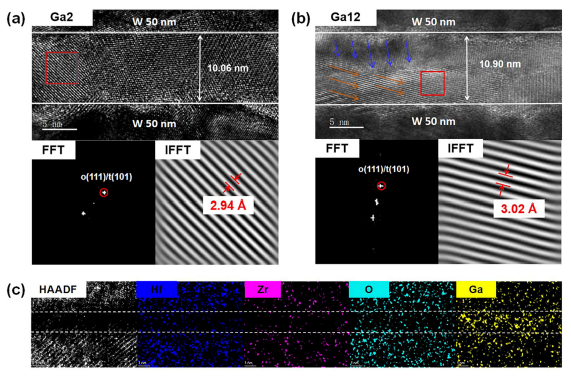
图1. (a) 和 (b) 分别为 Ga2 和 Ga12 样品的透射电子显微镜截面图像。(c) Ga12 样品铁电薄膜区域的能谱元素映射图。

图2. 基线扣除后的 XPS 光谱:(a)Ga 2p,(b)Hf 4f,(c)Zr 3d 谱。同时对比了不含离子液体样品的 Hf 4f 和 Zr 3d 谱。

图3. 采用 GIWAXS 技术对样品薄膜进行的晶体学分析。(a) 不同 Ga2O3 离子液体厚度样品的 GIWAXS 处理结果。分别提取了 (b) 峰位、(c) 半高全宽 (FWHM) 和 (d) 纵横比参数,针对 o(111)/t(101) 与 o(002)/t(110) 晶面峰进行分析,并绘制成原子层沉积 Ga2O3 循环次数的函数曲线。
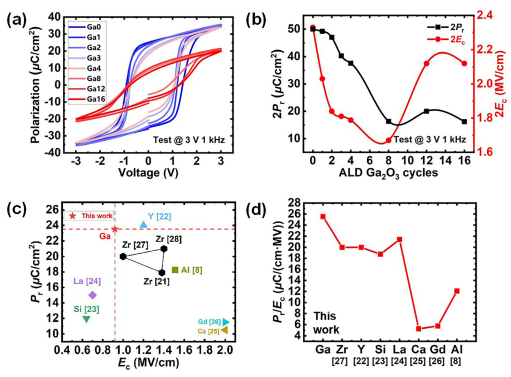
图4. 不同 Ga2O3 介电层的 HZO 薄膜铁电特性。(a) 制备器件测得的压-体积环。(b) 从压-体积环提取的 2Pr 和 Ec 值,作为原子层沉积 Ga2O3 循环次数的函数绘制。(c) 基准图:本工作 Ga2 样品的 Pr 与 Ec 值与其他报道的掺杂 HfO2 基铁电薄膜对比。(d) (c)中各工作计算得到的 Pr/Ec 比值。
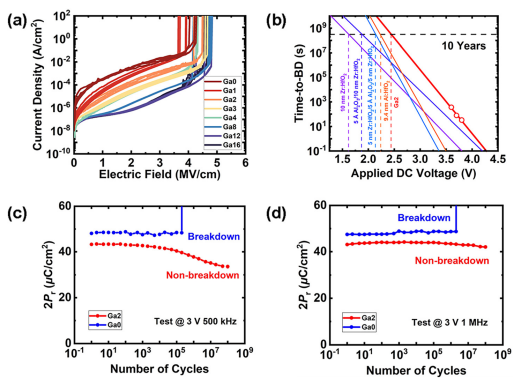
图5. (a) 不同 ALD Ga2O3 沉积周期的电容器 TZDB 特性曲线。(b) 不同 ALD Ga2O3 沉积周期器件在 63.2 % 失效率下的长寿命直流电压外推曲线(与其他文献报道对比)。(c) Ga0 与 Ga2 材料在 500 kHz 频率下的耐受特性,(d) 1 MHz 频率下的耐受特性。
DOI:
doi.org/10.1063/5.0301196








