

【会员论文】APL | 武汉大学张召富教授:掺杂剂-VGa复合缺陷在Si/Ge/Sn/Zr掺杂β-Ga₂O₃中引发载流子抑制的普适作用
日期:2026-02-02阅读:108
武汉大学张召富教授近日在Applied Physics Letters上发表了题为Universal Role of Dopant-VGa Complexes Induced Carrier Suppression in Si/Ge/Sn/Zr-doped β-Ga2O3 (掺杂剂-VGa复合缺陷在Si/Ge/Sn/Zr掺杂β-Ga2O3中引发载流子抑制的普适作用)的文章。武汉大学博士生刘太巧和九峰山实验室刘兴林为论文共同第一作者,武汉大学集成电路学院刘胜院士团队的张召富教授为论文通讯作者。
背 景
β-Ga2O3凭借其超宽禁带(~4.9 eV),高击穿电场,被视为高功率电子器件领域的关键材料。在此背景下,实现高效且稳定的n型掺杂是推动β-Ga2O3在电子器件实际应用的基础。Si, Sn, Ge, Zr等掺杂剂可在β-Ga2O3中形成浅施主缺陷,但其n型掺杂效率受“自补偿”效应制约,导致载流子浓度难以进一步提高。尽管已有研究已将VGa识别为关键补偿缺陷,然而与上述四种主要n型掺杂剂相关的系统性原子尺度补偿机制,包括它们的形成起源和能级位置,目前尚未得到完全理解。
主要内容
为揭示其微观机制,本研究结合第一性原理计算与实验方法,系统探究了Si、Sn、Ge、Zr四种关键n型掺杂剂的补偿行为,揭示了氧化镓n型掺杂中的普适性自补偿机制。研究结果表明,这四种掺杂剂均易与镓空位(VGa)结合形成稳定的“掺杂剂-VGa”复合缺陷。在富氧条件下,SiGaVGa、SnGaVGa复合缺陷的缺陷形成能比GeGaVGa、ZrGaVGa更低,缺陷浓度更高,因此在Si和Sn掺杂中表现出更显著的补偿作用。通过对Sn掺杂氧化镓衬底进行氧气退火实验与电学表征,霍尔效应与非接触涡流法电阻率测试一致表明:氧气退火诱导了强烈的补偿效应,导致载流子浓度大幅下降。此外,光致发光光谱在约2.5 eV处观测到明显的绿光发射峰,证实了深能级缺陷SnGaVGa的存在。
结 论
本研究采用理论计算与实验验证相结合的方法,对n型β-Ga2O3中的自补偿效应进行了深入探究。基于密度泛函理论的计算表明,稳定的XGaVGa(X = Si、Ge、Sn、Zr)复合物是导致载流子补偿的主要缺陷中心,严重制约了材料的n型导电能力。其中,SiGaVGa与SnGaVGa复合物的形成尤为显著。该理论预测在Sn掺杂β-Ga2O3体系中得到了实验证实:经氧气退火处理后,材料的载流子浓度由约1018 cm-3(室温霍尔测量)降至1016 cm-3(通过大于600 K的高温霍尔测量)。PL光谱在约2.5 eV处出现了与深能级缺陷相关的特征发射峰,与退火过程中形成的SnGaVGa复合物对应良好,进一步支持了上述缺陷构型的形成。此项工作从原子尺度阐明了不同掺杂体系中自补偿效应的共同物理起源,为通过调控退火氛围、抑制缺陷形成以优化β-Ga2O3电导率提供了关键理论与实验依据,对推动其在高性能功率电子器件中的应用具有重要意义。
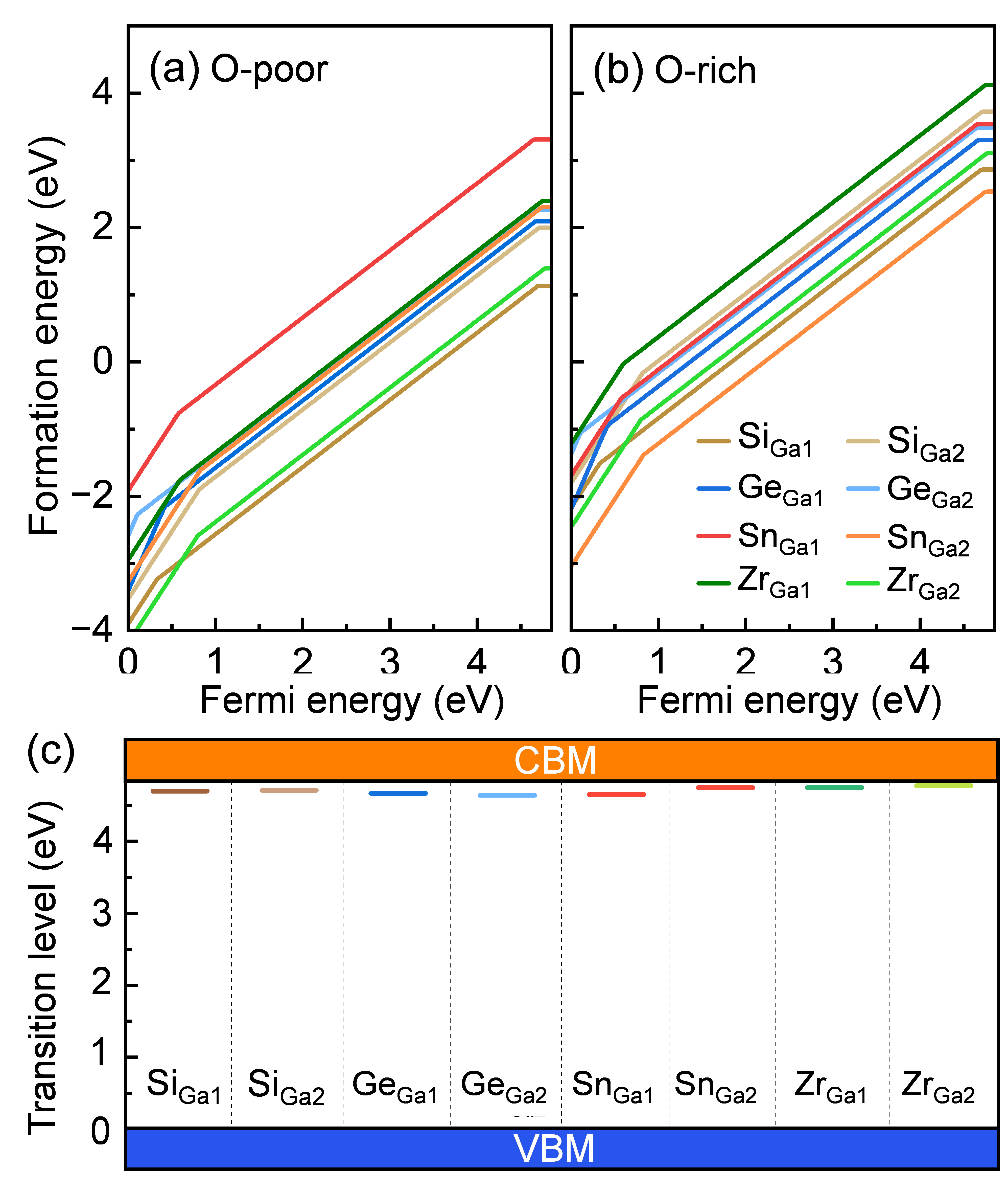
图1 Si, Ge, Sn, Zr取代β-Ga2O3的Ga位点的缺陷形成能在(a)贫氧和(b)富氧条件下随费米能级的变化。(c) 转变能级。Ga1为四面体位点,Ga2为八面体位点。
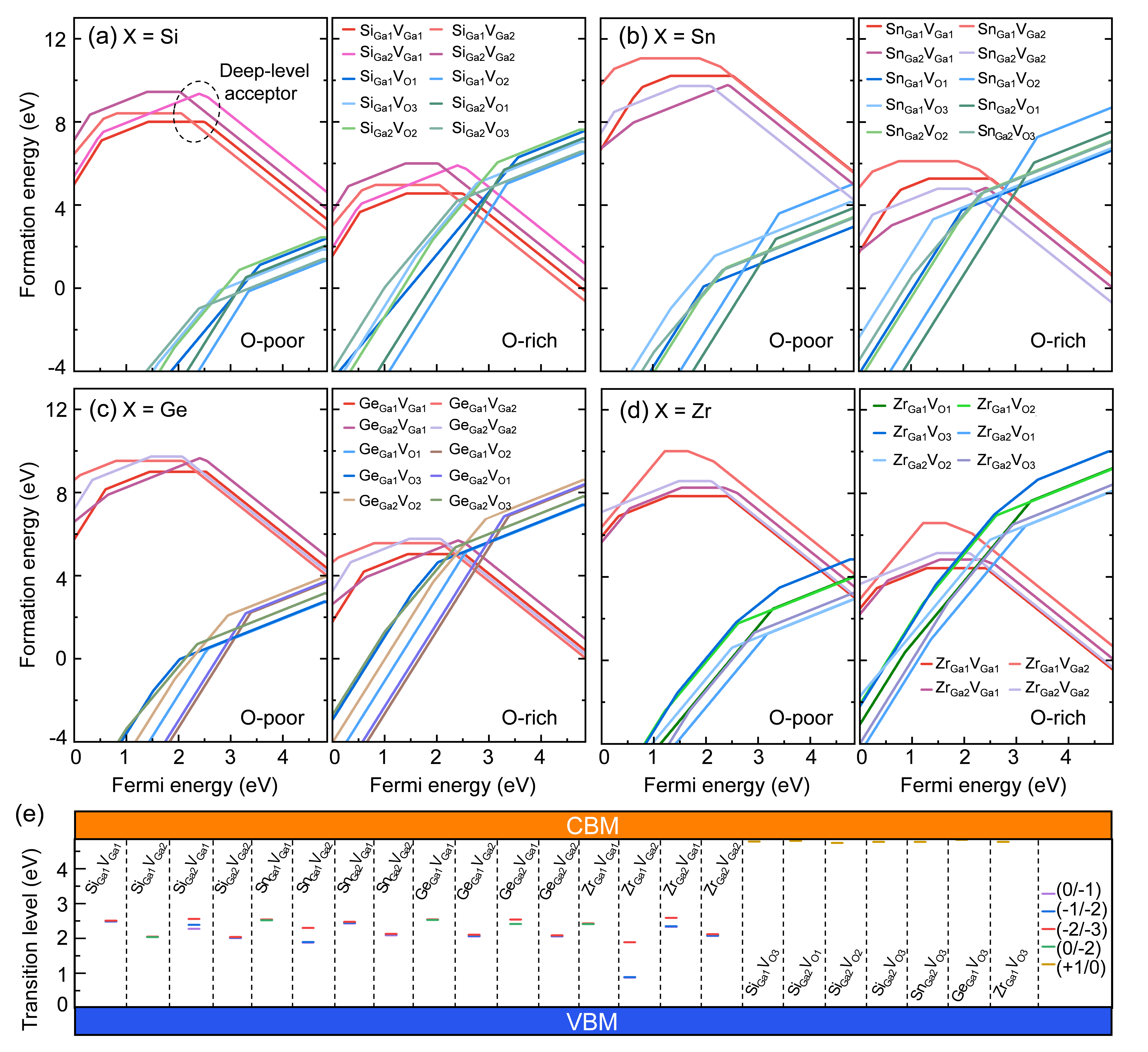
图2 复合缺陷XGaVGa和XGaVO(X = (a) Si, (b) Sn, (c) Ge, and (d) Zr)的缺陷形成能随费米能级的变化;(e) 复合缺陷XGaVGa和XGaVO的转变能级。
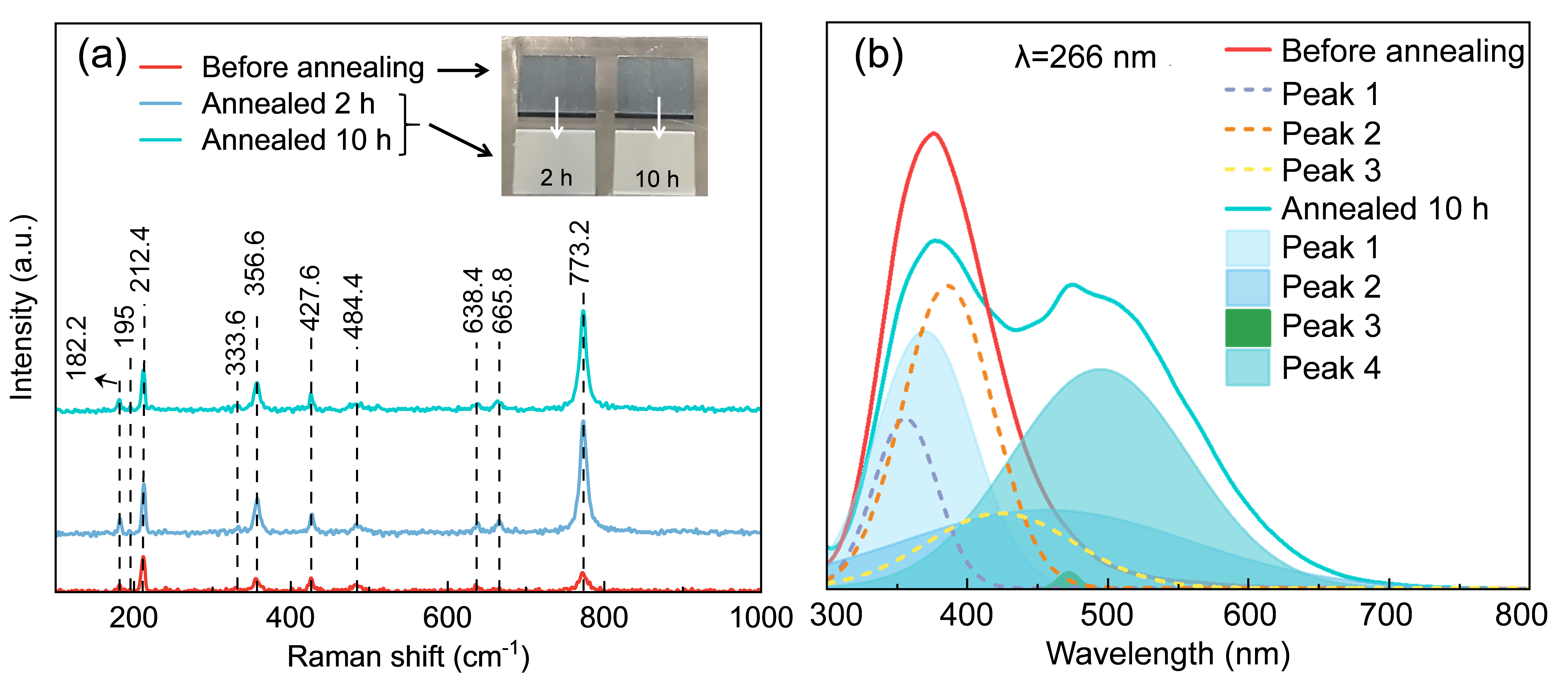
图3 (a) Sn掺杂β-Ga2O3衬底在退火前和退火2 h和10 h的拉曼光谱;(b) 退火前和退火10h后PL光谱对比。
DOI:
10.1063/5.0301321