

【会员论文】复旦大学马宏平教授团队:Ga₂O₃功率与光电子器件中Mist-CVD技术的综述
日期:2026-02-02阅读:124
由复旦大学马宏平教授的研究团队在学术会议2025 22nd China International Forum on Solid State Lighting & 2025 11th International Forum on Wide Bandgap Semiconductors (SSLCHINA: IFWS)发布了一篇名为Review of Mist-CVD Technology for Ga₂O₃ Power and Optoelectronic Devices(Ga₂O₃功率与光电子器件中Mist-CVD技术的综述)的文章。
背 景
随着新能源汽车、5G 通信、光伏及储能等新兴产业的快速发展,以及全球技术竞争的加剧,功率电子领域对更高性能半导体材料的需求不断增加。虽然碳化硅(SiC)和氮化镓(GaN)已被广泛应用,但它们可能并非功率电子材料发展的最终前沿。近年来,氧化镓(Ga₂O₃)因其宽禁带、高击穿电场以及大面积原生衬底可用性等优异固有特性,受到各国政府和产业界的高度关注,成为具有巨大增长潜力的战略性新兴产业材料。Ga₂O₃ 在高压开关器件和日盲紫外光电探测器等应用中展现出巨大潜力,但其技术发展关键依赖于能够高质量、低成本、可大面积制备薄膜的外延生长工艺。传统外延技术如分子束外延(MBE)、金属有机化学气相沉积(MOCVD)和氢化物气相外延(HVPE)虽然可制备高质量薄膜,但通常存在设备成本高、操作复杂、可扩展性受限等问题。在此背景下,雾化化学气相沉积(Mist-CVD) 因其非真空操作、工艺简单、对掺杂浓度和薄膜厚度的精确控制等优势,成为一种有前景的替代方案。研究表明,Mist-CVD 可在大面积衬底上低成本制备高质量 Ga₂O₃ 薄膜,并成功应用于肖特基二极管(SBD)、MESFET、MOSFET 及日盲紫外光电探测器,为学术研究与工业化应用提供了可靠途径。
主要内容
氧化镓(Ga₂O₃)是一种超宽禁带(UWBG)半导体,因其宽禁带(4.6–4.9 eV)、高击穿电场以及可获得大面积衬底的优势,被广泛认为是下一代功率电子器件和光电子器件的有前景材料。然而,Ga₂O₃ 器件的实际商业化需要能够以低成本、高效率制备高质量外延层的技术。雾化化学气相沉积(Mist-CVD)作为一种有潜力的替代方案应运而生,可有效解决这些限制。Mist-CVD 的特点包括无需真空、工艺简单、成本低廉,并且兼容大面积生长,同时能够精确控制掺杂浓度、薄膜厚度及晶体质量。这些优势使其在推进 Ga₂O₃ 器件的科研和商业化方面具有很大吸引力。在功率电子领域,采用 Mist-CVD 生长的 Ga₂O₃ 已成功应用于肖特基势垒二极管(SBD)、金属-半导体场效应晶体管(MESFET)以及金属-氧化物半导体场效应晶体管(MOSFET),展现出具有竞争力的工作电压和漏电流性能。在光电子领域,Ga₂O₃ 本征的吸收边约为 250 nm,可天然实现日盲紫外探测,无需进行带隙工程。因此,Mist-CVD 生长的 Ga₂O₃ 薄膜非常适合用于日盲光电探测器和深紫外传感器,表现出高响应度、低暗电流和优异的光谱选择性。本文综述了 Mist-CVD 在 Ga₂O₃ 功率电子与光电子器件中的最新应用进展,并讨论了其工业化部署所面临的挑战及未来发展前景。
总 结
根据综述可知,雾化化学气相沉积(Mist-CVD)已成为制备基于 Ga₂O₃ 的功率器件和光电子器件的一种高度竞争且多功能的外延技术。其独特优势包括无需真空操作、成本低、工艺简单,并且兼容大面积衬底,成功解决了传统方法如 MBE 和 MOCVD 的关键局限性。在功率电子领域,采用 Mist-CVD 生长的 Ga₂O₃ 已实现高性能的肖特基二极管(SBD)、MESFET 和 MOSFET,表现出优异的击穿电压、低特性导通电阻以及卓越的功率性能指标。在光电子领域,该技术可制备高质量日盲光电探测器薄膜,实现了出色的响应度、超低暗电流和高探测率。研究结果表明,Mist-CVD 不仅能够精确调控薄膜的组成和厚度,还可提升器件的电学与光学性能。总体而言,本工作系统总结了 Mist-CVD 作为一种有前景且可规模化的下一代半导体器件制备技术的应用价值。
项目支持
本工作得到中国国家重点研发计划(2023YFB4606300)、中国国家自然科学基金(62474049)、上海市科学技术委员会科技创新专项计划(编号:21DZ110080,23ZR1405300)以及长三角科技创新共同体联合研究计划(编号:2023CSJG0600)的资助。

图 1. 近期关于 Mist-CVD 制备 Ga₂O₃ 器件的先进研究。
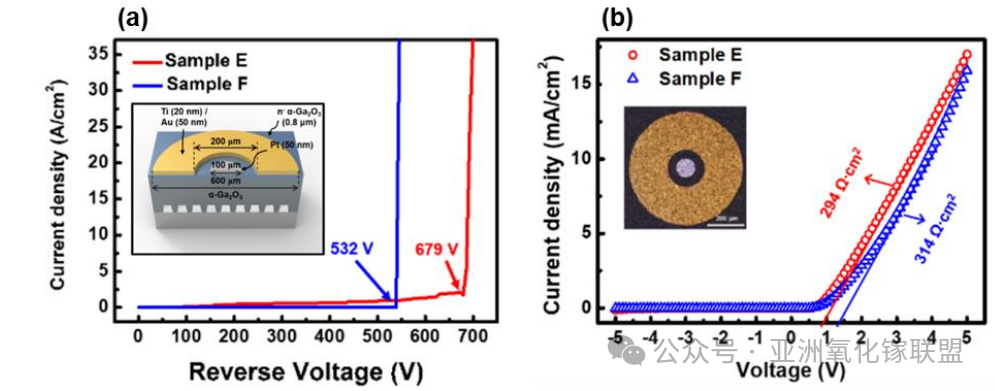
图 2. (a) 样品 E 与 F 的击穿电压比较,(b) 样品 E 与 F 的 J−V 特性,显示特性导通电阻。
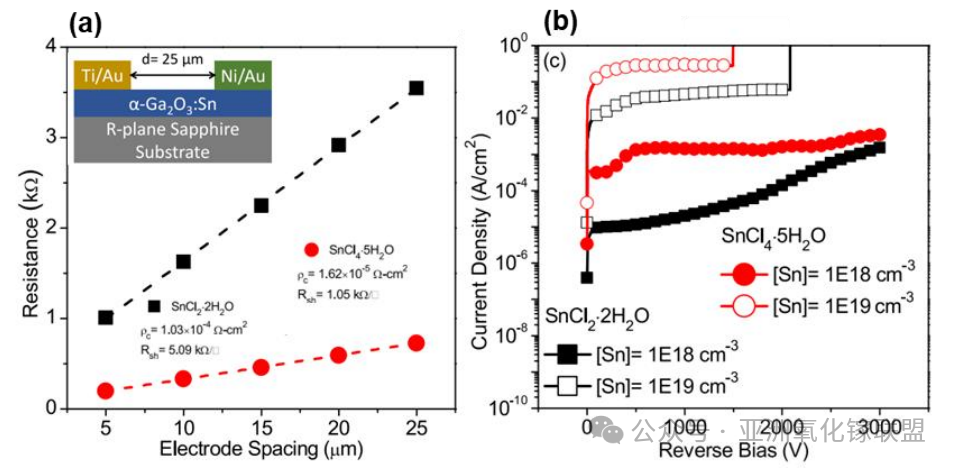
图 3. (a) SBD 的示意横截面,(b) 基于 α-Ga₂O₃:SnCl2·2H2O 和 α-Ga₂O₃:SnCl4·5H2O的 SBD 反向击穿特性。

图 4. (a) 在扩展反向偏压范围测得的 I–V 曲线,(b) MESFET 的输出特性。右侧和顶部刻度对应在 Vg = −10 V 条件下测量,以研究击穿行为。
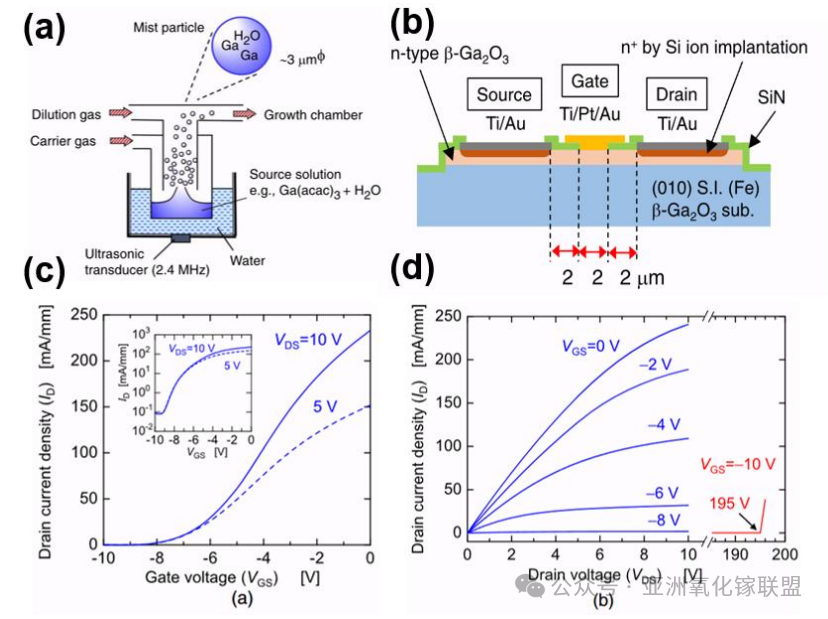
图 5. (a) 用于 Mist-CVD 生长的雾化器示意图,(b) β-Ga₂O₃ MESFET 结构的横截面示意图。不同栅源电压 VGS 下的漏电流密度 ID 与 (c) 栅源电压 VGS 和 (d) 漏源电压 VDS 的关系。在 (c) 中,插图为 ID 的对数图。
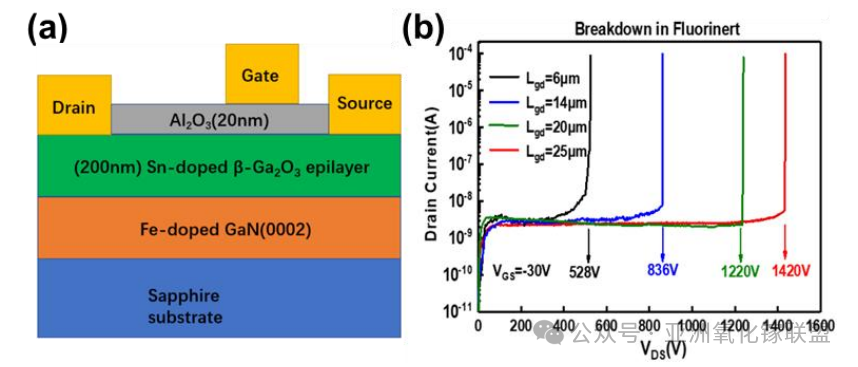
图 6. (a) β-Ga₂O₃ MOSFET 的示意横截面及微观图,(b) 不同 LGD 下 Sn 掺杂 β-Ga₂O₃ MOSFET 的关断状态击穿特性,VGS = −30 V 测量。
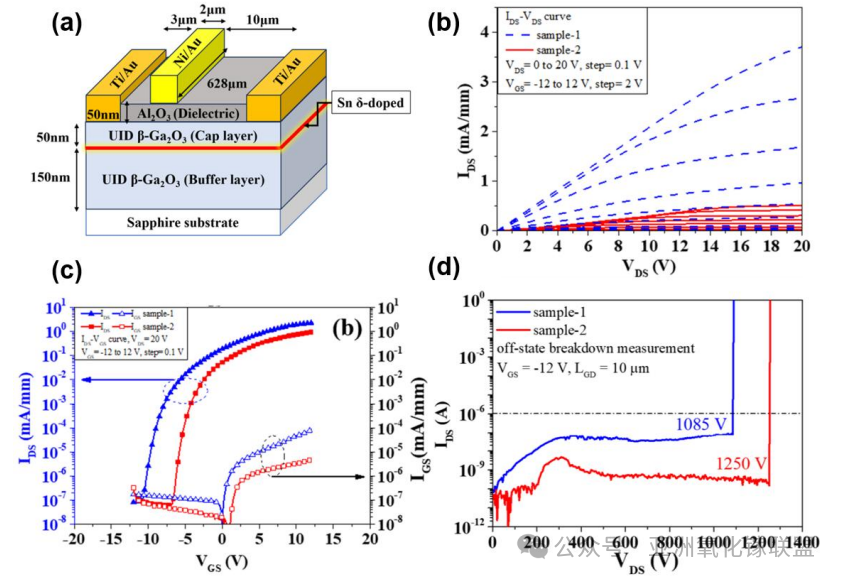
图 7. (a) 提议的 Sn δ 掺杂 β-Ga₂O₃ MOSFET 结构示意图,提议器件在 80 s 和 40 s Sn δ 掺杂 Mist 下的电学性能,(b) IDS–VDS 输出特性,(c) IDS–VGS 转移特性,(d) 两个样品的关断状态击穿电压分析。
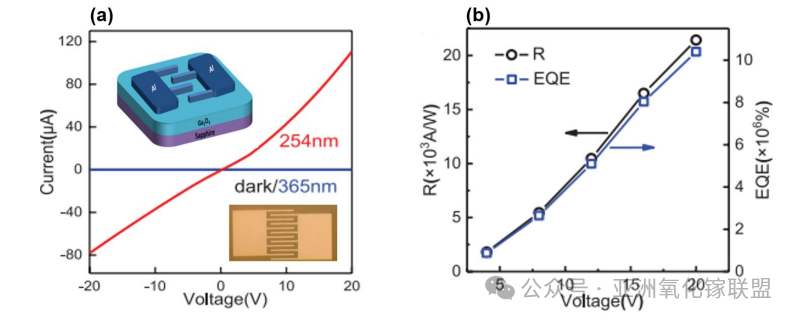
图 8. (a) PD-800 在暗态、365 nm 和 254 nm 光照下的线性及半对数坐标 I–V 特性,(b) 在 254 nm 光照(100 µW cm−2)下不同偏压测得的 EQE。

图 9. (a) 光电探测器在暗态及 254 nm 光强 500 μW cm−2 下的 I−V 曲线,(b) 响应度,(c) 探测率,(d) EQE,针对 0.5–900 μW cm−2 光强下 5 V 偏压的五个光电探测器。

图 10. (a) 器件结构示意图,(b) 不同 Li⁺ 掺杂浓度器件的光电流,(c) 不同 Li⁺ 掺杂浓度器件光电流对数坐标,(d) 暗电流,(e) 响应度,(f) 探测率,(g) 不同电压下器件的时域光响应,(h) 不同光强下的时域光响应,(i) 不同电压下电流的详细变化,(j) 不同光强下电流的详细变化,(k) 光电流密度随光强变化及按 J–Pα 拟合的结果,(l) 365 nm 光照下不同 Li⁺ 掺杂浓度器件光电流对数坐标。
DOI:
doi.org/10.1109/SSLCHINAIFWS69008.2025.11315007






