

【会员论文】超薄二维β-Ga₂O₃中的超高介电常数及其先进介电应用
日期:2026-02-12阅读:292
由复旦大学的研究团队在学术期刊Nano Letters发布了一篇名为Ultrahigh Dielectric Permittivity in Ultrathin 2D β-Ga2O3 for Advanced Dielectric Applications(超薄二维β-Ga₂O₃中的超高介电常数及其先进介电应用)的文章。
项目支持
本工作部分得到了中国教育部中央高校基本科研业务费专项资金(编号:D5000240188)、江苏省自然科学基金(编号:BK20240484)以及山东省自然科学基金(编号:ZR2025QC1603)的资助。
背景
随着先进晶体管不断向纳米尺度微缩,如何在抑制短沟道效应的同时保持有效的栅极控制,并在低功耗需求下降低器件工作电压,已成为半导体产业面临的核心挑战。传统二氧化硅(SiO₂)栅介质在厚度持续减薄的过程中逐渐逼近物理极限,量子隧穿引起的漏电流急剧增加,导致功耗显著上升,从而难以支撑器件进一步缩放。以高介电常数(high-k)材料替代 SiO₂,被认为是延续摩尔定律的关键途径之一,因为高-k 介质可以在保持相同等效氧化层厚度(EOT)的同时增大物理厚度,有效抑制漏电流并提升栅电容,从而增强沟道调控能力。
目前,基于氧化铪(HfO₂)的介质材料因其良好的 CMOS 工艺兼容性已被广泛应用,但其介电常数通常限制在约 50,难以满足未来技术节点对更激进器件缩放的需求。尽管弛豫铁电等材料在体相中可表现出更高的能量密度,但在超薄尺度下,其介电性能往往受到界面层效应的严重削弱,限制了实际应用。这一现状促使人们亟需探索在超薄极限下仍能保持高介电常数和优异电学性能的新型介质材料。在此背景下,具有超宽禁带、优异物理和化学稳定性的 β-氧化镓(β-Ga₂O₃)逐渐受到关注,但其在二维(2D)超薄尺度下的介电特性仍缺乏系统研究。
本工作正是针对这一空白,系统研究了超薄二维 β-Ga₂O₃ 单晶的介电行为。通过构建基于 10 nm 厚 β-Ga₂O₃ 薄片的金属–绝缘体–金属电容器,发现其表现出异常高达约 150 的介电常数。进一步结合光电和微观结构分析,揭示了这一超高介电响应的物理起源,并展示了其在高性能存储与逻辑器件中的应用潜力,从而确立了二维极限下 β-Ga₂O₃ 作为新一代高-k 介质材料的研究价值。
主要内容
半导体器件的持续微缩对高介电常数(high-k)介质的集成提出了迫切需求,以维持良好的栅控能力并降低功耗。本文报道了一种超薄(10 nm)β-氧化镓(β-Ga₂O₃)金属–绝缘体–金属电容器中实现的超高介电常数,其介电常数 k 高达约 150。通过光响应与微观结构分析发现,这一巨大的介电常数源于氧空位(VO)有序相的形成。所制备的电容器在存储器应用中表现出优异性能,包括极低的介电损耗(在 100 kHz 下小于 0.02)、极低的漏电流(小于 10⁻⁷ A/cm²)、较高的工作速度(超过 20 MHz)以及出色的耐久性(超过 10¹⁰ 次循环)。为验证其实用潜力,进一步制备了以 β-Ga₂O₃ 作为栅介质的 MoS₂ 场效应晶体管,其表现出超过 10⁶ 的开关比、68.1 mV/dec 的低亚阈值摆幅(SS)、几乎可忽略的迟滞(5.8 mV)以及超低的栅漏电流(约 10⁻¹³ A)。这些结果表明,超薄 β-Ga₂O₃ 是一种极具潜力的高-k 介质材料,有望应用于下一代逻辑与存储器器件。
创新点
在仅 10 nm 厚的二维 β-Ga₂O₃ 中实现约 150 的超高介电常数,显著高于常规高-k 介质。
通过光电与微结构分析,首次将巨介电响应归因于有序氧空位超结构诱导的新型极化相。
基于 β-Ga₂O₃ 的 MIM 电容同时实现低损耗、低漏电、高速(>20 MHz)与超高耐久性(>10¹⁰ 次)。
成功将超薄 β-Ga₂O₃ 用于 MoS₂ 晶体管栅介质,获得高开关比、近理想亚阈值摆幅和超低漏电,验证其在逻辑与存储器件中的应用潜力。
结论
本研究制备并表征了基于超薄(10 nm)二维 β-Ga₂O₃ 介电层的金属–绝缘体–金属(MIM)电容器,发现其介电常数高达约 150。光电与微结构分析结果表明,这种巨大的介电常数来源于有序氧空位超结构的形成,该结构诱导产生具有大偶极矩的新型极化相。所制备的电容器在存储应用方面展现出优异性能,包括低介电损耗、低漏电流、高工作速度(>20 MHz)以及超高耐久性(>10¹⁰ 次循环)。此外,还展示了采用超薄 β-Ga₂O₃ 作为栅介质的 MoS₂ 场效应晶体管,器件表现出较高的开关比、接近理想的亚阈值摆幅、几乎可忽略的迟滞效应以及极低的栅漏电流。该研究不仅揭示了 β-Ga₂O₃ 在二维极限下卓越的介电特性,也表明其有望成为未来存储与逻辑器件中的高介电常数材料。

图 1. β-Ga2O3 MIM 电容的制备、表征与电学性能。(a) 在云母基底上生长 β-Ga2O3 薄片的合成示意图。(b) β-Ga2O3 薄片在 Si/SiO2 基底上的拉曼光谱。(c) 以 β-Ga2O3 作为介质层的 MIM 电容关键制备步骤示意图。(d) 完成器件的顶视光学显微镜图像。(e) 表面形貌的 AFM 图像。(f) 在暗态与光照条件下测得的 β-Ga2O3 电容 I–t 特性。

图 2. β-Ga2O3 电容的介电特性。(a, b) 在振荡电场 VOSC = 0.05 V 下,介电常数(ε′,a)和等效氧化层厚度(EOT,b)的频率依赖关系。实线为依据公式 2 的拟合结果。(c) 对应的损耗角正切(tan δ)的频率依赖关系,实线为依据公式 3 的拟合结果。插图:低频区域的放大图。(d, e) 在 1 kHz、10 kHz、100 kHz 和 1 MHz 频率下测得的 ε′ 和 tan δ 的电压依赖关系。 (f) 在 1 MHz 测试频率下,不同厚度(10–60 nm)的 MIM 电容的介电常数。
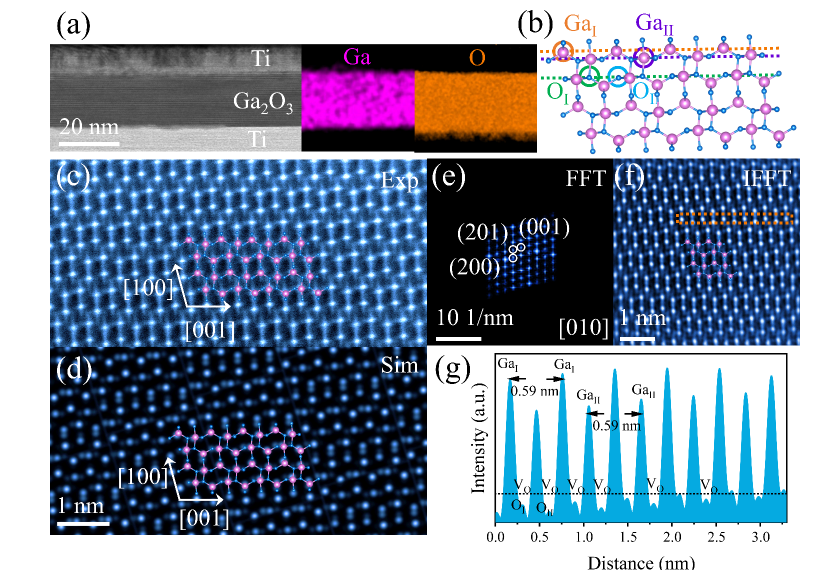
图 3. β-Ga2O3 电容的微结构与晶体学表征。(a) 低倍截面 HAADF-STEM 图像及对应的 Ga(红色)和 O(橙色)元素 EDS 分布图。(b) 沿 [100] 取向的二维 β-Ga2O3 薄片原子结构。(c, d) β-Ga2O3 电容的实验与模拟 HRTEM 图像。(e, f) FFT 及其对应的反 FFT 图像。(g) (f) 中红色虚线框所示区域跨原子柱的强度线型分布。

图 4. β-Ga2O3 基电容的综合电学表征与高 k 性能。(a) 在 20 MHz 至 100 kHz 频率范围内测得的电位移–电场(D–E)滞回回线。插图为 D–E 测试的脉冲方案。(b) 图 (a) 中回线斜率估算得到的 ε′ 数值(括号内)。(c) 在室温下施加电压/脉宽为 2 V/50 ns、重复频率为 10 MHz 的单极性方波脉冲时,β-Ga2O3 电容中存储电荷密度随循环次数的变化。插图为耐久性测试的脉冲方案。(d) 五个独立器件在准静态 I–V 测试中电流随外加电场的变化,箭头标出了发生灾难性失效的击穿点。插图:漏电流密度随外加电压变化的 J–V 特性。(e) 本工作获得的介电常数与已报道多种介电材料的对比。(f) 采用高 k β-Ga2O3 作为顶栅介质的 MOSFET 模拟漏电流–栅电压(Id–Vg)转移特性。
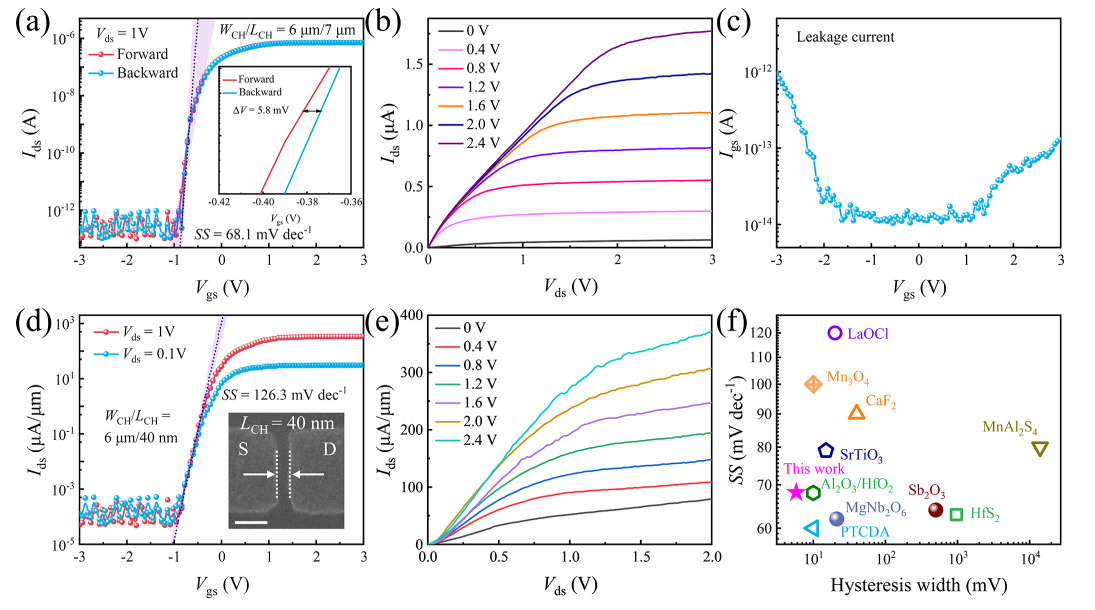
图 5. 以 β-Ga2O3 作为顶栅介质的 MoS2 场效应晶体管的电学性能(在无氧手套箱环境中制备)。(a) 在 Vds = 1 V 下的转移特性(Ids–Vgs),表现出大于 106 的开关比、68.1 mV/dec 的亚阈值摆幅(SS)以及 5.8 mV 的滞后(插图为放大图)。插图:器件结构的光学显微镜图像,比例尺 10 μm。黑色实线为拟合曲线,紫色区域为 95% 置信区间。(b) 在阶梯式 Vgs(0–2.4 V)下的输出特性(Ids–Vds),显示出良好的电流饱和与栅控能力。(c) 栅漏电流(Ig–Vgs)低于 10-13 A,体现出介质优异的绝缘性能。(d, e) 40 nm 沟道 β-Ga2O3/MoS2 FET 的转移特性(d)与输出特性(e)。插图:40 nm 沟道 β-Ga2O3/MoS2 FET 的 SEM 图像,比例尺 100 nm。(f) 与已报道介质材料相比的 SS 与滞后基准对比,突出 β-Ga2O3 的优异性能。
DOI:
doi.org/10.1021/acs.nanolett.5c05733