

【会员论文】ASS | 西安交通大学周磊簜副教授团队:Ni/Al₂O₃/β-Ga₂O₃二极管隧穿层中陷阱介导的电流输运:质子辐照效应
日期:2026-04-13阅读:42
由西安交通大学周磊簜副教授的研究团队在学术期刊Applied Surface Science发布了一篇名为Trap-mediated current transport in tunneling layer of Ni/Al2O3/β-Ga2O3 diodes: effect of proton irradiation(Ni/Al2O3/β-Ga2O3二极管隧穿层中陷阱介导的电流输运:质子辐照效应)的文章。
背 景
空间环境中普遍存在的高能质子极易诱发严重的位移损伤与单粒子效应,对β-Ga2O3器件的可靠性构成严峻挑战。因此,发展具有抗辐照能力的高性能β-Ga2O3器件,并揭示质子辐照对器件性能的影响机制,是当前β-Ga2O3器件应用与抗辐照加固设计中亟待深入探究的核心问题。β-Ga2O3器件的电学特性与抗辐照性能受异质结终端设计的影响。相较于肖特基势垒二极管(SBDs),采用纳米级绝缘层进行界面修饰的β-Ga2O3金属-绝缘体-半导体二极管(MISDs)在降低漏电流与提升击穿电压方面展现出显著优势,例如基于AlN、Al反应界面层、Nb2O5及TiO2的MISDs。值得注意的是,GaN基MIS-高电子迁移率晶体管(MIS-HEMTs)相较于常规HEMTs表现出更优的质子辐照耐受性,这暗示了该MIS结构(即薄层Al2O3)具有抗辐照潜力。然而,关于质子辐照对β-Ga2O3 MISDs影响的系统性研究仍鲜有报道。
主要内容
超宽禁带β-Ga2O3器件的抗辐照性能是其在极端辐照环境中应用的关键研究前沿。尽管金属-绝缘体-半导体二极管(MISDs)相较于肖特基势垒二极管(SBDs)表现出更优的可靠性,但其抗辐照性能尚待系统揭示。本研究通过引入3 nm Al2O3层并结合超临界流体处理,制备了高性能Ni/Al2O3/β-Ga2O3 MISDs。随后的5 MeV质子辐照实验表明,该器件的正向和反向特性均发生退化,这一行为与SBD中观察到的现象显著不同。该差异主要源于质子辐照在Al2O3中诱导产生的氧空位电子陷阱。一方面,质子与γ射线辐照损伤的对比分析揭示了Al2O3中电子陷阱与β-Ga2O3中串联电阻在调控开态电流中的竞争关系。另一方面,质子辐照后,漏电流在高偏压下的温度依赖性由正转负,表明其主导漏电机制发生转变,不再符合Poole-Frenkel发射和Fowler-Nordheim隧穿模型。本研究为具有MIS结构的β-Ga2O3器件的辐照损伤机制提供了深入的见解,为面向空间环境应用的高可靠β-Ga2O3器件的设计奠定了理论基础。
创新点
● 通过引入3 nm Al2O3界面层并采用超临界流体处理,制备了高性能Ni/Al2O3/β-Ga2O3 MISDs。
● MISDs与Ni/β-Ga2O3 SBDs在质子辐照下的性能退化差异源于Al2O3中辐照诱导的陷阱。
● 阐明了辐照前后MISDs的电流输运机制。
● 建立了区分质子辐照与γ射线辐照下开态电流响应机制的物理模型。
结 论
本研究系统探究了Ni/Al2O3/β-Ga2O3 MISDs的质子辐照损伤机制,主要结论如下:
(i)质子辐照后,MISDs的比导通电阻增幅较SBDs降低了44%。然而,尽管MISDs初始漏电流低于SBDs,但辐照后其漏电流显著上升且不均匀性加剧,与SBDs漏电流下降的现象形成鲜明对比。
(ii)质子辐照在Al2O3中诱发的电离损伤和位移损伤共同导致了电子陷阱密度和有效电荷密度的增加,而β-Ga2O3中则以位移损伤引起的载流子去除效应主导。此外,辐照诱导的缺陷改变了Al2O3/β-Ga2O3异质结的能带对齐,表现为导带带偏增大以及价带带偏由正转负。
(iii)正向电流在亚阈值区主要遵循热电子-场发射模型,在开态条件下遵循陷阱辅助隧穿(TAT)模型。开态电流由Al2O3中电子陷阱与β-Ga2O3中串联电阻之间的竞争关系决定,这导致质子和γ射线辐照后开态电流呈现相反的变化趋势。
(iv)未辐照MISD的漏电流符合从低偏压下Poole-Frenkel发射到高偏压下Fowler-Nordheim隧穿的机制转变。相比之下,质子辐照后MISDs的漏电流在低偏压下呈现正温度依赖性,在高偏压下呈现负温度依赖性,证实了TAT过程的主导地位。
项目支持
本研究得到国家重点实验室稳定支持基金(JBSY252800260)、宽禁带半导体器件与集成技术全国重点实验室开放基金(2413S121)以及国家自然科学基金(62204198)的资助。感谢西安交通大学微电子学院王旭辉女士在测试系统方面提供的宝贵协助,以及杨明超先生、杨松泉先生在低温超临界流体工艺方面的技术支持。

图1. 质子辐照前后Ni/Al2O3/β-Ga2O3 MISDs的室温电学特性。(a)MISDs结构示意图。(b)正向J-V特性及比导通电阻(Ron,sp)。(c)多次单向扫描的正向J-V特性。(d)Ron,sp与开启电压(Von)的统计分布。(e)反向J-V特性。(f)净载流子浓度与载流子去除率。

图2. SRIM模拟结果。(a)电子能损(Se)、核能损(Sn)及累积能量损失(Et)随深度的变化关系。(b)Al2O3和(c)β-Ga2O3中空位缺陷的分布

图3. 质子辐照前后Al2O3/β-Ga2O3异质结的XPS核心能级谱。(a)Al 2p谱、(b)O 1s谱和(c)Ga 2p3/2谱。

图4. 质子辐照前后Al2O3/β-Ga2O3异质结的能带对齐。(a1,b1)Al2O3的Al 2p谱和价带顶(VBM)。(a2,b2)Al2O3/β-Ga2O3界面的Ga 2p3/2和Al 2p谱。(a3,b3)β-Ga2O3的Ga 2p3/2谱和VBM。(a4,b4)Al2O3和(a5,b5)β-Ga2O3的O 1s谱。(a6,b6)Al2O3/β-Ga2O3界面能带对齐示意图。

图5. Al2O3/β-Ga2O3异质结的陷阱分析。(a)辐照前和(b)质子辐照后,具有50 nm Al2O3层的MIS电容器的C-V特性。(c)电子陷阱密度(Nt),(d)有效氧化层电荷密度(Neff)和(e)界面态密度(Dit)。

图6.(a)辐照前与(b)质子辐照后,MISDs在325-425 K温度范围内的正向J-V-T特性。(c)理查逊曲线,(d)理想因子(η),(e)隧穿参数(E00)及E00/kT。(f)质子辐照前MISD的陷阱辅助隧穿(TAT)曲线与(g)陷阱能级(qφt)。(h)热电子-场发射(TFE)与TAT的示意图。
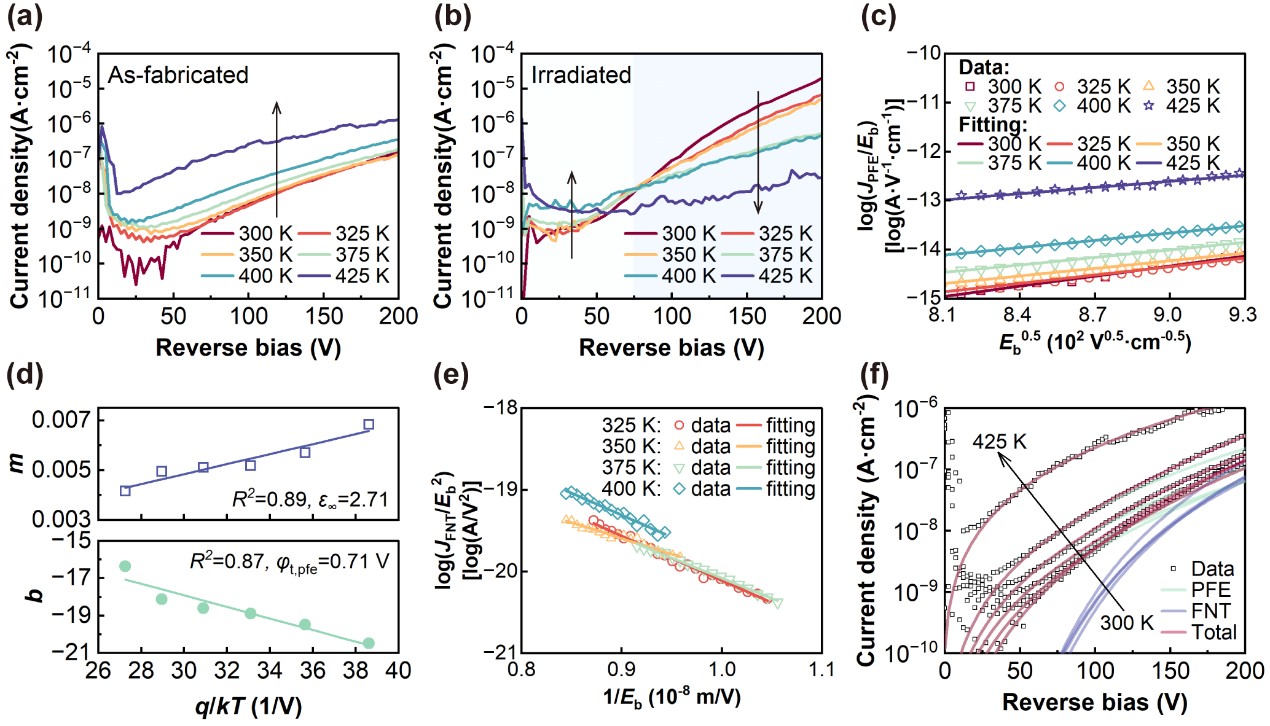
图7. (a)辐照前与(b)质子辐照后,MISDs在300-425 K温度范围内的反向J-V-T特性。辐照前MISDs反向电流密度的(c)Poole‑Frenkel发射曲线,(d)m(T)与b(T)随q/kT的变化关系,(e)Fowler‑Nordheim隧穿曲线和(f)拟合图。

图8. (a)辐照前和(b)γ射线辐照后MISDs的室温电学特性。(a)正向J-V特性及Ron,sp,(b)多次单向扫描的正向J-V特性和(c)反向J-V特性

图9. 辐照条件下开态电流的对比分析。(a)辐照前、质子辐照及γ射线辐照后,MISDs在导通状态下室温J-V特性的TAT曲线。(b)基于TAT曲线提取的qφt与陷阱浓度(Ntr)。(c)质子与γ射线辐照对MISD开态电流作用机理示意图。
DOI:
doi.org/10.1016/j.apsusc.2026.166671