

【会员论文】FlexMat | 南京工业大学、南方科技大学:用于介电应用的原子级薄Ga₂O₃薄膜的激光辅助原位制备
日期:2026-04-17阅读:24
由来自南京工业大学、南方科技大学的研究团队在学术期刊FlexMat发布了一篇名为Laser-assisted in situ fabrication of atomically thin Ga₂O₃ films for dielectric applications(用于介电应用的原子级薄Ga₂O₃薄膜的激光辅助原位制备)的文章。
背 景
二维氧化镓(Ga₂O₃)凭借其超宽禁带和可大规模制备的特性,成为光电子应用领域的高 κ 介电材料。但液态金属辅助制备过程中的热处理会降低沟道材料质量。传统二维 Ga₂O₃ 制备方法如溶液法、化学气相沉积(CVD)、物理气相沉积(PVD)均存在显著缺陷:溶液法需高温退火,气相沉积依赖危险前驱体或真空工艺,液态金属法仍需热退火,会对氧敏感材料造成损伤。
主要内容
二维氧化镓(Ga₂O₃)凭借其超宽禁带和可大规模制备的特性,成为光电子应用领域的高 κ 介电材料。但液态金属辅助制备过程中的热处理会降低沟道材料质量。该团队研究了一种激光辅助原位氧化法,结合限域模板辅助挤压技术,在室温下从液态镓金属表面制备厘米级二维原子级薄 Ga₂O₃ 薄膜。该方法避免了对敏感材料的热损伤。通过多波长激光辐照实验与密度泛函理论计算相结合,阐明激光加速氧化机制为初始 Ga/Ga₂O₃₋ₓ 表面的光催化氧化。进一步以黑磷(BP)和 MoS₂ 为沟道材料、Ga₂O₃ 薄膜为栅介质,制备顶栅场效应晶体管(FET)。基于 BP 的 FET 展现出栅可调的中红外光响应,响应度达 0.1 A・W⁻¹ 量级。基于 MoS₂ 的 FET 在可见光谱中光探测度为 6.8×10¹² Jones,开关比超 10⁸,亚阈值摆幅 73.6 mV decade⁻¹,在 8 MV cm⁻¹ 电场下栅漏电流低于 4×10⁻⁶ A cm⁻²。该室温激光氧化方法可实现超薄氧化物介电层与敏感二维材料的规模化集成,适用于下一代纳米电子学。
创新点
• 室温下实现液态镓表面厘米级原子级薄 Ga₂O₃ 薄膜制备,规避热退火对敏感材料的损伤
• 揭示激光加速氧化机制为非化学计量比 Ga₂O₃₋ₓ 表面的光催化氧化,短波长激光效果更显著
• 基于该 Ga₂O₃ 介电层成功制备 BP 与 MoS₂ 顶栅光晶体管,器件展现优异光电与介电性能
• 所制 MoS₂ FET 开关比超 10⁸、亚阈值摆幅 73.6 mV decade⁻¹、可见光探测度达 6.8×10¹² Jones
总 结
该团队提出一种激光辅助原位氧化法,结合限域模板辅助挤压技术,制备用于介电应用的原子级薄 Ga₂O₃ 薄膜。该方法解决了传统热退火易损伤敏感材料的难题,可制备厘米级高质量 Ga₂O₃ 薄膜。激光辐照下薄膜光学对比度与电阻的变化证实,激光可显著加速氧化过程。第一性原理计算揭示,激光诱导的非平衡自由载流子对提升氧化动力学至关重要。所制备的 Ga₂O₃ 薄膜成功作为介电层,应用于以 BP 和 MoS₂ 为沟道的光晶体管。基于 BP 的光晶体管在中红外波段展现栅可调光响应,室温响应度达 0.1 A・W⁻¹ 量级。基于 MoS₂的 FET 在可见光谱探测度为 6.8×10¹² Jones,开关比 10⁸,亚阈值摆幅 73.6 mV decade⁻¹,8 MV cm⁻¹ 电场下栅漏电流低于 4×10⁻⁶ A cm⁻²。结果表明,激光辅助原位氧化法与热敏感材料具有良好兼容性,彰显了该方法在推动电子与光电子器件应用方面的潜力。
项目支持
国家自然科学基金(批准号:62275117、62374079、62304097、92477123、52373290、62288102、U25A20484);深圳市优秀青年基金(批准号:RCYX20221008092900001);珠江人才计划(批准号:2019QN01C177);广东省基础与应用基础研究基金(批准号:2024A1515030224);深圳市基础研究计划(批准号:JCYJ20240813094508011)。
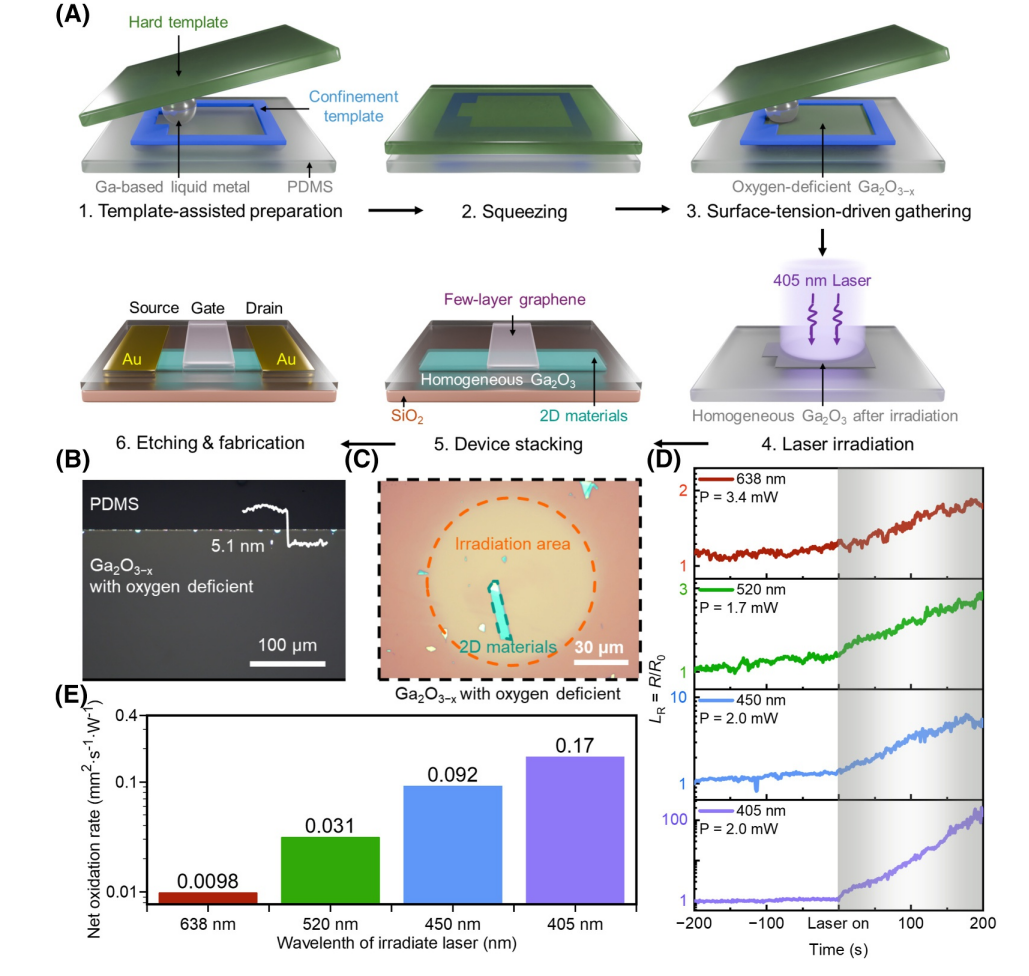
图 1 采用激光辅助原位氧化法制备与表征Ga₂O₃薄膜。(A) 模板辅助制备Ga₂O₃薄膜的流程示意图。(B) 在 PDMS 上制备的Ga2O3-x薄膜光学显微镜图像。(C) SiO2/Si衬底上Ga₂O₃薄膜激光辐照区域的光学显微镜图像。(D) 不同波长激光辐照下Ga2O3-x薄膜的电阻变化率随时间的变化。(E) 不同波长激光下的净氧化速率。

图 2 薄膜 Ga 与Ga2O3-x的电子结构与原子构型。(A–D) 薄膜 (A) Ga、(B) GaO0.3、(C) GaO 和 (D) Ga2O3的态密度(DOS)与原子构型。(B–C) 超胞结构及对应实空间概率分布:(B) 薄膜GaO0.3在−4~0 eV 能带的电子分布;(C) 薄膜 GaO 在 Γ 点价带上沿的电子分布,等值面水平为6.37×10−2。(E–F) 截断距离为 2.4 Å 时,薄膜GaO0.3、GaO 和Ga2O3中 (E) Ga 与 (F) O 的配位环境对比。
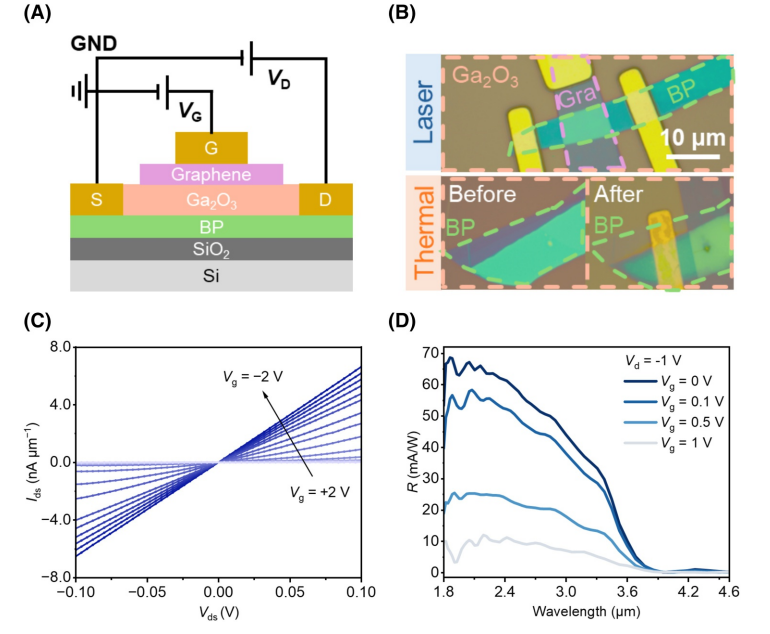
图 3 室温下黑磷(BP)光电晶体管的表征与红外光响应特性。(A) BP 光电晶体管的器件结构示意图。(B) 激光辅助原位氧化法(上图)与热退火法(下图)制备的 BP 光电晶体管光学显微镜图像。热退火法制备的器件中 BP 沟道出现明显损伤,厚度减小,存在暗斑且边缘模糊。初始 BP 层由绿色虚线框标出。(C) 激光辅助原位氧化法制备的 BP 光电晶体管输出特性。(D) 激光辅助原位氧化法制备的 BP 光电晶体管在不同栅压下对黑体辐射源的红外光响应。
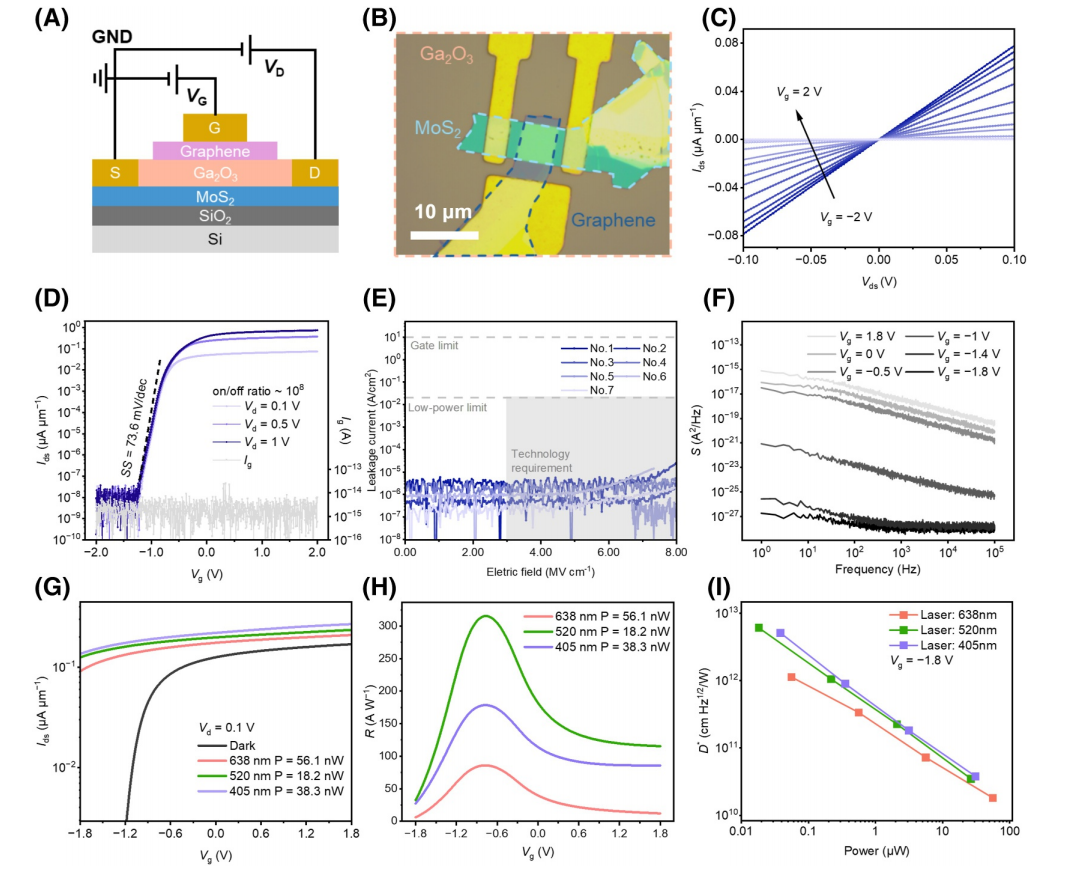
图 4 激光辅助氧化法制备的以Ga2O3为栅介质的顶栅MoS2场效应晶体管(FET)表征。(A) 顶栅MoS2 FET 的器件结构示意图。(B) 制备完成的顶栅MoS2 FET 光学显微镜图像。(C) 暗态下输出特性曲线。(D) 暗态下转移特性曲线。(E) 7 个器件的漏电流曲线,电流密度与击穿场强的技术要求、低功耗限值与栅极限值均来自 2022 年 IRDS 报告。(F) 不同栅压下Vds=1V时的噪声谱密度。(G) 不同激光辐照条件下的转移特性。(H) 不同激光辐照条件下栅压可调的光响应度。(I) 不同激光波长下光探测度随功率的变化。
DOI:
doi.org/10.1002/flm2.70064