

【会员论文】ASS丨厦门理工学院、厦门市计量检定测试院、福建物构所等团队:通过加合物介导的低温空间原子层沉积法制备P型氮掺杂非晶氧化镓薄膜
日期:2026-04-20阅读:56
由厦门理工学院、厦门市计量检定测试院、中国科学院福建物质结构研究所等的研究团队在学术期刊 Applied Surface Science 发布了一篇名为 Adduct-mediated low-temperature spatial atomic layer deposition of P-type nitrogen-doped amorphous gallium oxide thin films(通过加合物介导的低温空间原子层沉积法制备 P 型氮掺杂非晶氧化镓薄膜)的文章。
背 景
Ga₂O₃ 作为超宽禁带半导体,在功率电子与日盲光电器件中应用潜力巨大,但其难以实现稳定 P 型导电,限制了双极型器件与互补电路的发展。传统 N 掺杂 Ga₂O₃ 多依赖高温工艺,低温下难以实现有效氮掺杂,而空间原子层沉积(sALD)可在低温下实现均匀成膜,适合热敏与柔性器件。该团队提出加合物介导策略,在 150 ℃ 下实现 P 型 N 掺杂非晶 Ga₂O₃ 薄膜制备,为低温柔性氧化物电子学提供新方案。
主要内容
在低热预算条件下实现超宽禁带 Ga₂O₃ 的 P 型导电仍是重大挑战。该团队采用空间原子层沉积技术,在 150 ℃ 条件下制备出 P 型氮掺杂非晶 Ga₂O₃ 薄膜。研究利用 Ga (CH₃)₃:NH₃ 加合物前驱体预反应策略,克服 N–H 键解离的高动力学势垒,无需等离子体辅助即可实现氮元素有效掺入。材料表征表明,氮含量线性增加至约 0.62 at.%,并在更高前驱体流量下趋于平缓。紫外光电子能谱证实费米能级 EF 向价带下移,表现出 P 型电学特征。霍尔效应测试确定最优掺杂窗口,获得 2.6 ×10¹⁷ cm⁻³ 的空穴浓度与 2.1 cm² V⁻¹ s⁻¹ 的迁移率。该性能源于置换氮对本征氧空位的抑制作用。过量前驱体流量会因过掺杂产生间隙缺陷引发载流子散射,导致迁移率下降。该团队制备出开关比达 4.3 ×10⁴ 的功能性 P 沟道薄膜晶体管。结果证实了非晶氧化物中 P 型导电的可行性,为适用于热敏衬底的柔性电子器件提供了技术路线。
研究亮点
•通过空间原子层沉积(sALD)在 150 ℃ 下制备 P 型氮掺杂非晶 Ga₂O₃ 薄膜。
•基于 TMG:NH₃ 加合物介导策略,无需等离子体辅助即可实现 sALD 氮掺杂。
•在氮含量为 0.62 at.% 时获得 2.6×10¹⁷ cm⁻³ 的空穴浓度。
•高功函数(7.58 eV)与功能性 TFT 器件共同证实 P 型导电特性。
总 结
该团队采用加合物介导的空间原子层沉积技术,在 150 ℃ 下合成 P 型氮掺杂 Ga₂O₃ 薄膜。通过前驱体间预反应,成功突破氨解离的热限制,实现有效掺杂。生长动力学证实自限制沉积模式,适合精确厚度控制;结构表征表明薄膜保持连续、致密、原子级平整的非晶形貌。深度分布分析确证从表面到界面的均匀体掺杂,排除表面偏析效应。NH₃ 流量为 30 sccm 时获得最优性能,空穴浓度达 2.6 ×10¹⁷ cm⁻³,迁移率为 2.1 cm² V⁻¹ s⁻¹,氮元素有效抑制本征氧空位。O 1s 谱中氧空位组分系统性降低、导电类型由 N 型转为 P 型、P 沟道 TFT 实现有效栅调控,共同证明掺入的氮作为电活性受主参与自由空穴产生。过高 NH₃ 流量会因过掺杂引入间隙缺陷造成散射,导致迁移率下降。电子结构分析显示费米能级明显向价带顶移动,证实材料 P 型属性。最终,该团队将薄膜集成至 P 沟道薄膜晶体管,实现约 4.3 ×10⁴ 的开关比,验证材料实用性。该低温工艺为热敏聚合物衬底上的透明氧化物电子学提供可靠平台。虽然原位光谱验证(如 FTIR、质谱)可直接证实 Ga (CH₃)₃:NH₃ 加合物形成并定量评估动力学势垒降低,但此类实验需要专用原位反应腔,该团队计划在未来开展。
项目支持
本研究得到福建省中青年教师教育科研项目(编号 JAT241127)、厦门市科技计划项目(编号 3502Z202373061)、国家自然科学基金(编号 21975260)与国家海外高层次人才引进计划(千人计划)资助。

图 1. 低温氮掺杂的加合物介导反应机理示意图。

图 2. (a) 薄膜厚度随 sALD 周期的变化;(b) 每循环生长量(GPC)随 NH₃ 流量的变化。

图 3. (a) 不同 NH₃ 流量下制备的 N 掺杂 Ga₂O₃ 薄膜的 GIXRD 图谱;(b) NH₃ 流量为 30 sccm 时 N 掺杂 Ga₂O₃ 薄膜的 SIMS 深度分布。
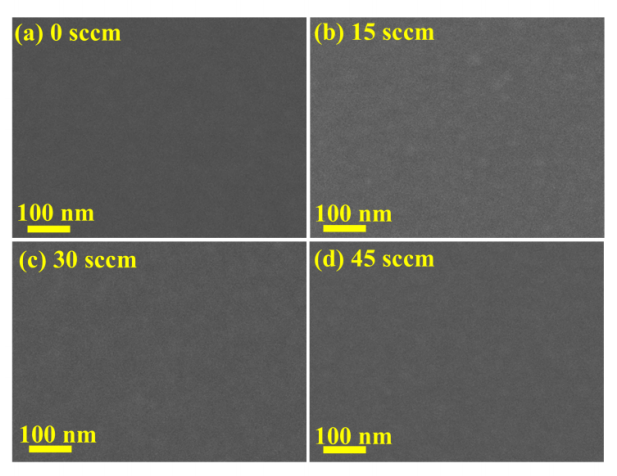
图 4. NH₃ 流量分别为 (a) 0、(b) 15、(c) 30、(d) 45 sccm 时制备的 N 掺杂 Ga₂O₃ 薄膜的 SEM 图。
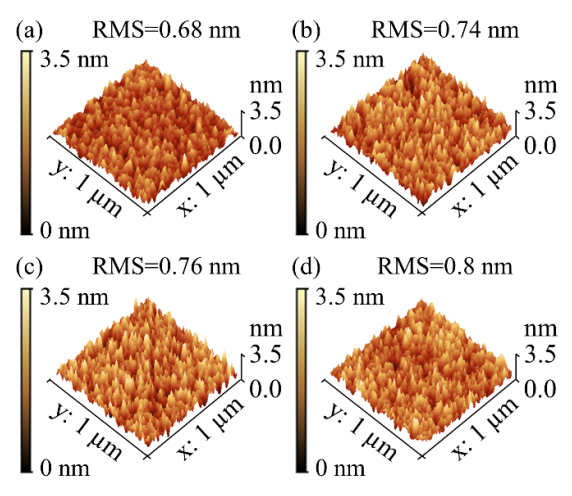
图 5. NH₃ 流量分别为 (a) 0、(b) 15、(c) 30、(d) 45 sccm 时制备的 N 掺杂 Ga₂O₃ 薄膜的 AFM 图。
DOI:
doi.org/10.1016/j.apsusc.2026.166803