

【会员论文】MTP丨东北师范大学刘益春院士、李炳生教授团队:高性能日盲光电探测器中κ-Ga₂O₃向β-Ga₂O₃相变的几何与热控制
日期:2026-04-30阅读:13
由东北师范大学刘益春院士、李炳生教授团队联合美国纽约市立大学的研究团队在学术期刊 Materials Today Physics 发布了一篇名为 Geometric and Thermal Control of κ- to β-Ga₂O₃ Phase Engineering for High-Performance Solar-Blind Photodetector(高性能日盲光电探测器中 κ-Ga₂O₃ 向 β-Ga₂O₃ 相变的几何与热控制)的文章。
背 景
日盲紫外光电探测器在环境监测与深空成像等领域具有重要应用价值,超宽禁带 Ga₂O₃ 因其优异的光电特性成为理想候选材料。热力学稳定的 β-Ga₂O₃ 因晶格对称性低,在异质外延过程中易产生晶格失配与高密度缺陷,难以获得高质量薄膜;同质外延虽可改善缺陷问题,但单晶衬底制备难度大、成本高昂,限制了器件性能提升与规模化应用。当前,利用亚稳相 κ-Ga₂O₃ 作为前驱体,通过可控相变制备高质量 β-Ga₂O₃ 薄膜的研究仍较为缺乏,生长温度与退火工艺对相变过程的调控规律尚不明确。
主要内容
该团队通过调节金属有机化学气相沉积(MOCVD)的生长温度,在 c 面蓝宝石上实现了(002)取向 κ-Ga₂O₃、κ-β 混合相以及(-201)取向 β-Ga₂O₃ 的可控生长。κ-Ga₂O₃ 晶粒的高取向性源于其与 c 面蓝宝石衬底的良好晶格对称性匹配,窄 ω 扫描摇摆曲线(FWHM < 0.6°)证实了这一点。为获得高结晶度 β-Ga₂O₃ 薄膜,该团队采用后退火工艺将亚稳态 κ 相转化为热力学稳定的 β 相。在 1000 ℃ 优化退火温度下,所得 β-Ga₂O₃ 薄膜的晶体质量与表面形貌均得到显著提升,(-201)摇摆曲线半高宽从生长态 2.25° 大幅降至 0.77°,表面粗糙度从 11.3 nm 降至 4.17 nm。在 10 V 偏压下,基于 β-Ga₂O₃ 的日盲紫外光电探测器实现 98 A/W 响应度、1.3 × 10¹⁷ Jones 探测率与超过 10⁶ 的紫外 / 可见光抑制比。该工作建立了一种可控制备不同相 Ga₂O₃ 薄膜的可靠方法,并可制备适用于光电器件的高质量 β-Ga₂O₃ 薄膜。
创新点
•通过调控 MOCVD 生长温度,在 c 面蓝宝石上实现 κ 相、κ‑β 混合相和 β 相 Ga₂O₃ 薄膜的可控生长。
•在 c 面蓝宝石衬底上获得摇摆曲线半高宽低于 0.6° 的高质量 κ‑Ga₂O₃ 薄膜。
•通过 1000 ℃ 后退火将亚稳态 κ‑Ga₂O₃ 转化为高结晶度 β‑Ga₂O₃,显著提升晶体质量与表面形貌。
•制备出超高探测率 1.3 × 10¹⁷ Jones、紫外 / 可见光抑制比超 10⁶ 的高性能日盲紫外光电探测器。
•提出一种可行的相工程策略,用于优化 Ga₂O₃ 基光电器件性能。
总 结
该团队通过精确调控生长与退火温度,实现了 Ga₂O₃ 薄膜从 κ 相、经 κ-β 混合相到 β 相的可控相变。预生长的高质量 κ Ga₂O₃ 作为前驱相,在后续退火中引导原子重构为 β Ga₂O₃。所得薄膜具有更窄的 XRD 摇摆曲线(FWHM = 0.77°)与更低的表面粗糙度(RMS = 4.17 nm),结晶质量远优于直接生长。因此,制备的紫外光电探测器展现出优异性能,实现 98 A/W 高响应度与超过 10⁶ 的高抑制比。该工作为发展高质量 Ga₂O₃ 基日盲紫外光电探测器奠定了基础。
项目支持
本研究得到国家自然科学基金(NO. 62274027、62404039)、松山湖材料实验室开放基金(2023SLABFK03)、111 计划(B25030)、吉林省科技发展计划(NO. 20220502002GH)与吉林省教育厅科学研究项目(JJKH20250304BS)资助。
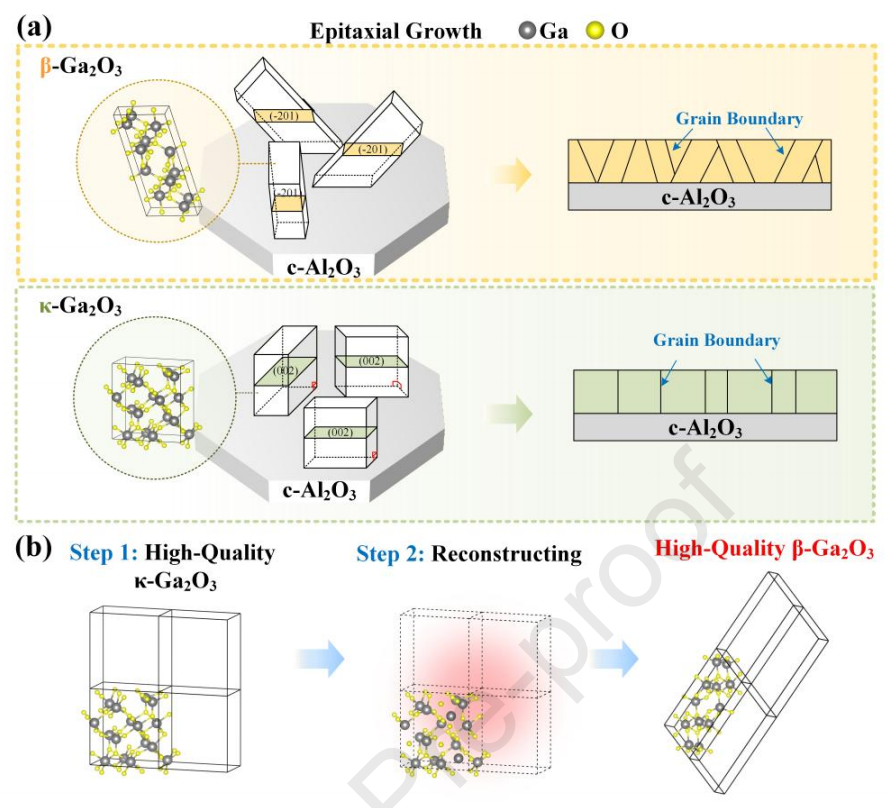
图 1. (a)β‑Ga₂O₃ 与 κ‑Ga₂O₃ 薄膜在 c 面蓝宝石衬底上的外延生长示意图;(b)通过外延生长与后续相变获得高质量 β‑Ga₂O₃ 薄膜的工艺示意图。

图 2. 不同温度生长 Ga₂O₃ 薄膜的结构与光学表征。(a)c 面蓝宝石衬底上 Ga₂O₃ 外延生长与相变示意图;(b)XRD 图谱;(c)局部放大 XRD 图谱,插图为不同温度下 β‑Ga₂O₃(-201)与 κ‑Ga₂O₃(002)衍射峰强度比(Iᵦ / Iκ);(d)κ‑Ga₂O₃(122)晶面 φ 扫描图谱;(e)κ‑Ga₂O₃(002)与(f)β‑Ga₂O₃(-201)XRD 摇摆曲线;(g)透射光谱,插图为对应 Tauc 图。

图 3. 基于密度泛函理论计算的(a)κ‑Ga₂O₃ 与(b)β‑Ga₂O₃ 电子能带结构,理论带隙分别为 5.24 eV 与 4.90 eV。
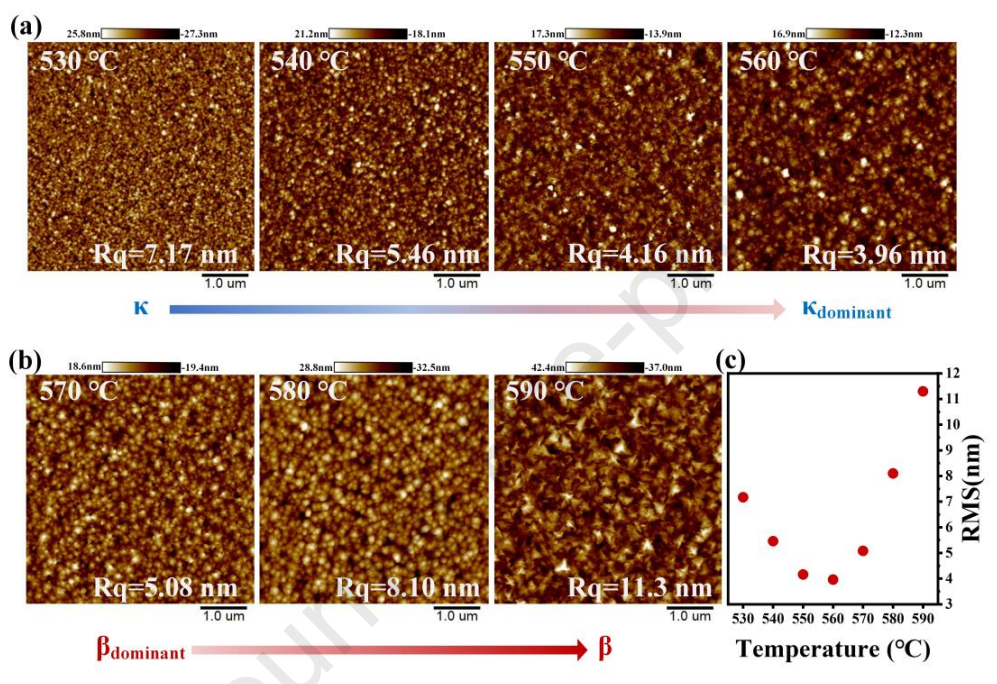
图 4. (a,b)不同生长温度 Ga₂O₃ 的 AFM 图(扫描范围 5 μm × 5 μm);(c)RMS 随生长温度变化曲线。

图 5. (a)κ 相、κ‑β 混合相和 β 相 Ga₂O₃ 的 XPS 全谱;(b)不同生长温度 Ga₂O₃ 的 O 1s 高分辨 XPS 谱。

图 6. 不同生长温度的 MSM 型 Ga₂O₃ 光电探测器。(a)暗态与 250 nm 光照下 I–V 曲线;(b)10 V 偏压下 250 nm 光照光电流与暗电流随生长温度变化;(c)10 V 偏压下响应光谱;(d)10 V 偏压下最大响应度(Rₘₐₓ)与比探测率(D*ₘₐₓ)随生长温度变化。

图 7. 后退火温度对 κ‑Ga₂O₃ 薄膜与器件的影响。(a)不同退火温度薄膜的 XRD 图谱(右图为放大图);(b)1000 ℃ 退火相变 Ga₂O₃ 与 590 ℃ 直接外延 Ga₂O₃ 的 β‑Ga₂O₃(-201)XRD 摇摆曲线对比;(c)RMS 随退火温度变化;(d)MSM 光电探测器在暗态与 250 nm 光照下 I–V 曲线;(e)10 V 偏压下 250 nm 光照光电流与暗电流随退火温度变化;(f)10 V 偏压下响应光谱。
DOI:
doi.org/10.1016/j.mtphys.2026.102105