

【国际论文】高温退火对高-k/β-Ga₂O₃界面和电容的影响
日期:2023-05-15阅读:727
近日来自得克萨斯大学达拉斯分校材料科学与工程系的研究人员在学术期刊《Journal of Vacuum Science & Technology A》上发布了一篇名为Impact of process anneals on high-k/β-Ga2O3 interfaces and capacitance (高温退火对高-k/β-Ga2O3界面和电容的影响)这篇论文主要探究了在高功率电子器件中广泛应用的宽禁带半导体材料β-Ga2O3与高介电常数材料HfO2之间的薄膜,并研究了接口处处理热处理对器件性能的影响。该研究团队通过原子层沉积技术在β-Ga2O3衬底上沉积了HfO2,并制备了MOS电容器。研究结果表明,与未经热处理的β-Ga2O3样品相比,用氢气或氮气对β-Ga2O3进行的热处理会导致电容-电压(C-V)行为的恶化。相比之下,用纯氧气处理的样品具有更好的C-V特性,具有更高的最大电容和更小的平带电压漂移,表明氧气热处理可以改善C-V行为。X射线光电子能谱也表明,450°C时氧气热处理可以减少氧空位浓度,从而支持改善的C-V特性,并表明β-Ga2O3的氧气热处理可能会带来更好的MOS器件性能。
当使用薄膜沉积技术在β-Ga2O3衬底上生长HfO2高介电常数薄膜时,为了制作金属-氧化物-半导体(MOS)器件,需要在HfO2膜上制备电极。下方图1展示了一个典型的阴影掩膜MOS电容器结构,其中使用阴影掩膜法制备了金属(Cr/Au)顶电极和Ti/Au底电极,并且这些电极通过HfO2膜与β-Ga2O3衬底隔开。

图1. β-Ga2O3上的阴影掩蔽MOS电容结构示意图
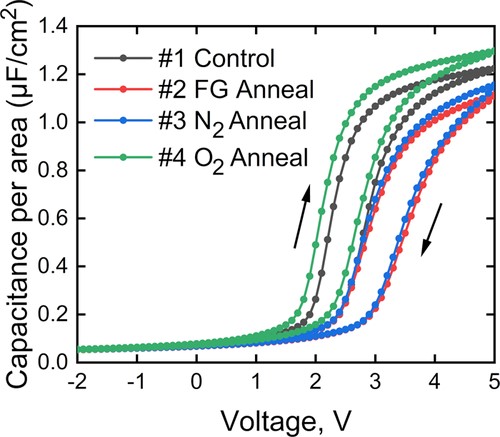
图2. 稳定的电容-电压测量特性,显示了每种工艺条件下不同的Cox/A结果。对照样品显示Cox/A约为1.22μF/cm2。在氮气或成型气体中退火的样品显示出更低的Cox/A,并向右偏移。氧气退火的样品显示出最好的结果,Cox/A大约为1.3μF/cm2,并略微向左偏移控制样品,表明界面电荷较少。
原文分享








