

【会员新闻】西安电子科技大学何云龙老师及团队在氧化镓材料与功率器件的研究进展
日期:2023-08-04阅读:1534
氧化镓材料与功率器件的研究进展
何云龙, 洪悦华, 王羲琛, 章舟宁, 张方, 李园, 陆小力, 郑雪峰, 马晓华
( 西安电子科技大学微电子学院, 西安 710071)
摘 要:氧化镓(Ga2O3)以其禁带宽度大、击穿场强高、抗辐射能力强等优势,有望成为未来半导体电力电子领域的主力军。相比于目前常见的宽禁带半导体 SiC 和 GaN,Ga2O3 的 Baliga 品质因数更大、 预期生长成本更低,在高压、大功率、高效率、小体积电子器件方面更具潜力。对 Ga2O3 外延材料、功率二极管和功率晶体管的国内外最新研究进行了概括总结,展望了 Ga2O3 在未来的应用与发展前景。
关键词:Ga2O3;外延材料;功率二极管;功率晶体管
中图分类号:TN303 文献标志码:A 文章编号:1681-1070 (2023)01-010107
DOI: 10.16257/j.cnki.1681-1070.2023.0036
中文引用格式:何云龙,洪悦华,王裴琛,等. 氧化镓材料与功率器件的研究进展[J]. 电子与封装,2023, 23(1): 010107.
英文引用格式:HE Yunlong, HONG Yuehua, WANG Xichen, et al. Progress of gallium oxide materials and power devices[J]. Electronics & Packaging, 2023, 23(1): 010107.
1 引言
随着国家“碳达峰、碳中和”战略的实施,节能减排、提升转换效率是目前能源领域的重要发展方向。功率半导体器件是功率转换的核心,为了实现该战略目标,超大功率、高转换效率、小体积的功率器件成为研究热点。目前,以 Si、Ge 为代表的第一代半导体器件经过几十年的芯片制造、器件结构、封装和应用技术的不断优化,已接近或达到材料的物理极限,未来发展空间有限。因此,依靠现有Si基功率器件已经无法满足功率半导体器件小型化、 高效率的工作需求,寻找并开发性能优异的半导体材料逐渐成为国内外研究者的主攻方向。以氧化镓(Ga2O3)为代表的超宽禁带半导体材料,具有超宽的禁带宽度(约 4.8 eV)和超高临界击穿场强(约 8 MV/cm),因此具有击穿电压高、 输出功率大等优点,成为目前的研究热点之一。
与常见的宽禁带半导体GaN、SiC相比,Ga2O3材料的迁移率虽然不高,但是其击穿场强超大,电子饱和速度快,在高压低导通的电力电子领域具有巨大的优势。Ga2O3材料目前已知的晶相共有 6 种,其中,β-Ga2O3的热稳定性最高,单晶生长质量最好,是制备器件的最佳选择。基于β-Ga2O3制备的功率电子器件,Baliga 品质因数是GaN器件的 4 倍,是SiC器件的 10 倍,是 Si 器件的 3444 倍。因此在相同的工作电压下,β-Ga2O3器件导通电阻更低、功耗更小,进而能够极大地降低器件工作时的电能损耗。此外,β-Ga2O3单晶衬底与蓝宝石衬底的制备工艺类似,可以通过金属熔融法直接获得,目前 4 英寸Ga2O3单晶衬底工艺已经相对成熟,成本有望降至同尺寸 SiC 衬底的三分之一,因此在低成本方面具有极大的潜力。与 GaN 功率器件相比,β-Ga2O3功率器件没有电流崩塌现象,其可靠性更高;其击穿场强比GaN更高,理论上具有更高的输出功率。与 SiC 功率器件相比,β-Ga2O3功率器件制作方法简单,且可利用平面型结构,更易于集成。当然,β-Ga2O3的热导率较低,这也成为制约β-Ga2O3器件发展的瓶颈。因此,如何提高器件的散热效果成为目前亟待解决的关键问题。
Ga2O3被认为是制备下一代高功率、高效率及低功耗电源系统极具希望的材料,欧美等发达国家已经将其列为下一代战略半导体材料,并开展了一系列研究。本文总结了国内外在Ga2O3材料、功率二极管和功率晶体管方面的最新研究进展,希望能为Ga2O3材料及其器件的研究提供参考。
2 Ga2O3外延材料
Ga2O3的材料外延技术主要有氢化物气相外延(HVPE)、金属有机化学气相沉积(MOCVD)和分子束外延(MBE)等。其中,HVPE生长的材料尺寸较大、缺陷密度低、生长成本低,是目前材料生长的主流方式。但是,由于Ga2O3属单斜晶系,其表面粗糙度较高,需要进行平整化处理。同时,由于其生长速率较高,其外延厚度不易控制。目前主流的研究机构多集中于日、韩等国家。2014年,日本东京农业与科技大学采用GaCl2和O2作为前驱体源,通过 HVPE 生长方法在(001)晶向的Ga2O3衬底上进行外延,外延材料的(002)晶向摇摆曲线的半高宽90”,背景杂质载流子浓度低至1013cm-3[1]。 2019年,韩国全南大学引人Pd 纳米颗粒,使用HVPE方法在蓝宝石上生长 α 向Ga2O3薄膜,其摇摆曲线半高宽为879”,粗糙度为4.98 nm[2]。2022年,韩国崇实大学在蓝宝石上通过 HVPE 生长 α 向Ga2O3薄膜,外延材料的XRD摇摆曲线如图 1 所示,外延的Ga2O3薄膜摇摆曲线的半高宽73”,并在此材料上制作了MOSFET器件,器件击穿电压高达2300 V,表明HVPE生长的Ga2O3质量得到了显著提升[3]。

图 1 外延材料的XRD摇摆曲线
相比于HVPE生长方法,通过 MBE生长的外延材料厚度精确可控,但是,该方法生长效率较低,且无法满足大尺寸外延的生长要求,在产业界并不是主流方法。即使如此,它依然是目前生长高质量外延材料的主力军。2020年,德国莱布尼茨研究所通过MBE在(100)晶向的Ga2O衬底上同质外Ga2O3薄膜层,尝试使用金属铟辅助金属交换催化的方法来提高生长速率,其生长速率高达1.5 nm/min,粗糙度(RMS)为0.3 nm[4]。2020 年,美国康奈尔大学使用了新颖的S-MBE方法分别在蓝宝石和Ga2O3上外延Ga2O3薄膜,其在蓝宝石上外延的生长速率为1.6 µ.m/h,在Ga2O3衬底上外延的速率为1.5 µ.m/h,薄膜的摇摆曲线半高宽为71”,粗糙度为0.7nm[5]。2022年该课题组引入In2O和SnO,提高了Ga2O3薄膜的生长速率,材料的摇摆曲线半高宽为10.3”,粗糙度为0.25 nm[6],如图 2 所示,这是目前通过MBE生长Ga2O3的最佳水平。

(a)XRD摇摆曲线 (b)表面粗糙度
图2 美国康奈尔大学外延材料测试结果
MOCVD外延生长方法兼顾了HVPE和MBE两种方法的优点,它不仅可以获得较大的薄膜尺寸,同时可以有效控制生长速率,是使Ga2O3外延生长步入产业化的有效途径。由于该方法研究起步较晚,生长的材料质量还有待提高。2018年,美国加州大学报道了使用MOCVD生长方法同质外延了超高电子迁移率的Ga2O3薄膜,其在室温下电子迁移率为 176 cm2/(V·s),在54 K低温下电子迁移率为3481 cm2/4V·s)[7]。 2021年,吉林大学在(100)的衬底上MOCVD同质外延 Si 掺Ga2O3薄膜,实现了掺杂浓度从6.5×1016cm-3到2.6×1019 cm-3的可控掺杂[8];2022年,该课题组通过优化生长工艺,获得的Ga2O3薄膜材料载流子掺杂浓度低至3.6×1016cm-3,电子迁移率为 137 cm2/ (V·s),在(002)衍射面的半高宽为26.3”,薄膜粗糙度为0.323 nm[9],如图 3 所示。这是目前通过MOCVD方法生长的质量最好的Ga2O3材料。
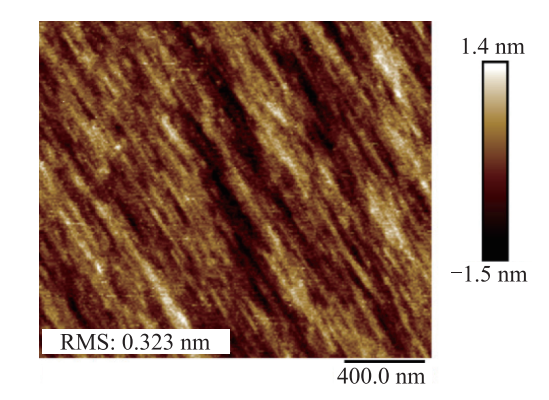
图 3 吉林大学 MOCVD 外延材料表面粗糙度
Ga2O3以其优异的材料性能受到国内外研究者的关注,它被认为是下一代功率电子器件的核心。因此,以Ga2O3材料为基础制作的功率器件具有在大功率、高温、强辐射等领域应用的潜力。Ga2O3功率器件的关键研究集中于Ga2O3 功率二极管以及Ga2O3功率晶体管。
3 Ga2O3功率二极管
目前,Ga2O3基功率二极管根据器件结构可分为肖特基结构、场终端结构、鳍式沟槽型结构以及PN结结构等,评价器件主要性能的参数有击穿电压、导通电阻、Baliga品质因数等。
3.1 肖特基结构
常规的Ga2O3基功率二极管主要由肖特基接触的阳极以及欧姆接触的阴极构成。2013年,日本Tamura公司成功地制备出第一支β-Ga2O3基二极管,如图4所示,器件的击穿电压为150 V[10]。2015年,日本信息与通信技术研究所(NICT)通过 HVPE 的方法,成功生长了7 µm的低掺杂外延层(掺杂浓度为1×1016cm-3),并基于该材料制备了二极管,通过变温C-V、I-V特性研究,发现器件正向导通电流符合热电子发射机制,反向漏电流传输符合热场发射机制[11]。

图 4 日本Tamura公司制作的常规功率二极管
3.2 场终端结构
从3.1节可以看出,仅采用常规肖特基结构的二极管击穿场强距离其理论极限仍有较大差距。因此,若要获得更高的击穿电压及Baliga品质因数,器件需要进行新型场终端技术开发与改进。场终端技术主要是在阳极的边缘处通过离子注入或者金属电极等结构使得器件的电场分布更加均匀,从而起到削弱阳极边缘电场峰值的效果。2019年,日本信息与通信技术研究所在Ga2O3的阳极边缘区域进行氮离子注人,采用场环叠加场板的复合终端结构实现了1.43 kV 的击穿电压以及4.7 mΩ·cm2的导通电阻[12]。2021年,美国犹他大学利用双层高介电常数介质 BTO/STO 制备场板结构,器件导通电阻低至0.32 mΩ·cm2,其击穿电压为687 V,Baliga品质因数超过了1 GW/cm2,该导通电阻是目前报道的最低值[13]。2022年,西安电子科技大学采用刻蚀形成沟槽结构,并填充二氧化硅介质制作了场终端功率二极管,该器件的击穿电压高达6000V,导通电阻为3.4 mΩ·cm2,器件的Baliga品质因数高达10.6 GW/cm2[14]。
虽然Ga2O3场终端结构取得了长足进步,但由于Ga2O3材料P型掺杂的缺失,严重制约Ga2O3功率二极管向着更高性能的方向发展。研究者尝试利用 P型NiOx代替Ga2O3,形成了异质PN结,填补了P型Ga2O3缺失带来的遗憾,成为了目前研究的热点。2020年,中国电科13所利用Ga2O3天然P型的优势,与Ga2O3结合制备出了结势垒肖特基二极管(JBS),其结构如图 5 所示。 器件导通电阻为3.45 mΩ·cm2,击穿电压为1715 V,Baliga品质因数超过了 0.85 GW/cm2[15]。2021年,西安电子科技大学制作了凹槽型JBS 结构功率二极管,器件的击穿电压达到1340 V,导通电阻低至1.94 mΩ·cm2[16]。

图 5 中国电科13所制作的JBS二极管结构
3.3 鳍式沟槽型结构
2018年,美国康奈尔大学首次制备出鳍式沟槽型结构的Ga2O3二极管,其结构如图6所示,在深沟槽上方沉积Al2O3介质,器件的击穿电压高达2440V,导通电阻为11.3 mΩ·cm2[17]。该器件的优势是利用多个鳍式沟槽将有源区进行分离,该结构不仅具有平面的场终端结构,同时还增加了纵向的场终端,并且,多个鳍式沟槽增加了散热面积。2020年,该课题组采用两级场板对鳍式沟槽型结构的Ga2O3二极管进行优化,器件的击穿电压达到2890 V,导通电阻为10.5 mΩ·cm2,该器件的Baliga品质因数高达0.80 GW/cm2[18]。

图 6 首支鳍式沟槽结构的Ga2O3二极管
3.4 PN结结构
随着NiOx沉积技术的成熟,研究者尝试把高质量P型氧化镍与N型Ga2O3结合制备成异质PN结结构的Ga2O3 二极管,以PN结代替肖特基结,提升其耐压特性。2020年,南京大学通过改变氧气氛围及腔室压强沉积出2层不同浓度的NiOx,以此为基础制作了Ga2O3 PN结二极管。该器件的击穿电压为1860 V,导通电阻为10.6 mΩ·cm2,其Baliga品质因数为0.33 GW/cm2[19]。2021年,西安电子科技大学通过磁控溅射的方式制作了PN结二极管,该器件的击穿电压为1220 V,其导通电阻降至1.08 mΩ·cm2,其Baliga品质因数达到1.38 GW/cm2[20]。同年,中国科学技术大学通过后退火技术优化NiOx与Ga2O3 的界面,降低了界面态缺陷密度,从而提高了器件的性能。该器件经过退火后,击穿电压从900 V提高至1630 V,导通电阻降为4.1 mΩ·cm2,Baliga品质因数达到0.65 GW/cm2[21]。
由于NiOx与Ga2O3形成的异质PN结具有优良的特性,PN结结构的二极管性能有了巨大的提升,为此,研究者不断地将PN结结构与场终端结构相结合,改进与提升Ga2O3功率二极管的器件特性。2022年,南京大学制作了梯形台面的NiOx,并与Ga2O3结合制备成异质PN结二极管。该器件的击穿电压达到2230 V,导通电阻为1.9 mΩ·cm2[22]。同年,中国电科13所采用异质PN结结构结合梯形场板制作的器件击穿电压达到2410 V,导通电阻低至1.12 mΩ·cm2,其Baliga品质因数达到5.18 GW/cm2[23]。西安电子科技大学采用双层浓度的NiOx制作了异质PN结结构二极管,并结合了Mg离子注入场环、SiO2介质场板等多种终端技术,器件结构如图7所示,其中NA和ND分别为受主掺杂浓度和施主掺杂浓度,T为厚度。制作的器件击穿电压达到8320 V,导通电阻为5.24 mΩ·cm2,Baliga品质因数达到13.2 GW/cm2[24],该值为目前国际报道的最高值。

图7 西安电子科技大学制作的复合终端结构氧化镓PN二极管
通过以上研究,可以发现采用异质 PN 结结构依然是目前提升Baliga品质因数最为有效的方法之一,同时,为了提升器件的击穿电场,使其更接近于Ga2O3的理论极限,场终端技术依然不可或缺。因此,Ga2O3基功率二极管的主攻方向依然集中于提升其击穿电压并降低其导通电阻。当然,随着器件性能的不断提升,器件的击穿场强不断接近其理论极限,器件的热稳定性与可靠性将成为更为重要的考量标准。
4 Ga2O3功率晶体管
相对于Ga2O3功率二极管,Ga2O3功率晶体管的研究目前还相对滞后,主要原因是绝缘衬底上高质量的外延材料难以获得,同时,高质量外延材料的尺寸较小,能够进行器件特性改进的物理空间较少。因此,Ga2O3功率晶体管目前存在的问题较多,主要包括击穿电压低、电流密度低、增强型难以制备等。研究的主要方向涵盖场终端技术、垂直器件技术与增强型技术等几个方面,评价器件性能的主要参数有击穿电压、导通电阻、Baliga品质因数等。
4.1 场终端技术
与Ga2O3功率二极管相似,Ga2O3基功率晶体管的击穿场强远低于其理论极限,要想获得较高的击穿场强,开发并优化场终端技术势在必行。2020年,中国电科13 所采用优化的源极场板制作了Ga2O3基MOSFET,其结构如图8所示,器件的功率品质因数为277 W/cm2,达到了世界领先水平[25];同年,该单位研究了氧气氛围退火对器件功率性能的影响,这也是国内首次报道Ga2O3基MOSFET的功率性能,该器件在1 GHz连续波条件下输出功率Pout为0.4 W/mm,功率附加效率(PAE)为10%,增益为3.2 dB[26]。

图8 中国电科13所制作的Ga2O3基MOSFET器件结构
2019 年,日本电子与通信研究所采用双层介质结合源场板技术制作了 MOSFET,其器件击穿电压达到2321 V。该技术为Ga2O3基MOSFET提供了一种稳定、低成本和有效的击穿电压提升方法[27]。2022年,美国布法罗大学采用聚合物钝化层显著提升MOSFET的击穿电压,其器件击穿电压高达 8.03 kV[28]。西安电子科技大学通过优化NiOx/Ga2O3界面并结合凹槽技术,使器件的导通电阻达到 6.24 mΩ·cm2,击穿电压为2145 V,其功率优值(PFOM)达到 0.74 GW/cm2,该值为目前横向Ga2O3基MOSFET报道的最高值,显示出Ga2O3基MOSFET在大功率、高效率和电力电子方面的巨大应用前景[29]。
4.2 垂直器件技术
对于横向器件来说,提升器件击穿电压的途径除了采用有效的终端技术以外,还可以增加其栅漏间距,而栅漏间距的不断增大无疑增加了器件的有源区面积。因此,众多的研究者开始将关注点聚焦到了垂直型器件,垂直型器件可以在不改变其有源区面积的条件下提升器件的击穿电压,是目前研究的重要方向之一。2019年,日本国家信息和通信技术研究所通过N和Si元素注入掺杂技术制作了垂直型Ga2O3基MOSFET,为Ga2O3基垂直型器件的研究提供了重要参考[30]。2022年,美国斯坦福大学制作了首个Mg扩散电流阻挡层(CBL)垂直场效应晶体管(VDBFET),该器件的开关比达到 109,击穿电压为72 V,虽然击穿电压很低,但该器件的报道为Ga2O3基MOSFET在CBL结构的创新上提供了理论依据[31]。
2019年,美国康奈尔大学制作了垂直鳍型Ga2O3基MOSFET,如图 9 所示。该器件通过控制每根鳍宽调制器件的阈值电压,通过漂移区的掺杂浓度调制器件的击穿电压,器件的击穿电压高达2.66 kV,特征导通电阻为25.2 mΩ·cm2。该器件运用了低损伤刻蚀技术、小线条光刻技术、介质保型覆盖技术等多个关键技术,因此其制作难度较大。但它具有阈值电压可控、击穿特性好、散热性好等优点,为Ga2O3基MOSFET在电力电子领域的应用提供了重要支撑[32]。

图 9 美国康奈尔大学制作的垂直鳍型Ga2O3基MOSFET
4.3 增强型技术
Ga2O3材料的迁移率较低,通常低于200 cm2/ (V·s),同时,为了使器件获得较高的电流密度,通常材料的沟道层较厚,因此,Ga2O3基MOSFET的阈值电压较负(低于-20 V),这严重限制了器件在功率转换中的应用。为此,制作高性能的增强型功率器件是未来的发展趋势。2019年,美国空军实验室采用凹槽栅结构制作了增强型Ga2O3基MOSFET,其在0.1 mA/mm电流密度 时的阈值电压为+3 V,漏极电流密度大于20 mA/mm,电流开关比大于107,器件的击穿电压高于198 V[33]。中国电科 13 所采用栅极氧退火技术,形成栅氧化层(OA 区),有效降低了沟道电子,制作的增强型器件的阈值电压为 4.1 V,击穿电压在3000 V以上[34],器件结构如图 10 所示。2022年,西安电子科技大学通过优化NiOx/Ga2O3界面并结合Ga2O3凹槽技术制作Ga2O3增强型功率器件,其导通电阻为13.75 mΩ·cm2,击穿电压为1977 V,PFOM值为0.28 GW/cm2,该参数为目前Ga2O3增强型功率器件的最佳指标[29]。

图 10 中国电科 13 所制作的增强型器件结构
由于Ga2O3材料的热导率较低,且材料自身存在氧空位和镓空位等缺陷,影响着Ga2O3的热学性能以及载流子输运。过低的热导率导致器件的自热现象严重,这会导致器件性能严重衰退。因此,散热效率成为制约Ga2O3功率器件迈向应用的瓶颈。2019年,西安电子科技大学首次采用离子刀剥离技术实现了Ga2O3基MOSFET的衬底转移,如图 11 所示,其中GaO@ISiC(GaO@ISi)中的“I”代表Al2O3介质层,为解决Ga2O3功率器件的散热问题提供了重要的解决方案[35]。此外,衬底减薄也是解决Ga2O3功率器件散热问题的有效方陆之一[36]。

图 11 西安电子科技大学离子刀剥离键合技术
从以上研究进展可以看出,场终端技术的优化依然是Ga2O3基MOSFET提升击穿电压的有效途径之一,目前Ga2O3功率晶体管的最高击穿电压可达8.03 kV,通过优化界面特性并结合凹槽技术,可以获得最高的 PFOM 值(0.74 GW/cm2)。虽然目前对Ga2O3基MOSFET的研究取得了一定的进展,但是相对于二极管来说,MOSFET的发展依处于初级阶段,依然有很多问题有待解决。
5 结束语
本文对Ga2O3外延材料、功率二极管和功率晶体管的国内外最新研究进行了归纳与总结。Ga2O3外延材料主要有HVPE、MBE和MOCVD 3 种生长方式。其中,MOCVD生长方式兼顾了较大的外延尺寸与可控的生长速率,是将Ga2O3材料推向产业化的有效途径,优化其生长工艺,制作大尺寸、高质量的外延材料将成为未来的主要研究方向。Ga2O3功率器件主要分为功率二极管与功率晶体管。目前,Ga2O3功率二极管通过异质 PN 结与多种场终端技术的结合,已经迫近Ga2O3材料的理论极限,是最接近商用的器件之一。而 Ga2O3功率晶体管尽管采用多种技术实现了一定的突破,但是受限于目前的材料质量与尺寸,器件的性能距离其理论极限还有巨大差距,且其增强型器件制备技术尚不完善,需要继续进行技术开发与理论研究。此外,受限于Ga2O3材料固有的低热导率特性,Ga2O3功率器件的热管理技术也将成为未来的重点研究方向之一。
参考文献:
[1] MURAKAMI H,NOMURA K,GOTO K,et al. Homo-epitaxial growth of β-Ga2O3 layers by halide vapor phase epitaxy[J].Applied Physics Express,2014,8(1):015503.
[2]CHA A-N,BANG S,RHO H,et al.Effects of nanoepitaxial lateral overgrowth on growth of α-Ga2O3 by halide vapor phase epitaxy[J]. Applied Physics Letters,2019,115(9):091605.
[3]JEONGY J,PARK J-H,YEOM M J,et al.Heteroepitaxialα-Ga2O3 MOSFETs with a 2.3kV breakdown voltage grown by halide vapor-phase epitaxy[J]. Applied Physics Express,2022,15(7):074001.
[4]MAZZOLINI P,FALKENSTEIN A,GALAZKA Z,et al.Offcut-related step-flow and growth rate enhancementduring (100)beta-Ga2O3 homoepitaxy by metal-exchang catalyzed molecular beam epitaxy (MEXCAT-MBE)[J].Applied Physics Letters,2020,117(22):1-6.
[5]VOGT P,HENSLINGF V E,AZIZIE K,et al.Adsorption-controlled growth of Ga2O3 by suboxide molecular-beam epitaxy[J].APL Materials,2021,9(3):031101.
[6]VOGT P,HENSLINGFV E,AZIZIE K,et al.Extending the kinetic and thermodynamic limits of molecular-beam epitaxy utilizing suboxide sources or metal-oxide-catalyzed epitaxy[J].Physical Review Applied,2022,17(3):034021.
[7]ZHANG Y,ALEMA F,MAUZE A,et al.MOCVD grownepitaxial β-Ga2O3 thin film with an electron mobility of 176 cm2/(V·s)at room temperature[J]. APLMaterials,2018,7(2):022506.
[8]JIAO T,LI Z,CHEN W,et al.Stable electron concentrationSi-doped β-Ga2O3 films homoepitaxial growth by MOCVD [J].Coatings,2021,589(11):11050589.
[9]ZHAO C L,JIAO T,CHEN W,et al. Preparation ofhigh-thickness n--Ga2O3 film by MOCVD[J].Coatings,2022,645(12):12050645.
[10]SASAK IK,HIGASHIWAKI M,KURAMATA A,et al.Ga2O3 Schottky barrier diodes fabricated by usingsingle-crystal β-Ga2O3(010) substrates[J].IEEE Electron Device Letters,2013,34(4):493-495.
[11]HIGASHIWAKI M,KONISHI K,SASAKI K,et al.Temperature-dependent capacitance-voltage and current-voltage characteristics of Pt/Ga2O3 (001) Schottky barrier diodes fabricated on n-Ga2O3 drift layers grown by halide vapor phase epitaxy[J]. Applied Physics Letters,2016,108(13):133503.
[12]LIN C-H,YUDA Y,WONG M H,et al.Vertical Ga2O3 Schottky barrier diodes with guard ring formed bynitrogen-ion implantation[J].IEEE Electron Device Letters,2019,40(9):1487-1490.
[13]ROY S,BHATTACHARYYA A,RANGA P,et al.High-k oxide field-plated vertical (001)beta-Ga2O3 Schottky barrier diode with Baliga's figure of merit over 1 GW/cm2[J].IEEE Electron Device Letters,2021,42(8):1140-1143.
[14]DONG P,ZHANG J,YAN Q,et al.6kV/3.4mΩ·cm2 vertical beta-Ga2O3 Schottky barrier diode with BV2/Ron,sp performance exceeding 1-D unipolar limit of GaN and SiC[J].IEEE Electron Device Letters,2022,43(5):765-768.
[15]LYU Y,WANG Y,FU X,et al.Demonstration of beta-Ga2O3 junction barrier Schottky diodes with a Baliga'sfigure of merit of 0.85GW/cm2 or a 5A 700V handling capabilities[J]. IEEE Transactions on Power Electronics,2021,36(6):6179-6182.
[16]YAN Q,GONG H,ZHANG J,et al.Beta-Ga2O3 hetero-junction barrier Schottky diode with reverse leakagecurrent modulation and BV2/Ron,sp value of 0.93GW/cm2[J].Applied Physics Letters,2021,118(12):1-5.
[17]LI W,HU Z,NOMOTO K,et al. 2.44kV Ga2O3 vertical trench Schottky barrier diodes with very low reverseleakage current[C]//2018IEEE International ElectronDevices Meeting(IEDM),2018.
[18]LI W,NOMOTO K,HU Z,et al.Field-plated Ga2O3 trench Schottky barrier diodes with a BV2/Ron,sp of up to 0.95GW/cm2[J]. IEEE Electron Device Letters,2020,41(1):107.
[19]GONGHH,CHENXH,XUY,etal.A1.86-kVdoublelayeredNiO/beta-Ga2O3 verticalp-nheterojunctiondiode[J].AppliedPhysicsLetters,2020,117(2):022104.
[20]WANG C,GONG H,LEI W,et al.Demonstration of thep-NiOx/n-Ga2O3 heterojunction gate FETs and diodes with BV2/Ron,sp figures of merit of 0.39 GW/cm2 and1.38GW/cm2[J]. IEEE Electron Device Letters,2021,42(4):485-488.
[21]HAO W,HE Q,ZHOU K,et al.Low defect density and small I-V curve hysteresis in NiO/β-Ga2O3 pn diode with a high PFOM of 0.65GW/cm2[J]. Applied Physics Letters,2021,118(4):043501.
[22]ZHOU F,GONG H,XU W,et al.1.95-kV beveled-mesa NiO/beta-Ga2O3 heterojunction diode with 98.5%conversion efficiency and over million-times overvoltage ruggedness[J]. IEEE Transactions on Power Electronics,2022,37(2):1223-1227.
[23]WANG Y,GONG H,LYU Y,et al. 2.41kV verticalP-NiO/n-Ga2O3 heterojunction diodes with a record Baligasfigure-of-merit of 5.18GW·cm2[J].IEEE Transactions on Power Electronics,2022,37(4):3743-3746.
[24]JI X,LU C,YAN Z,et al.A review of gallium oxide-based power Schottky barrier diodes[J].Journal of Physics D-Applied Physics,2022,55(44):65-81.
[25]LYU Y,ZHOU X,LONG S,et al.Source-field-platedβ-Ga2O3 MOSFET with record power figure of merit of 50.4MW/cm2[J].IEEE Electron Device Letters,2019,40(1):83-86.
[26]LYU Y,LIU H,ZHOU X,et al.Lateral β-Ga2O3 MOSFETs with high power figure of merit of 277MW/cm2[J].IEEE Electron Device Letters,2020,41(4):537-540.
[27]MUN J,CHO K,DO J,et al.2.32kV breakdown voltage lateral β-Ga2O3 MOSFETs with source-connected field plate[J]. ECS Journal of Solid State Science and Technology,2019,8(7):Q3079.
[28]SHARMA S,ZENG K,SINGISETTI U,et al.Field-plated lateral Ga2O3 MOSFETs with polymer passivation and8.03kV breakdown voltage[J].IEEE Electron DeviceLetters 2020,41(6):836.
[29]WANG C,ZHOU H,ZHANG J,et al.Hysteresis-free andls-switching of D/E-modes Ga2O3 hetero-junction FETs with the BV2/Ron,sp of 0.74/0.28GW/cm2[J]. Applied Physics Letters,2022,120(11):112101.
[30]WONG M,GOTO K,HIGASHIWAKI M,et al.Current aperture vertical β-Ga2O3 MOSFETs fabricated by N- andSi-ionimplantation doping[J].IEEE Electron Device Letters,2019,40(3):431-434.
[31]ZENG K,SOMAN R,CHOWDHURY S,et al.Vertical Ga2O3 MOSFET with magnesium diffused current blocking layer[J].IEEE Electron Device Letters,2022,43(9):1527-1530.
[32]LI W,NOMOTO K,HU Z,et al.Single and multi-finnormally-off Ga2O3 vertical transistors with a breakdownvoltage over 2.6kV[C]//IEEE International Electron Devices Meeting(IEDM),2019:19-271.
[33]CHABAK K,MCCANDLESS J,MOSER N,et al.Recessed-gate enhancement-mode β-Ga2O3 MOSFETs[J].IEEE Electron Device Letters,2018,39(1):67-70.
[34]LYU Y,ZHOU X, LONG S,et al.Enhancement-mode β-Ga2O3 metal-oxide-semiconductor field-effect transistor with high breakdown voltage over 3000V realized by oxygen annealing[J].Physica Status Solidi(RRL)-Rapid Research Letters,2019,14(3):1900586.
[35]XU W,WANG Y,YOU T,et al.First demonstration of waferscale heterogeneous integration of Ga2O3 MOSFETs on SiC and Si substrates by ion-cutting process[C]//IEEEInternational Electron Devices Meeting(IEDM),2019.
[36]GONG H,ZHOU F,YU X,et al.70 μm body Ga2O3Schottky barrier diode with 1.48K/W thermal resistance,59 A surge current and 98.9% conversion efficiency[J].IEEEElectron Device Letters,2022,43(5):773-776.


