

【Member Papers】1.5-kV Blocking Vertical AgOₓ/β-Ga₂O₃ Schottky Barrier Diodes with Ultralow Leakage Current and Over 1013 Rectification Ratio
日期:2025-10-15阅读:529
Researchers from the Xidian University and Suzhou Institute of Nano-Tech and Nano-Bionics, CAS have published a dissertation titled "1.5-kV Blocking Vertical AgOx/β-Ga2O3 Schottky Barrier Diodes with Ultralow Leakage Current and Over 1013 Rectification Ratio " in Journal of Physics D: Applied Physics.
Project Support
The research was supported by the National Natural Science Foundation of China (Grant Nos. 62293522, 62204255, and 62234007) and the Key Program of Shaanxi Provincial Department of Science and Technology Support (2024CY2-GJHX-81).
Background
β-phase gallium oxide (β-Ga2O3) has garnered significant interest for high-power electronic applications due to its ultra-wide bandgap, high critical field strength, controllable doping, and the availability of large-diameter wafers. Among β-Ga2O3 device architectures, vertical Schottky barrier diodes (SBDs) are preferred for high-voltage and high-current applications since they enable current scaling. Over the past decade, substantial progress has pushed device performance toward the material limit through various edge terminations, including field plates, mesa termination, implanted edge termination, and junction termination extension; to date, numerous β-Ga2O3 SBDs with breakdown voltage (Vbr) > 2 kV have been reported.
Schottky contacts that combine a high Schottky barrier height (SBH) with low reverse leakage currents are essential for making high-voltage β-Ga2O3 SBDs. Prior work has focused on oxidized noble metals, surface treatments, and ultrathin dielectric interlayers. Oxidized noble metals such as PtOx, IrOx, and RuO2 can substantially raise SBH owing to their higher work function relative to the base metals. Silver oxide (AgOx) is particularly attractive owing to lower material cost of Ag, the highest reported SBHs on β-Ga2O3, and simple fabrication methods including thermal oxidation, pulsed laser deposition, and radio-frequency (RF) magnetron sputtering. AgOx exhibits multiple phases, such as AgO, Ag2O, Ag2O3, Ag4O3, and Ag4O4. Among these, Ag2O is the most thermodynamically stable, with a decomposition threshold of approximately 300 ℃. Nevertheless, AgOx as a high-barrier anode for β-Ga2O3 SBDs remains underexplored.
Abstract
High-performance vertical AgOx/β-Ga2O3 Schottky barrier diodes (SBDs) were demonstrated in this work. Ag2O was confirmed as the primary phase in the AgOx films deposited by RF magnetron sputtering at room temperature, using the X-ray photoelectron spectroscopy (XPS) and X-ray diffraction (XRD). The built-in voltage (Vbi) was determined to be 2.3 V, corresponding to a Schottky barrier height of 2.41 eV at the AgOx/β-Ga2O3 interface. The vertical AgOx/β-Ga2O3 SBDs achieved an ultralow leakage current of <10-11 A/cm2 with a rectification ratio over 1013 and a low differential specific on-resistance (RON,sp) of 5 mΩ·cm2. A high reverse breakdown voltage (Vbr) of 1.5 kV was obtained, resulting in a decent power figure of merit (Vbr2/RON,sp) of 0.46 GW/cm2. These results highlight a promising pathway for developing high-performance β-Ga2O3-based power diodes.
Conclusion
In conclusion, the AgOx film as anode electrode was successfully deposited on β-Ga2O3 using RF magnetron sputtering at room temperature, demonstrating high crystalline quality using XPS and XRD. Due to the high crystalline quality of the AgOx film and large SBH at the AgOx/β-Ga2O3 interface, the fabricated AgOx/β-Ga2O3 SBDs achieve an excellent performance including reduced leakage current less than 10-11 A/cm2 and enhanced breakdown voltage exceeding 1.5 kV. Combined with the high On-state current over 102 A/cm2 and a differential RON,sp of 5 mΩ·cm2, yielding a remarkable ION/IOFF exceeding 1013 and PFOM reaching 0.46 GW/cm². As compared to the reported results without the edge termination, the device exhibits the highest ION/IOFF and lowest JOFF with a decent Vbr. These results underscore the promise of AgOx as a high-barrier contact for next-generation β-Ga2O3-based power rectifiers.
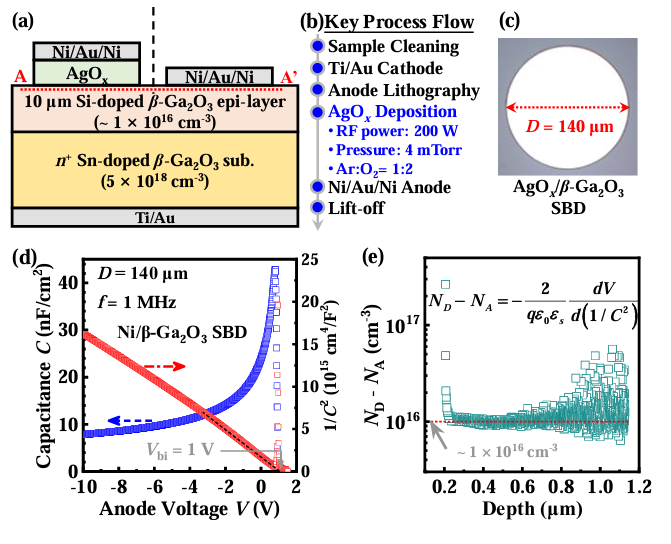
Figure 1. (a) Schematic cross sections of the fabricated β-Ga2O3 SBDs. (b) Key fabrication process of SBDs. (c) Top-view of the device with a D of 140 μm. (d) C - V and 1/C2 - V characteristics of Ni/β-Ga2O3 SBD at 1 MHz. (e) Donor concentration distribution in the β-Ga2O3 drift layer.

图 2. (a) 5 × 5 μm2原子力显微镜(AFM)图像,(b) Ag3d核心能级XPS光谱,(c) O1s核心能级XPS光谱,(d) 溅射沉积的AgOx薄膜XRD曲线。 (e) AgOx/β-Ga2O3 SBD在1 MHz下的C - V和 1/C2 - V 特性。 (f) AgOx/β-Ga2O3肖特基界面在热平衡下的能带图。
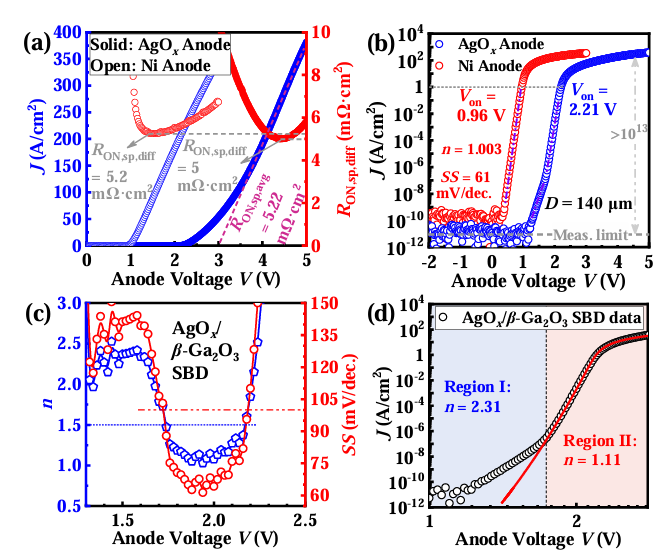
Figure 2. (a) 5 × 5 μm2 AFM image, XPS spectra of (b) Ag3d and (c) O1s core levels, and (d) XRD curve of the sputtered AgOx film. (e) C - V and 1/C2 - V characteristics of the AgOx/β-Ga2O3 SBD measured at 1 MHz. (f) Energy band diagram of AgOx/β-Ga2O3 Schottky interface at thermal equilibrium.
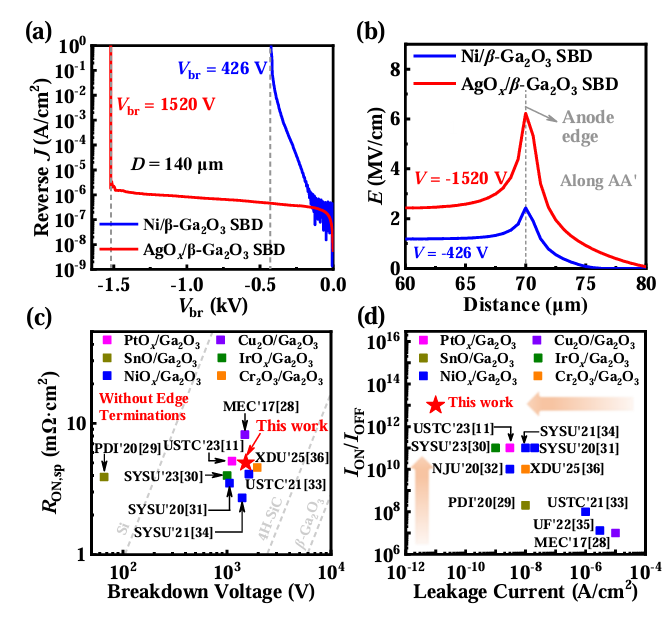
Figure 4. (a) Reverse J - V characteristic of the SBDs. (b) Simulated E along the cutline AA’ in Fig. 1(a) at the measured Vbr. Benchmarks of (c) RON,sp vs. Vbr and (d) ION/IOFF vs. JOFF of the AgOx/β-Ga2O3 SBD and reported diodes.
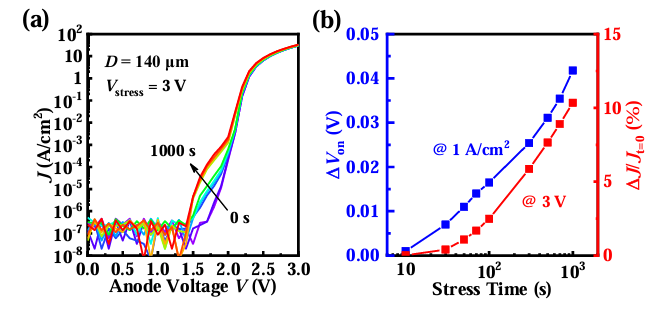
Figure 5. (a) Forward J - V characteristics of the AgOx/β-Ga2O3 SBD measured after different forward-bias stress time. (b) Evolution of ΔVon and ΔJ under forward-bias stress.
DOI:
doi.org/10.1088/1361-6463/ae0b82